Chang Li, Cheng Chen, Jie Chen, Tao He, Hongwei Li, Zeyuan Yang, Liu Xie, Zhongchang Wang, Kai Zhang. High-performance junction field-effect transistor based on black phosphorus/β-Ga2O3 heterostructure[J]. Journal of Semiconductors, 2020, 41(8): 082002
Search by keywords or author
- Journal of Semiconductors
- Vol. 41, Issue 8, 082002 (2020)
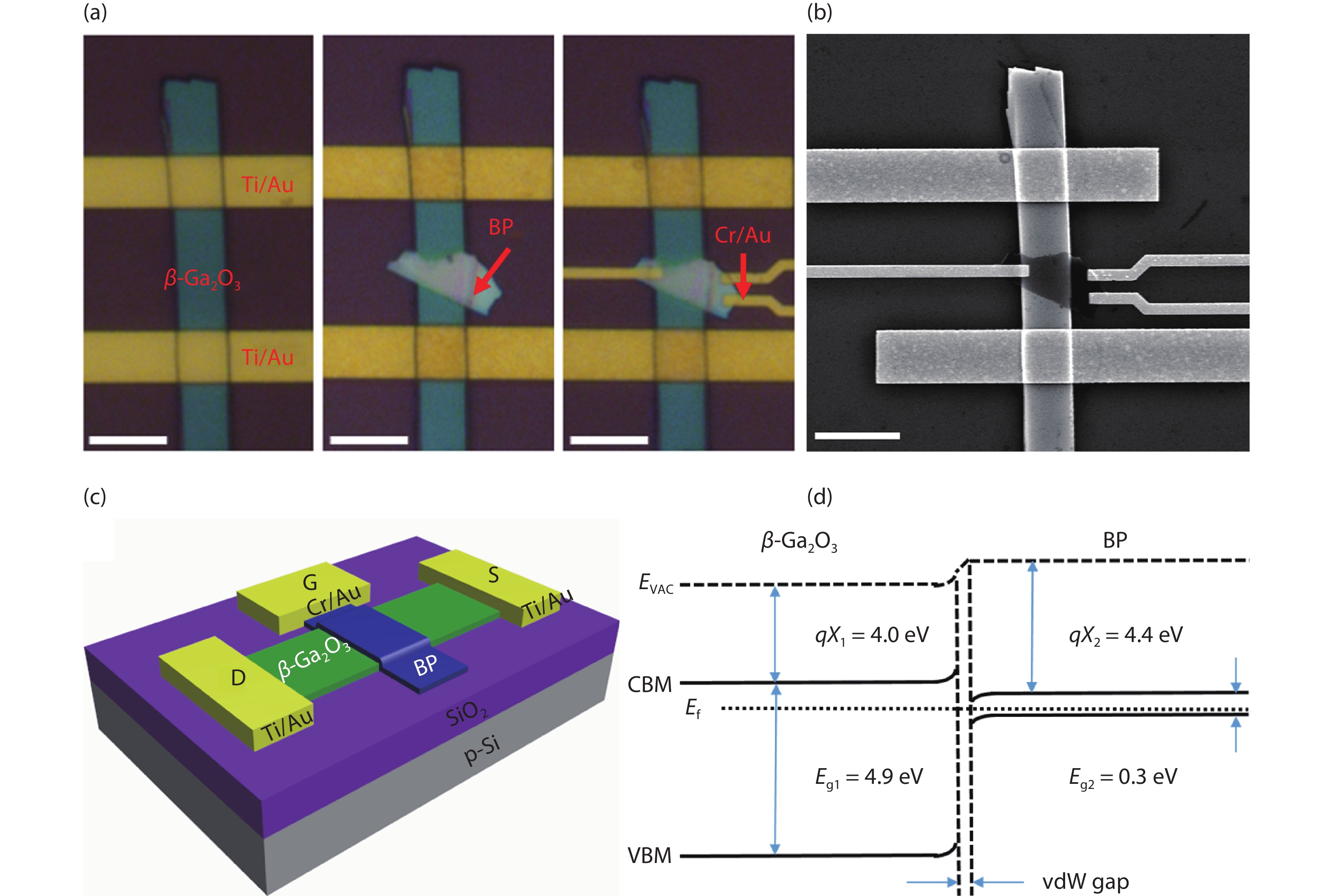
Fig. 1. (Color online) (a) Optical microscope images of fabrication steps of BP/β -Ga2O3 heterojunction device. The channel length and width of the β -Ga2O3 were 16 and 6 μ m, respectively. (b) SEM image of an as-fabricated BP/β -Ga2O3 heterojunction device. (c) Schematic illustration of the JFET device fabricated on a Si/SiO2 (285 nm) substrate. (d) Energy band diagram of multilayer p-type BP and n-type β -Ga2O3 heterojunctions with a vdW gap. Scale bars are 10 µ m.

Fig. 2. (Color online) (a) AFM image of the BP/β -Ga2O3 heterojunction. (b, c) Height profiles of the exfoliated BP and β -Ga2O3 flakes in (a). The thicknesses of the nanoflakes are 32.6 and 123.5 nm, respectively. (d) Raman spectra of the BP, β -Ga2O3 and the BP/β -Ga2O3 overlapped regions obtained under a 532 nm laser. The black and green curve demonstrated typical multilayer BP flake and β -Ga2O3 flake. The red curve shows the peaks of the overlapped region. (e) SEM image of the BP/β -Ga2O3 heterostructure device (left) and corresponding EDS element mappings for Ga and P (right). Scale bars are 5 µ m.
Fig. 3. (Color online) (a)Transfer characteristics for back-gate BP FET. Back gate voltage V bg swept from –60 to 60 V with a fixed source–drain bias voltage V ds = 0.1 V. (Inset: output characteristics for back gated BP FET. V bg ranging from –60 to 60 V with steps of 30 V under V ds swept from 0 to 50 mV.) (b) Transfer characteristics for back gate β -Ga2O3 FET. V bg swept from –80 to 80 V with a fixed V ds = 5 V (Inset: output characteristics for back-gate β -Ga2O3 FET. V bg ranging from –80 to 80 V with steps of 40 V under V ds swept from 0 to 5 V.) (c) I ds−V ds curve of BP/β -Ga2O3 PN heterojunction. It shows a typical rectifying behavior. (Inset: the circuit schematic diagram of the PN heterojunction.) (d) I ds−V ds semi-log plot of the BP/β -Ga2O3 PN heterojunction.
Fig. 4. (Color online) (a) Circuit schematic diagram and optical image of the BP/β -Ga2O3 JFET. (b) Band diagram of β -Ga2O3 along the channel length direction. The red and blue curve shows the band bending at zero and negative gate voltage, respectively. (c) Output characteristics (I ds−V ds) of the JFET. V gs ranging from –15 to 2 V under V ds swept from 0 to 25 V. (d) Transfer characteristics (I ds−V gs) of the JFET. V ds ranging from 2 to 20 V under V gs swept from –25 to 2 V. (e) Semi-log plot of the transfer characteristics of the JFET. It shows a high on/off ratio beyond 107. (f) Transconductance curves (estimated from transfer curves of (d)) of BP/β -Ga2O3 JFET as function of V gs with V ds sweeping from 2 to 20 V.
Fig. 5. (Color online) (a) Output characteristics curves of the BP/β -Ga2O3 JFET under different temperatures (ranging from 300 to 450 K with steps of 50 K) at V gs = 1 V. (b) Transfer characteristics curves of the BP/β -Ga2O3 JFET under different temperatures (ranging from 300 to 450 K with steps of 50 K) at V ds = 10 V.
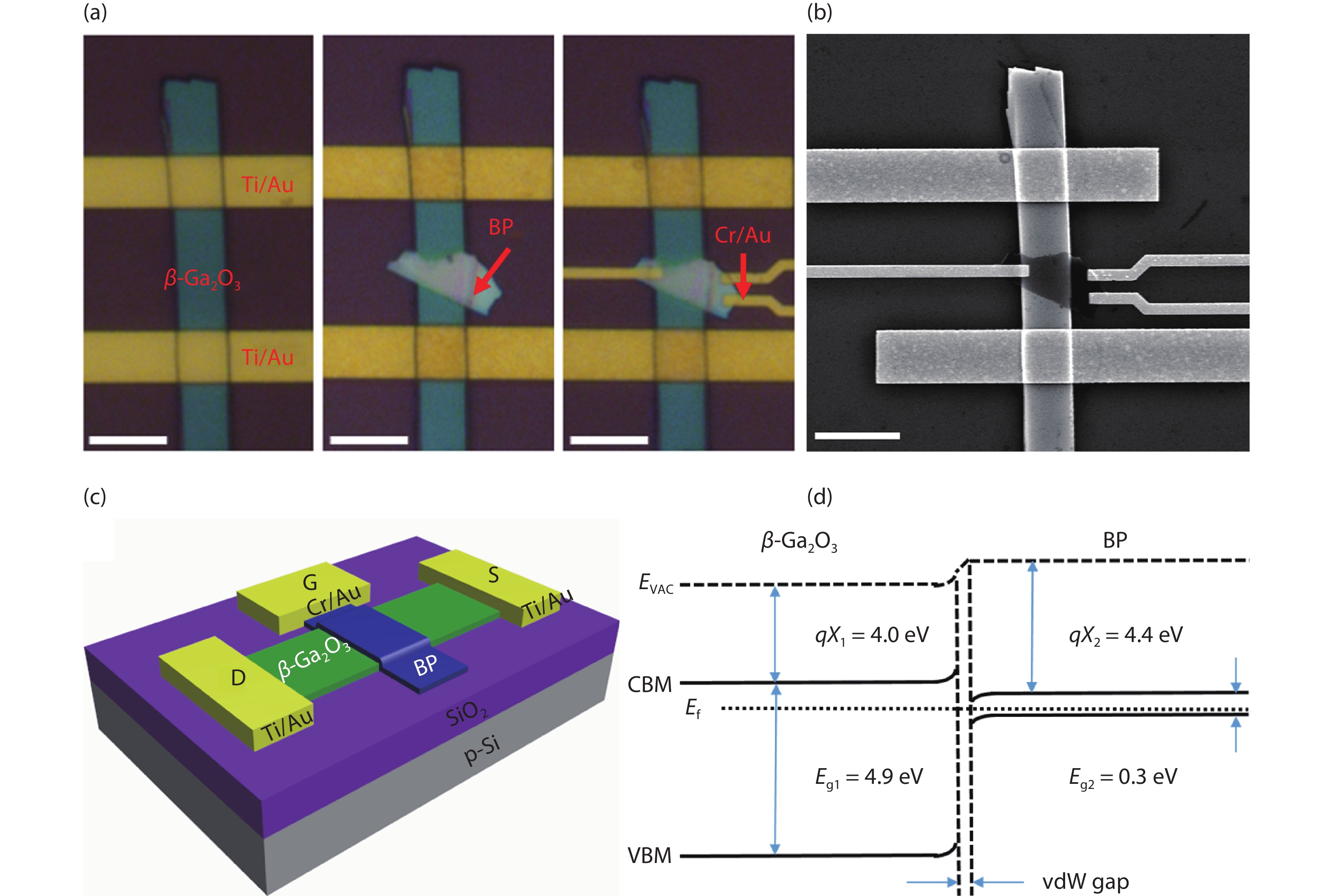
Set citation alerts for the article
Please enter your email address



