Shuxin Tan, Takashi Egawa. Influence of growth conditions of oxide on electrical properties of AlGaN/GaN metal–insulator–semiconductor transistors[J]. Journal of Semiconductors, 2019, 40(4): 042801
Search by keywords or author
- Journal of Semiconductors
- Vol. 40, Issue 4, 042801 (2019)
Abstract
| (1) |
View in Article
| (2) |
View in Article
| (3) |
View in Article
| (4) |
View in Article
| (5) |
View in Article
| (6) |
View in Article
| (7) |
View in Article
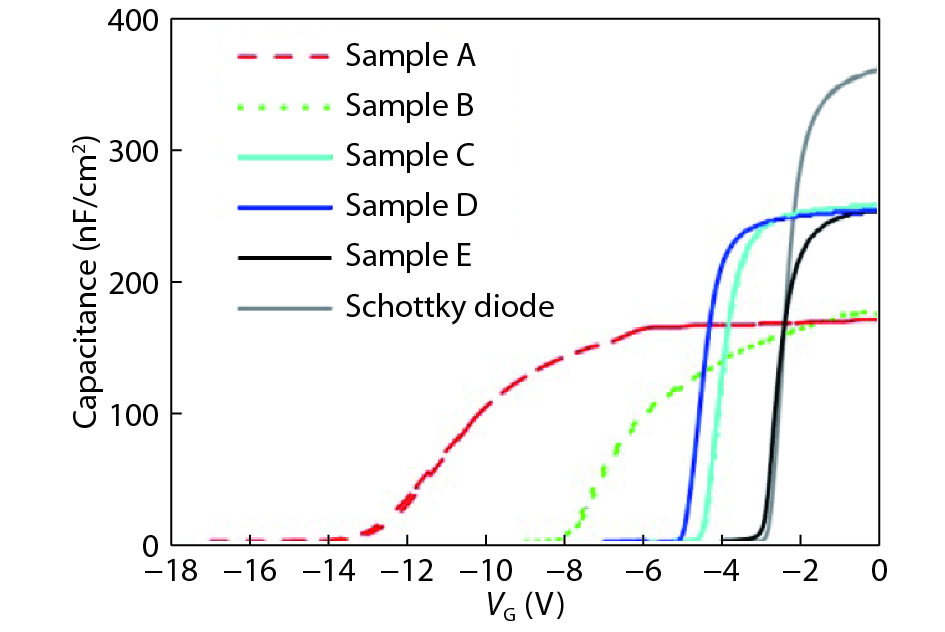
Set citation alerts for the article
Please enter your email address



