Run Tian, Chao Ma, Jingmin Wu, Zhiyu Guo, Xiang Yang, Zhongchao Fan. A review of manufacturing technologies for silicon carbide superjunction devices[J]. Journal of Semiconductors, 2021, 42(6): 061801
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 6, 061801 (2021)
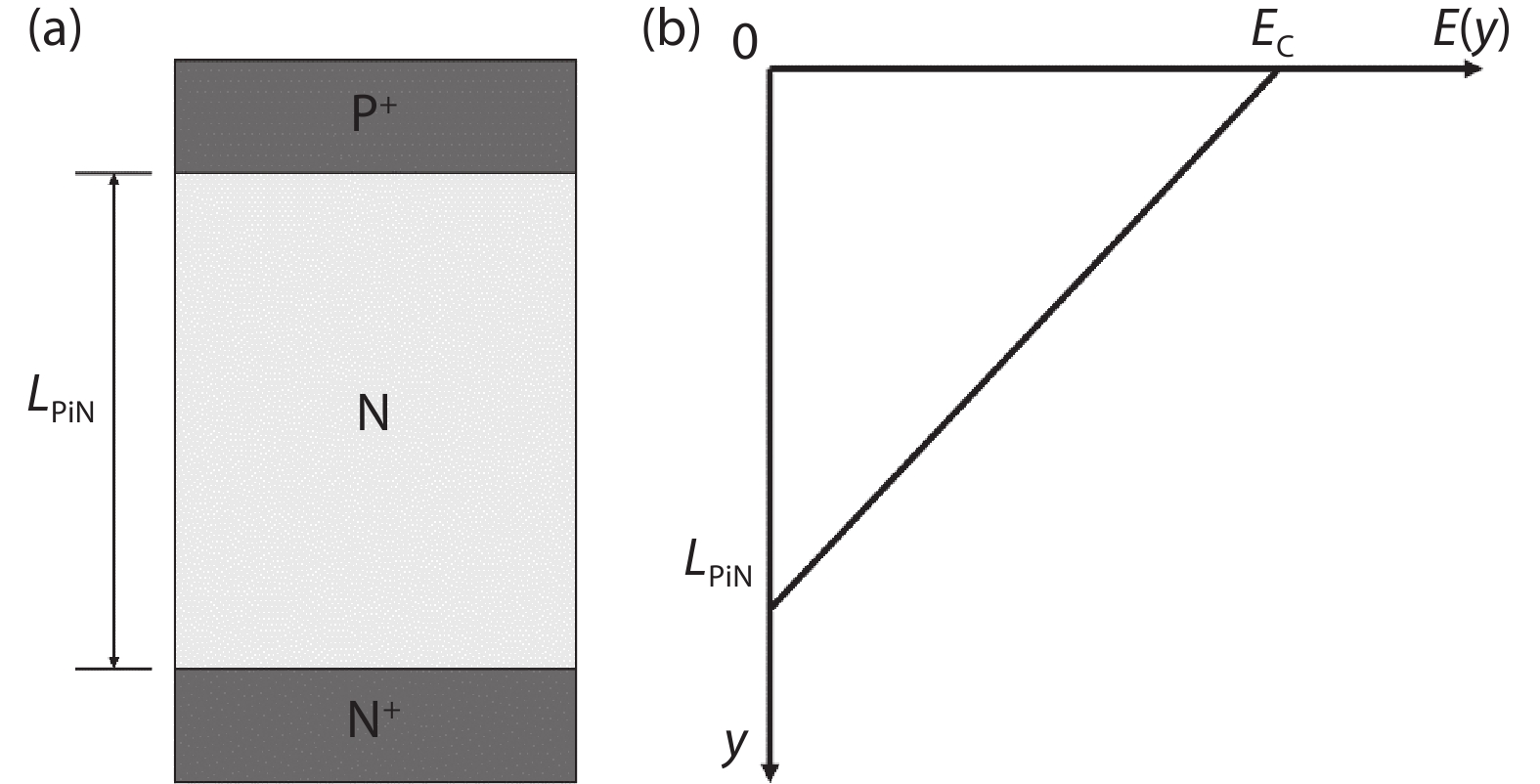
Fig. 1. (a) A typical P–i–N structure. (b) Electric field distribution.
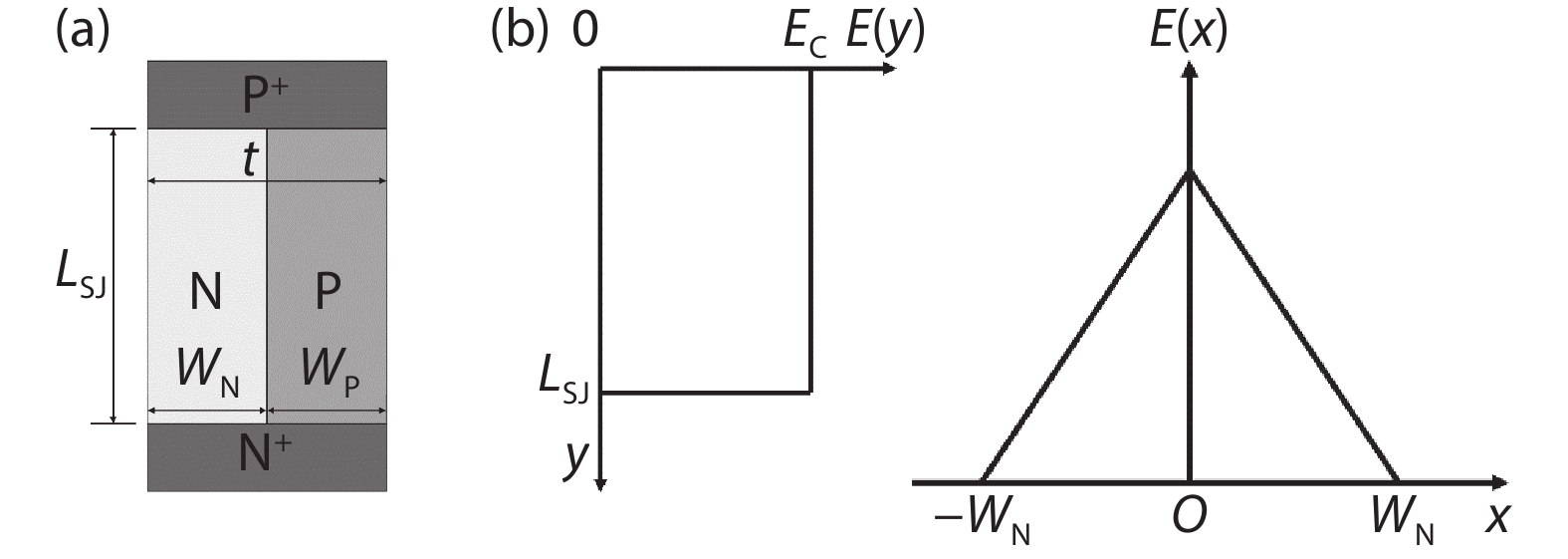
Fig. 2. (a) SJ structure. (b) Electric field distribution in y - and x -directions.
Fig. 3. Process flow diagram of MEG.
Fig. 4. (Color online) The schematic diagram of energy-filter technology[15 ].
Fig. 5. Process flow diagram of TFE.
Fig. 6. A schematic diagram of trenches parallel to
Fig. 7. The schematic diagram of the trench mask pattern.
Fig. 8. The schematic diagrams of the cross section of the samples after trench filling.
Fig. 9. Process flow of the trench and implantation technique.
Fig. 10. (Color online) The schematic diagram of the trenches with inclined sidewall.
|
Table 1. The calculation results of SRIM software.
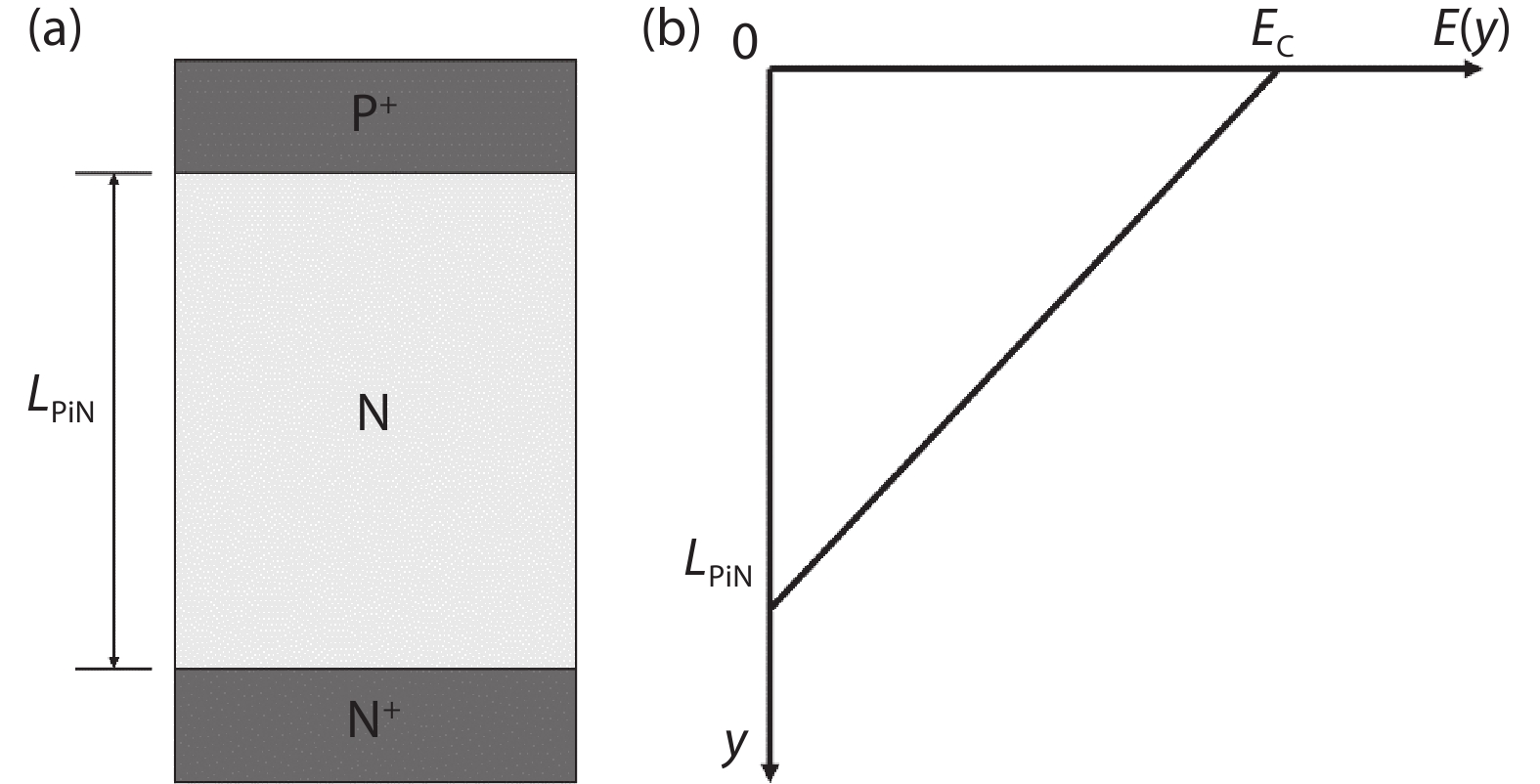
Set citation alerts for the article
Please enter your email address



