Zhangli Liu, Bingkui He, Fei Meng, Qiang Bao, Yuhong Sun, Shaojun Sun, Guangwei Zhou, Xiuliang Cao, Haiwei Xin. Contact etch process optimization for RF process wafer edge yield improvement[J]. Journal of Semiconductors, 2019, 40(12): 122402
Search by keywords or author
- Journal of Semiconductors
- Vol. 40, Issue 12, 122402 (2019)

Fig. 1. (Color online) Yield loss map induced by the CT open issue.
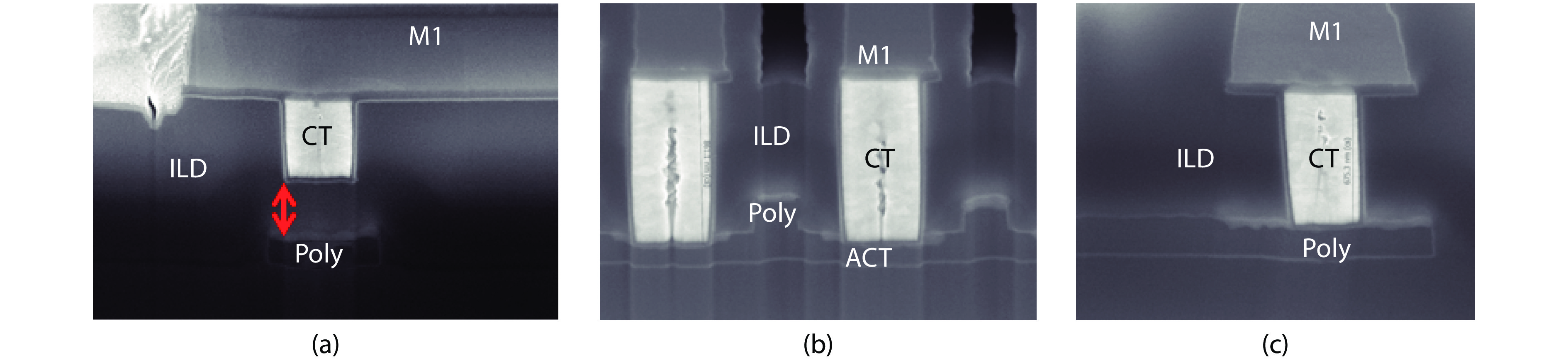
Fig. 2. FA SEM result for a CP fail sample at different pattern regions: (a) CT on poly-sparse pattern; (b) CT on an active region; and (c) CT on a poly-dense pattern. M1 is metal 1 for electrical connection, ILD is inter-layer-dielectric, ACT is active region for device, poly is for MOSFET or resistance, salicide is formed between CT and ACT/poly.
Fig. 3. Failure mechanism for CT open for sparse poly-pattern at most of the wafer’s edge. (a) CT pattern top view. (b) BARC layer wafer center. (c) CT formed at wafer center. (d) BARC layer wafer edge. (e) CT formed at wafer edge.
Fig. 4. (Color online) Instruction for CT etch BT and ME steps pre- and post-optimization. The blue line is normal CT etch process for wafer center; the red line is pre-optimization CT etch process at wafer edge; the green line is post-optimization CT etch process at wafer edge.
Fig. 5. (Color online) (a) Yield map and (b) SEM result at CT on sparse poly-pattern at wafer edge with CT etch optimization recipe.
Fig. 6. TEM result for CT etch process with (a) POR and (b) post-optimization recipe.
Fig. 7. (Color online) RcN+ and RcP+ WAT mapping data BOX chart. W.26 mean the CT size is 0.26 × 0.26 µ m2.
| ||||||||||||
Table 1. Etch rate for BARC and ILD oxide.

Set citation alerts for the article
Please enter your email address



