R. Singh, T. R. Lenka, R. T. Velpula, B. Jain, H. Q. T. Bui, H. P. T. Nguyen. Investigation of current collapse and recovery time due to deep level defect traps in β-Ga2O3 HEMT[J]. Journal of Semiconductors, 2020, 41(10): 102802
Search by keywords or author
- Journal of Semiconductors
- Vol. 41, Issue 10, 102802 (2020)
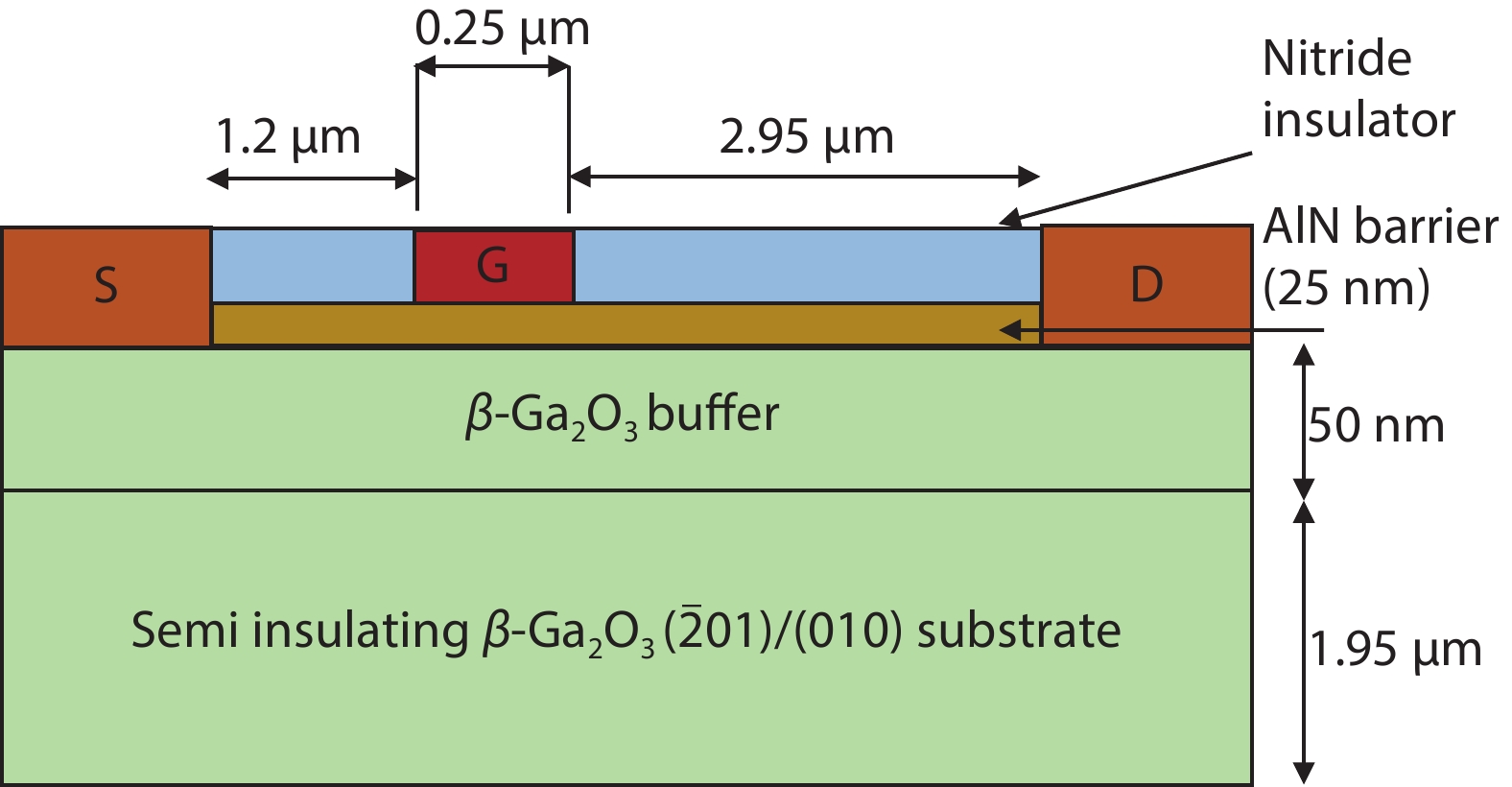
Fig. 1. (Color online) Schematic cross sectional view of the analysed device structure.

Fig. 2. (Color online) Pre-stress and post-stress bias voltages at gate and drain terminals.
Fig. 3. (Color online) Pre-stress and post-stress drain current. Inset: current collapse.
Fig. 4. (Color online) Trapping and de-trapping of defect trap under gate stress.
Fig. 5. (Color online) Drain stress and recovery of current recovery due to de-population of traps.
Fig. 6. (Color online) Current collapse and recovery curve, showing intentional doped Fe causes most of the current collapse and Ge doping caused current collapse takes approximately 2 h to attain steady state value.
Fig. 7. (Color online) Ionised trap density horizontally at a depth of 0.5 μ m in the substrate.
|
Table 1. Deep level traps reported in β -Ga2O3 substrate and epitaxial layer, energy level, capture cross section and trap concentration. Fe and Ge enabled current collapse and drain current recovery time to pre-stress condition.
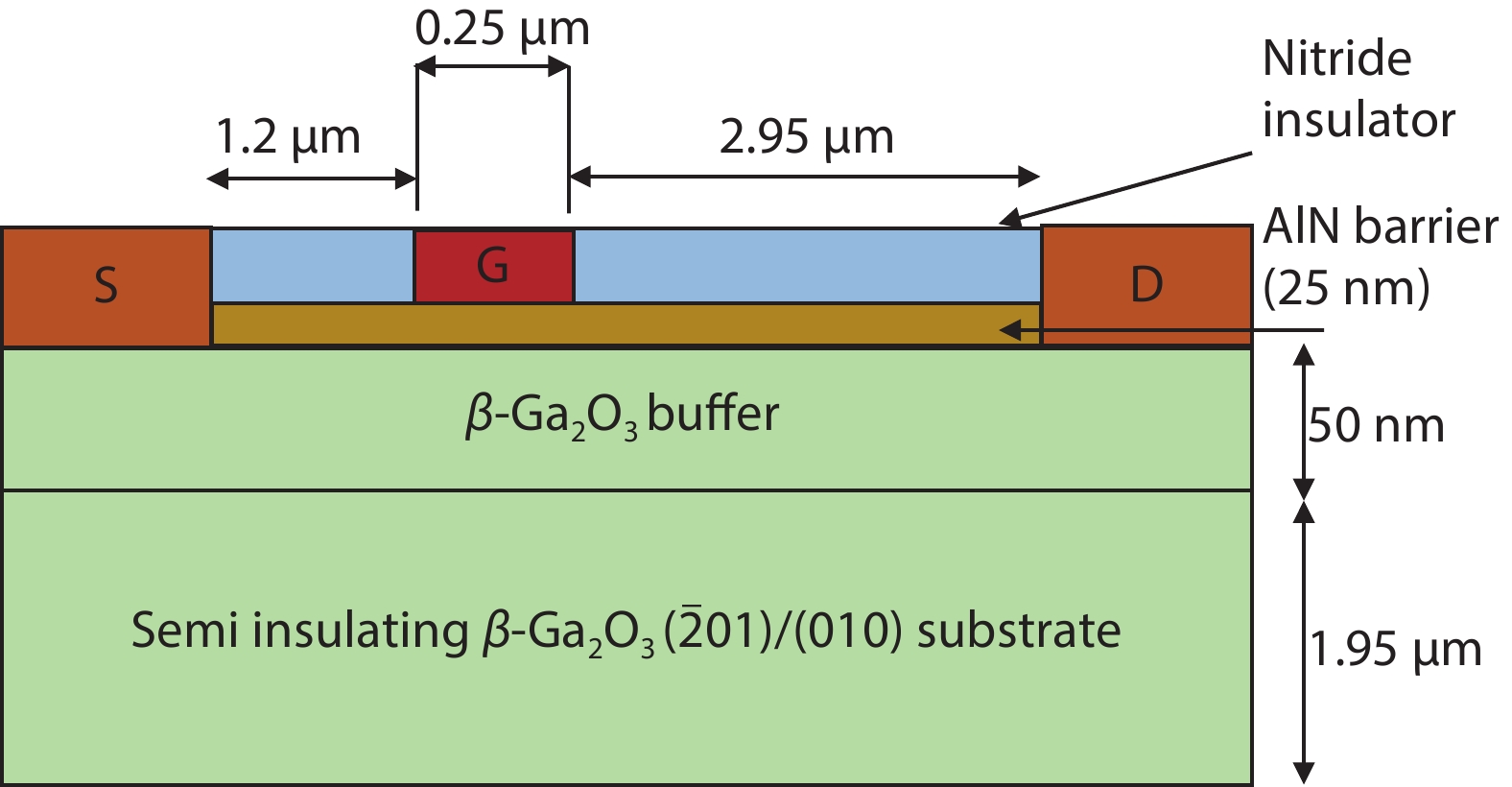
Set citation alerts for the article
Please enter your email address



