- Journal of Semiconductors
- Vol. 40, Issue 10, 101306 (2019)
Abstract
1. Introduction
High-speed optical communication and fast neuromorphic optical computation highly demand low-cost photonic integrated circuits (PIC) on the silicon platform[
Based on the improvement of static performances, dynamical characteristics of Ge- or Si-based Qdot lasers are drawing more and more attentions, which can directly determine the design of PIC systems. This article provides an overview of recent progresses on the laser dynamics of linewidth broadening factor (LBF), relative intensity noise (RIN), frequency noise (FN, or phase noise), sensitivity to optical feedback, intensity modulation, and mode locking operation, which are compared to those of Qdot lasers grown on native GaAs substrate. The paper is organized as follows: Section 2 introduces a rate equation model for Qdot lasers and analyzes all the dynamical characteristics theoretically. Section 3 discusses the LBF, and Section 4 discusses the RIN and its sensitivity to optical feedback. Section 5 investigates the direct intensity modulation including both the small-signal response and the large-signal response. Section 6 studies the mode locking characteristics of Si-based Qdot lasers. Section 7 discusses the future trends, and Section 8 summarizes this work.
2. Rate equation analysis
The rate equation model for Qdot lasers takes into account the carrier dynamics in the carrier reservoir (RS, wetting layer), in the first excited state (ES), and in the ground state (GS). The Qdot laser is assumed to emit solely on a single mode at the GS, and the inhomogeneous broadening effect is not considered. The coupled rate equations for the carrier numbers (NRS, NES, NGS), the photon number (S), and the phase (φ) of the electric field are given by[
where I is the pump current, and η is the current injection efficiency.
Epitaxial defect in semiconductors induces nonradiative recombination through the Shockley-Read-Hall process, and the nonradiative recombination lifetime τnr is inversely proportional to the defect density. The defect density in GaAs-based Qdot lasers is 103–104 cm–2 or less, and the corresponding τnr is on the order of 10 ns, which is much longer than the spontaneous emission lifetime (~1.0 ns). Therefore, the nonradiative recombination term in the rate equations is negligible[
The simulations in Fig. 1 show that the fast nonradiative recombination process or the high defect density raises the threshold current, which is the same as widely observed in experiments[
![]()
Figure 1.(Color online) Nonradiative recombination effects on the threshold current and the carrier numbers in GS, ES, and RS at the threshold, respectively.
The LBF characterizes the coupling ratio of the carrier-induced refractive index variation to the gain variation in semiconductor lasers[
![]()
Figure 2.(Color online) Nonradiative recombination effects on the LBF. (Reproduced from Ref. [
The RIN characterizes the intensity noise of semiconductor lasers, and it is defined as the ratio of the power spectral density of intensity noise to the square of the averaged optical power[
![]()
Figure 3.(Color online) Non-radiative recombination effects on (a) the RIN spectrum, (b) the FN spectrum, and (c) the low-frequency RIN and the peak FN.
The FN of semiconductor laser originates from the spontaneous emission as well. The high-frequency (> 20 GHz) FN inFig. 3(b) determines the Schawlow-Townes linewidth. However, the low-frequency (< 1.0 GHz) FN inFig. 3(b) is amplified by the LBF (α) by a factor of (1 + α2), which directly determines the total spectral linewidth of semiconductor lasers[
Fig. 4(a) shows that the fast nonradiative recombination suppresses the resonance peak. This is because the nonradiative recombination shortens the total carrier lifetime and hence significantly enhances the damping factor in Fig. 4(b). Consequently, the modulation bandwidth in Fig. 4(b) is reduced slightly from 5.9 GHz at τnr = 10 ns down to 5.5 GHz at τnr = 0.1 ns.
![]()
Figure 4.(Color online) Non-radiative recombination effects on (a) the intensity modulation response, and (b) the 3-dB modulation bandwidth and the damping factor.
Semiconductor lasers in an optical system inevitably suffer from residual optical feedback due to optical connectors or other optical devices in the optical link. When the feedback strength reaches a certain level defined as the critical feedback level, the laser becomes oscillating in the chaos state, which is also known as coherence collapse[
There are several analytical models evaluating the critical feedback level of semiconductor lasers[
where Г is the damping factor, R is the facet reflectivity, and τin is the light round-trip time in the laser cavity. According to Eq. (6), a large damping factor and/or a small LBF are desirable for increasing the critical feedback level. Surprisingly, fast nonradiative recombination in Fig. 5 raises the critical feedback level from –14.0 dB at τnr = 10 ns up to –10.4 dB at τnr = 0.1 ns. This is understandable because the nonradiative recombination substantially enhances the damping factor in Fig. 4(b), and slightly reduces the LBF in Fig. 2.
![]()
Figure 5.(Color online) Non-radiative recombination effects on the critical feedback level. (Reproduced from Ref. [
3. Linewidth broadening factor
In experiments, the LBF of semiconductor lasers can be measured by a few techniques as reviewed in Ref. [32]. However, the most widely employed method is the Hakki-Paoli method[
with L being the cavity length, and Δλ being the adjacent mode spacing. However, the accuracy of this method is limited by the thermal effect, which induces red-shift of the longitudinal mode. Therefore, pulsed power source is usually used to pump the laser to reduce the thermal effect, which in turn weakens the optical signal. In 2016, Wang et al. proposed an improved Hakki-Paoli method taking advantage of the optical injection locking technique, which was thermally insensitive and hence improved the accuracy of LBF measurement[
Fig. 6 investigates the sub-threshold LBFs of Qdot lasers epitaxially grown on a Ge(100) wafer with 6° off-cut towards [111] plane by the gas-source molecular beam epitaxy based on the Hakki-Paoli method. The active region of the two laser samples consists of five stack layers of dot-in-well structures. Both lasers are fabricated from the same wafer, and are operated on GS. The only difference between the two laser devices is the cavity length. Fig. 6(a) shows that the LBF of the Ge-based laser with a cavity length of 4.4 mm decreases from 3.0 at 1208 nm down to 2.0 at 1218 nm. The LBF at gain peak of 1213 nm is around 2.5. In contrast, Fig. 6(b) shows that the LBF of the Ge-based laser with a cavity length of 2.2 mm increases from 1.7 at 1184 nm up to 4.1 at 1194 nm. The LBF at the gain peak of 1190 nm is about 3.0. The different tendency of the LBF versus the lasing wavelength in both laser can be attributed to the large dot size dispersion[
![]()
Figure 1.(Color online) Nonradiative recombination effects on the threshold current and the carrier numbers in GS, ES, and RS at the threshold, respectively.
Fig. 7 studies sub-threshold LBFs of InAs/GaAs Qdot lasers epitaxially grown on an on-axis Si (001) wafer by the solid-source molecular beam epitaxy[
![]()
Figure 2.(Color online) Nonradiative recombination effects on the LBF. (Reproduced from Ref. [
It is remarked that although Fig. 2 shows that the nonradiative recombination slightly reduces the LBF, it is negligible in comparison with the inhomogeneous broadening effect[
4. RIN and sensitivity to optical feedback
Fig. 8 compares the measured RINs of a Ge-based Qdot laser and of a GaAs-based one. Both lasers have the same epilayer structure except the substrate[
![]()
Figure 3.(Color online) Non-radiative recombination effects on (a) the RIN spectrum, (b) the FN spectrum, and (c) the low-frequency RIN and the peak FN.
Fig. 9 compares the feedback sensitivity of a Ge-based Qdot laser and a GaAs-based one. Both lasers have the same epilayer structure and the same cavity structure[
![]()
Figure 4.(Color online) Non-radiative recombination effects on (a) the intensity modulation response, and (b) the 3-dB modulation bandwidth and the damping factor.
Fig. 10 compares the measured RINs of a 1.3 μm InAs/GaAs Qdot laser epitaxially grown on (001)Si and of a 1.5 μm AlGaInAs Qwell laser heterogeneously integrated on Si[
![]()
Figure 5.(Color online) Non-radiative recombination effects on the critical feedback level. (Reproduced from Ref. [
The experimental observation in Fig. 10 is confirmed through measuring the optical spectrum and the electrical spectrum in Fig. 11[
![]()
Figure 6.(Color online) Sub-threshold LBF of Ge-based Qdot lasers with a cavity length of (a) 4.4 mm and (b) 2.2 mm. Both lasers have a ridge width of 4.0
5. Direct modulation response
For short-reach optical links such as PICs and data centers, direct modulation scheme is more desirable than external modulation one, because the frequency chirp of the laser source does not affect a lot the signal quality in short distance. 1.3 μm InAs/GaAs Qdot lasers have shown record small-signal modulation bandwidth of 13 GHz[
Hantschmann et al. reported the small-signal modulation response of InAs/GaAs Qdot lasers epitaxially grown on (001) Si with 4° off-cut towards [001] plane[
![]()
Figure 8.(Color online) RINs of (a) Ge-based Qdot laser (
Inoue et al. reported the direct modulation characteristics of an InAs/GaAs Qdot laser epitaxially grown on on-axis (001)Si[
![]()
Figure 10.(Color online) Effects of optical feedback on RINs of (a) a Qdot laser epitaxially grown on Si (
6. Mode-locking operation
Mode-locking semiconductor lasers can generate a large number of coherent longitudinal modes. One mode-locking laser can be used as a multi-channel light source for wavelength division multiplexing communications[
Fig. 14(a) illustrates the schematic structure of an InAs/GaAs Qdot laser epitaxially grown on on-axis (001)Si substrate[
![]()
Figure 11.(Color online) Optical feedback effects on (a, b) the optical power distribution of two cavity modes, and (c, d) on the electrical power distribution. (a) and (c) are for a Si-based Qdot laser (
Fig. 15 shows the characteristics of another mode-locked Qdot laser epitaxially on on-axis (001) Si, which was fabricated in the same group as Fig. 14[
![]()
Figure 13.(Color online) Intensity modulation responses of (a) undoped and (b) p-doped Qdot lasers on Si. (c) Eye diagrams of the p-doped laser, under non-return-to-zero modulation. The cavity length is 0.58 mm. (Reproduced from Ref. [
In addition to the two-section mode locking scheme, Qdot lasers of one single gain section are widely found to exhibit mode locking as well[
7. Future trends
All the Ge- or Si-based Qdot lasers investigated in sections 3–6 are based on Fabry-Perot cavity, which emit on multimodes. However, practical applications in optical communication and in optical computing require single-mode laser sources, which are widely achieved through using the distributed feedback (DFB) gratings. Wang et al. have successfully demonstrated DFB Qdot laser arrays on off-cut (001) Si substrate, which showed a high side mode suppression ratio of 50 dB. Besides, the DFB laser arrays cover the full spectral span of the O band, with a channel spacing of 20 nm[
Most Qdot lasers epitaxially grown on Si are operated in the O band, while C band laser emission is required for long-haul communication. However, it is more challenging to directly grown 1.5 μm InAs/InP Qdot lasers on Si than 1.3 μm InAs/GaAs Qdot lasers, because the lattice mismatch between InP and Si is as large as about 8%, twice the mismatch between GaAs and Si. This problem is circumvented by using V-grooved Si substrate, which traps most twined stacking faults in Si[
Fabry-Perot or DFB lasers typically have a footprint in the millimeter range. In order to reduce the footprint of laser sources on Si down to the micrometer range, Si-based micro-disk lasers and micro-ring lasers have been developed[
8. Conclusion
In summary, this work systematically discussed recent progresses on the dynamical characteristics of Qdot lasers epitaxially grown on Ge or Si, including the LBF, the RIN and the FN, the modulation response, the sensitivity to optical feedback, and mode-locked performances. Although there is high density of epitaxial defects, some dynamical performances of Ge- or Si-based Qdot lasers are becoming comparable to those of GaAs-based ones. Particularly, these lasers are highly tolerant to optical feedback, owing to the defect-enhanced damping factor. However, it is still highly desirable to further reduce the defect density for further improving both static and dynamic performances. Once Qdot lasers are properly integrated on the Si platform, the next challenging task in future work is to figure out approaches to efficiently couple the laser light into optical waveguides, which connect a large variety of photonic and optoelectronic devices in PICs.
Acknowledgments
This work is supported by National Natural Science Foundation of China (No. 61804095), and by Shanghai Pujiang Program (No. 17PJ1406500).
References
[1] R Soref. The past, present, and future of silicon photonics. IEEE J Sel Top Quantum Electron, 12, 1678(2006).
[2] X Lin, Y Riveson, N T Yardimci et al. All-optical machine learning using diffractive deep neural networks. Science, 361, 1004(2018).
[3] J Cardenas, C B Poitras, J T Robinson et al. Low loss etchless silicon photonic waveguides. Opt Express, 17, 4752(2009).
[4] L Vivien, J Osmond, J M Fédéli et al. 42 GHz p.i.n germanium photodetector integrated in a silicon-on-insulator waveguide. Opt Express, 17, 6252(2009).
[5] G T Reed, G Mashanovich, F Y Gardes et al. Silicon optical modulators. Nat Photon, 4, 518(2010).
[6] D Liang, J E Bowers. Recent progress in lasers on silicon. Nat Photon, 4, 511(2010).
[7] R Alcotte, M Martin, J Moeyaert et al. Epitaxial growth of antiphase boundary free GaAs layer on 300 mm Si (001) substrate by metalorganic chemical vapour deposition with high mobility. APL Mater, 4, 046101(2016).
[8] A Y Liu, R W Herrick, O Ueda et al. Reliability of InAs/GaAs quantum dot lasers epitaxially grown on silicon. IEEE J Sel Top Quantum Electron, 21, 690(2015).
[9] K Tanabe, T Rae, K Watanabe et al. High-temperature 1.3
[10] Y Urino, N Hatori, K Mizutani et al. First demonstration of athermal silicon optical interposers with quantum dot lasers operating up to 125 °C. J Lightw Technol, 33, 1223(2015).
[11] S Uvin, S Kumari, A D Groote et al. 1.3
[12] H Liu, T Wang, Q Jiang et al. Long-wavelength InAs/GaAs quantum-dot laser diode monolithically grown on Ge substrate. Nat Photon, 5, 416(2011).
[13] J C Norman, D Jung, Y Wan et al. Perspective: The future of quantum dot photonic integrated circuits. APL Photonics, 3, 030901(2018).
[14] D Jung, R Herrick, J Norman et al. Impact of threading dislocation density on the lifetime of InAs quantum dot lasers on Si. Appl Phys Lett, 112, 153507(2018).
[15] D O’Brien, S P Hegarty, G Huyet et al. Feedback sensitivity of 1.3
[16] D G Deppe, K Shavritranuruk, G Ozgur et al. Quantum dot laser diode with low threshold and low internal loss. Electron Lett, 45, 54(2009).
[17] M Sugawara, M Usami. Quantum dot devices handling the heat. Nat Photon, 3, 30(2009).
[18] A Lee, Q Jiang, M Tang et al. Continuous-wave InAs/GaAs quantum-dot laser diodes monolithically grown on Si substrate with low threshold current densities. Opt Express, 20, 22181(2012).
[19] S Chen, W Li, J Wu et al. Electrically pumped continuous-wave III–V quantum dot lasers on silicon. Nat Photon, 10, 307(2016).
[20] A Y Liu, J Peters, X Huang et al. Electrically pumped continuous-wave 1.3
[21] M A Tischler, T Katsuyama, N A El-Masry et al. Defect reduction in GaAs epitaxial layers using a GaAsP–InGaAs strained-layer superlattice. Appl Phys Lett, 46, 294(1985).
[22] A Y Liu, C Zhang, J Norman et al. High performance continuous wave 1.3
[23] A D Lee, Q Jiang, M Tang et al. InAs/GaAs quantum-dot lasers monolithically grown on Si, Ge, and Ge-on-Si substrates. IEEE J Sel Top Quantum Electron, 19, 1901107(2013).
[24] A Y Liu, S Srinivasan, J Norman et al. Quantum dot lasers for silicon photonics. Photon Res, 3, B1(2015).
[25] J C Norman, D Jung, Z Zhang et al. A review of high-performance quantum dot lasers on silicon. IEEE J Quantum Electron, 55, 1(2019).
[26] C Wang, J P Zhuang, F Grillot et al. Contribution of off-resonant states to the phase noise of quantum dot lasers. Opt Express, 24, 29872(2016).
[27] K Sears, M Buda, H Tan et al. Modeling and characterization of InAs/GaAs quantum dot lasers grown using metal organic chemical vapor deposition. J Appl Phys, 101, 013112(2007).
[28]
[29] K K Linder, J Phillips, O Oasaimeh et al. Self-organized In0.4Ga0.6As quantum-dot lasers grown on Si substrates. Appl Phys Lett, 74, 1355(1999).
[30]
[31] M Osinski, J Buus. Linewidth broadening factor in semiconductor lasers–An overview. IEEE J Quantum Electron, 23, 9(1987).
[32] S K Hwang, D H Liang. Effects of linewidth enhancement factor on period-one oscillations of optically injected semiconductor lasers. Appl Phys Lett, 89, 061120(2006).
[33] S Melnik, G Huyet. The linewidth enhancement factor α of quantum dot semiconductor lasers. Opt Express, 14, 2950(2006).
[34] M Gioannini, I Montrosset. Numerical analysis of the frequency chirp in quantum-dot semiconductor lasers. IEEE J Quantum Electron, 43, 941(2007).
[35] B Globisch, C Otto, E Scholl et al. Influence of carrier lifetimes on the dynamical behavior of quantum-dot lasers subject to optical feedback. Phys Rev E, 86, 046201(2012).
[36] D Bimberg, N Kirstaedter, N N Ledentsov et al. InGaAs–GaAs quantum-dot lasers. IEEE J Sel Top Quantum Electron, 3, 196(1997).
[37] T C Newell, D J Bossert, A Stintz et al. Gain and linewidth enhancement factor in InAs quantum-dot laser diodes. IEEE Photon Technol Lett, 11, 1527(1999).
[38] B Dagens, A Markus, J X Chen et al. Giant linewidth enhancement factor and purely frequency modulated emission from quantum dot laser. Electron Lett, 41, 323(2005).
[39] Z Mi, P Bhattacharya. DC and dynamic characteristics of P-doped and tunnel injection 1.65-
[40] A Martinez, K Merghem, S Bouchoule et al. Dynamic properties of InAs/InP (311)B quantum dot Fabry-Perot lasers emitting at 1.52
[41] S Bhowmick, M Z Baten, T Frost et al. High performance InAs/In0.53Ga0.23Al0.24As/InP quantum dot 1.55
[42] M Gioannini, A Sevega, t I Montrosset. Simulations of differential gain and linewidth enhancement factor of quantum dot semiconductor lasers. Opt Quantum Electron, 38, 381(2006).
[43] Y G Zhou, X Y Zhao, C F Cao et al. High optical feedback tolerance of InAs/GaAs quantum dot lasers on germanium. Opt Express, 26, 28131(2018).
[44] M Ahmed, M Yamada, M Saito. Numerical modeling of intensity and phase noise in semiconductor lasers. IEEE J Quantum Electron, 37, 1600(2001).
[45] R J Fronen, L K J Vandamme. Low-frequency intensity noise in semiconductor lasers. IEEE J Quantum Electron, 24, 724(1988).
[46] A Capua, L Rozenfeld, V Mikhelashvili et al. Direct correlation between a highly damped modulation response and ultra low relative intensity noise in an InAs/GaAs quantum dot laser. Opt Express, 15, 5388(2007).
[47] J Duan, X G Wang, Y G Zhou et al. Carrier-noise-enhanced relative intensity noise of quantum dot lasers. IEEE J Quantum Electron, 54, 1(2018).
[48]
[49] D O'Brien, S P Hegarty, G Huyet et al. Sensitivity of quantum-dot semiconductor lasers to optical feedback. Opt Lett, 29, 1072(2004).
[50] J O Binder, G D Cormack. Mode selection and stability of a semiconductor laser with weak optical feedback. IEEE J Quantum Electron, 25, 2255(1989).
[51] J Helms, K Petermann. A simple analytic expression for the stable operation range of laser diode with optical feedback. IEEE J Quantum Electron, 26, 833(1990).
[52] B Tromborg, J Mork. Nonlinear injection locking dynamics and the onset of coherence collapse in external cavity lasers. IEEE J Quantum Electron, 26, 642(1990).
[53] C Wang, K Schires, M Osinski et al. Thermally insensitive determination of the linewidth broadening factor in nanostructured semiconductor lasers using optical injection locking. Sci Rep, 6, 27825(2016).
[54] Y G Zhou, J Duan, H Huang et al. Intensity noise and pulse oscillation of an InAs/GaAs quantum dot laser on germanium. IEEE J Sel Top Quantum Electron, 25, 1(2019).
[55] J Duan, H Huang, D Jung et al. Semiconductor quantum dot lasers epitaxially grown on silicon with low linewidth enhancement factor. Appl Phys Lett, 112, 251111(2018).
[56] D Jung, J Norman, M J Kennedy et al. High efficiency low threshold current 1.3
[57] K Jungho, S Hui, S Minin et al. Comparison of linewidth enhancement factor between p-doped and undoped quantum-dot lasers. IEEE Photon Technol Lett, 18, 1022(2006).
[58] Y G Zhou, C Zhou, C F Cao et al. Relative intensity noise of InAs quantum dot lasers epitaxially grown on Ge. Opt Express, 25, 28817(2017).
[59] U Feiste. Optimization of modulation bandwidth in DBR lasers with detuned bragg reflectors. IEEE J Quantum Electron, 34, 2371(1998).
[60] A Laakso, M Dumitrescu. Modified rate equation model including the photon-photon resonance. Opt Quantum Electron, 42, 785(2011).
[61] A Y Liu, T Komljenovic, M L Davenport et al. Reflection sensitivity of 1.3
[62] N Schunk, K Petermann. Numerical analysis of the feedback regimes for a single-mode semiconductor laser with external feedback. IEEE J Quantum Electron, 24, 1242(1988).
[63] J Duan, H Huang, B Dong et al. 1.3-
[64] M Liao, S Chen, Z Liu et al. Low-noise 1.3
[65] H Huang, J Duan, D Jung et al. Analysis of the optical feedback dynamics in InAs/GaAs quantum dot lasers directly grown on silicon. J Opt Soc Am B, 35, 2780(2018).
[66] T Kageyama, Q H Vo, K Watanabe et al. Large modulation bandwidth (13.1 GHz) of 1.3
[67] M Ishida, M Matsuda, Y Tanaka et al. Temperature-stable 25-Gbps direct-modulation in 1.3-
[68] A Abdollahinia, S Banyoudeh, A Rippien et al. Temperature stability of static and dynamic properties of 1.55
[69] S Banyoudeh, A Abdollahinia, O Eyal et al. Temperature-insensitive high-speed directly modulated 1.55-
[70] C Hantschmann, P P Vasilev, A Wonfor et al. Understanding the bandwidth limitations in monolithic 1.3
[71] D Inoue, D Jung, J Norman et al. Directly modulated 1.3
[72] M G Thompson, A R Rae, X Mo et al. InGaAs quantum-dot mode-locked laser diodes. IEEE J Sel Top Quantum Electron, 15, 661(2009).
[73] S Liu, J C Norman, D Jung et al. Monolithic 9 GHz passively mode locked quantum dot lasers directly grown on on-axis (001) Si. Appl Phys Lett, 113, 041108(2018).
[74] G J Simonis, K G Purchase. Optical generation, distribution, and control of microwaves using laser heterodyne. IEEE Trans Microwave Theory Tech, 38, 667(1990).
[75] A Stöhr, A Akrout, R Buß et al. 60 GHz radio-over-fiber technologies for broadband wireless services. J Opt Netw, 8, 471(2009).
[76] P J Delfyett, D H Hartman, S Z Ahmad. Optical clock distribution using a mode-locked semiconductor laser diode system. J Lightw Technol, 9, 1646(1991).
[77] T Ohno, K Sato, R Iga et al. Recovery of 160 GHz optical clock from 160 Gbit/s data stream using mode locked laser diode. Electron Lett, 40, 265(2004).
[78] E U Rafailov, M A Cataluna, W Sibbett. Mode-locked quantum-dot lasers. Nature Photon, 1, 395(2007).
[79] S Liu, X Wu, D Jung et al. High-channel-count 20 GHz passively mode-locked quantum dot laser directly grown on Si with 41 Tbit/s transmission capacity. Optica, 6, 128(2019).
[80] G Carpintero, M G Thompson, R V Penty et al. Low noise performance of passively mode-locked 10-GHz quantum-dot laser diode. IEEE Photon Technol Lett, 21, 389(2009).
[81] M L Davenport, S Liu, J E Bowers. Integrated heterogeneous silicon/III–V mode-locked lasers. Photon Res, 6, 468(2018).
[82] J Renaudier, R Brenot, B Dagens et al. 45 GHz self-pulsation with narrow linewidth in quantum dot Fabry-Perot semiconductor lasers at 1.5
[83] J Liu, Z Liu, S Raymond et al. Dual-wavelength 92.5 GHz self-mode-locked InP-based quantum dot laser. Opt Lett, 33, 1702(2008).
[84] S Liu, D Jung, J C Norman et al. 490 fs pulse generation from passively mode-locked single section quantum dot laser directly grown on on-axis GaP/Si. Electron Lett, 54, 432(2018).
[85] M Rossetti, X Tianhong, P Bardella et al. Impact of gain saturation on passive mode locking regimes in quantum dot lasers with straight and tapered waveguides. IEEE J Quantum Electron, 47, 1404(2011).
[86] M Rossetti, P Bardella, I Montrosset. Time-domain travelling-wave model for quantum dot passively mode-locked lasers. IEEE J Quantum Electron, 47, 139(2011).
[87] P Bardella, L L Columbo, M Gioannini. Self-generation of optical frequency comb in single section quantum dot Fabry-Perot lasers: a theoretical study. Opt Express, 25, 26234(2017).
[88] Y Wang, S Chen, Y Yu et al. Monolithic quantum-dot distributed feedback laser array on silicon. Optica, 5, 528(2018).
[89] H Su, L F Lester. Dynamic properties of quantum dot distributed feedback lasers: high speed, linewidth and chirp. J Phys D, 38, 2112(2005).
[90] Z G Lu, P J Poole, J R Liu et al. High-performance 1.52
[91] A Becker, V Sichkovskyi, M Bjelica et al. Narrow-linewidth 1.5-
[92] T Septon, S Gosh, A Becker et al. Spectral characteristics of narrow linewidth InAs/InP quantum dot distributed feedback lasers. 26th International Semiconductor Laser Conference, TuD4(2018).
[93] J Duan, H Huang, Z G Lu et al. Narrow spectral linewidth in InAs/InP quantum dot distributed feedback lasers. Appl Phys Lett, 112, 121102(2018).
[94] T Septon, S Gosh, A Becker et al. Narrow linewidth InAs/InP quantum dot DFB laser. Optical Fiber Communication Conference, W3A.8(2019).
[95] Y Wan, Q Li, Y Geng et al. InAs/GaAs quantum dots on GaAs-on-V-grooved-Si substrate with high optical quality in the 1.3
[96] Q Li, K W Ng, K M Lau. Growing antiphase-domain-free GaAs thin films out of highly ordered planar nanowire arrays on exact (001) silicon. Appl Phys Lett, 106, 072105(2015).
[97] S Zhu, B Shi, Q Li et al. 1.5
[98] Y Wan, Q Li, A Y Liu et al. Sub-wavelength InAs quantum dot micro-disk lasers epitaxially grown on exact Si (001) substrates. Appl Phys Lett, 108, 221101(2016).
[99] Y Wan, Q Li, A Y Liu et al. Optically pumped 1.3
[100] Y Wan, D Jung, J Norman et al. O-band electrically injected quantum dot micro-ring lasers on on-axis (001) GaP/Si and V-groove Si. Opt Express, 25, 26853(2017).
[101] Y Wan, J Norman, Q Li et al. 1.3
[102] B Shi, S Zhu, Q Li et al. 1.55
[103] B Shi, S Zhu, Q Li et al. Continuous-wave optically pumped 1.55
[104] Y Han, Q Li, S Zhu et al. Continuous-wave lasing from InP/InGaAs nanoridges at telecommunication wavelengths. Appl Phys Lett, 111, 212101(2017).
[105] Y Han, W K Ng, C Ma et al. Room-temperature InP/InGaAs nano-ridge lasers grown on Si and emitting at telecom bands. Optica, 5, 918(2018).
[106] Y Han, Q Li, K W Ng et al. InGaAs/InP quantum wires grown on silicon with adjustable emission wavelength at telecom bands. Nanotechnology, 29, 225601(2018).
[107] Y Han, W K Ng, Y Xue et al. Telecom InP/InGaAs nanolaser array directly grown on (001) silicon-on-insulator. Opt Lett, 44, 767(2019).
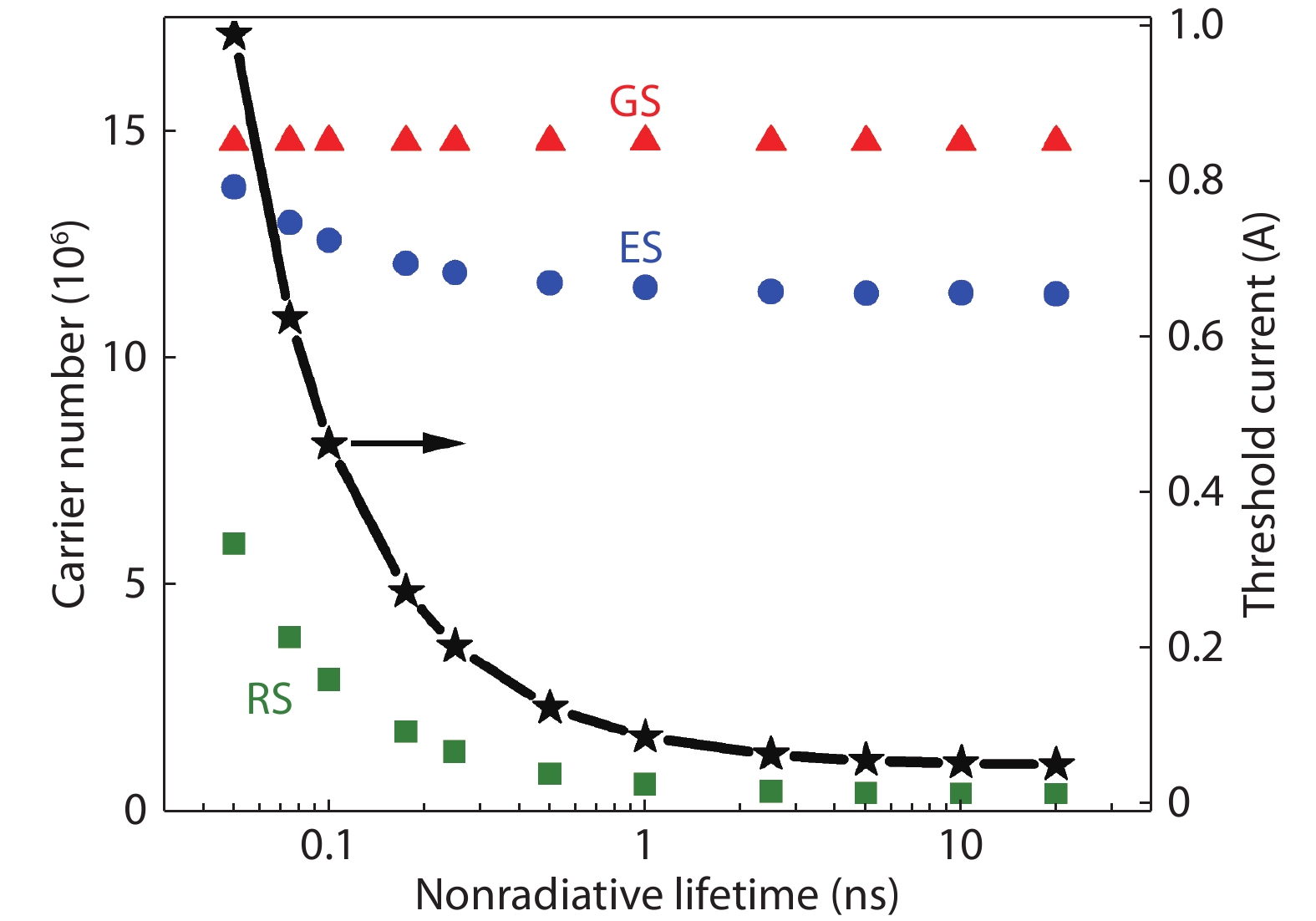
Set citation alerts for the article
Please enter your email address



