Yiding Lin, Kwang Hong Lee, Shuyu Bao, Xin Guo, Hong Wang, Jurgen Michel, Chuan Seng Tan, "High-efficiency normal-incidence vertical p-i-n photodetectors on a germanium-on-insulator platform," Photonics Res. 5, 702 (2017)
Search by keywords or author
- Photonics Research
- Vol. 5, Issue 6, 702 (2017)
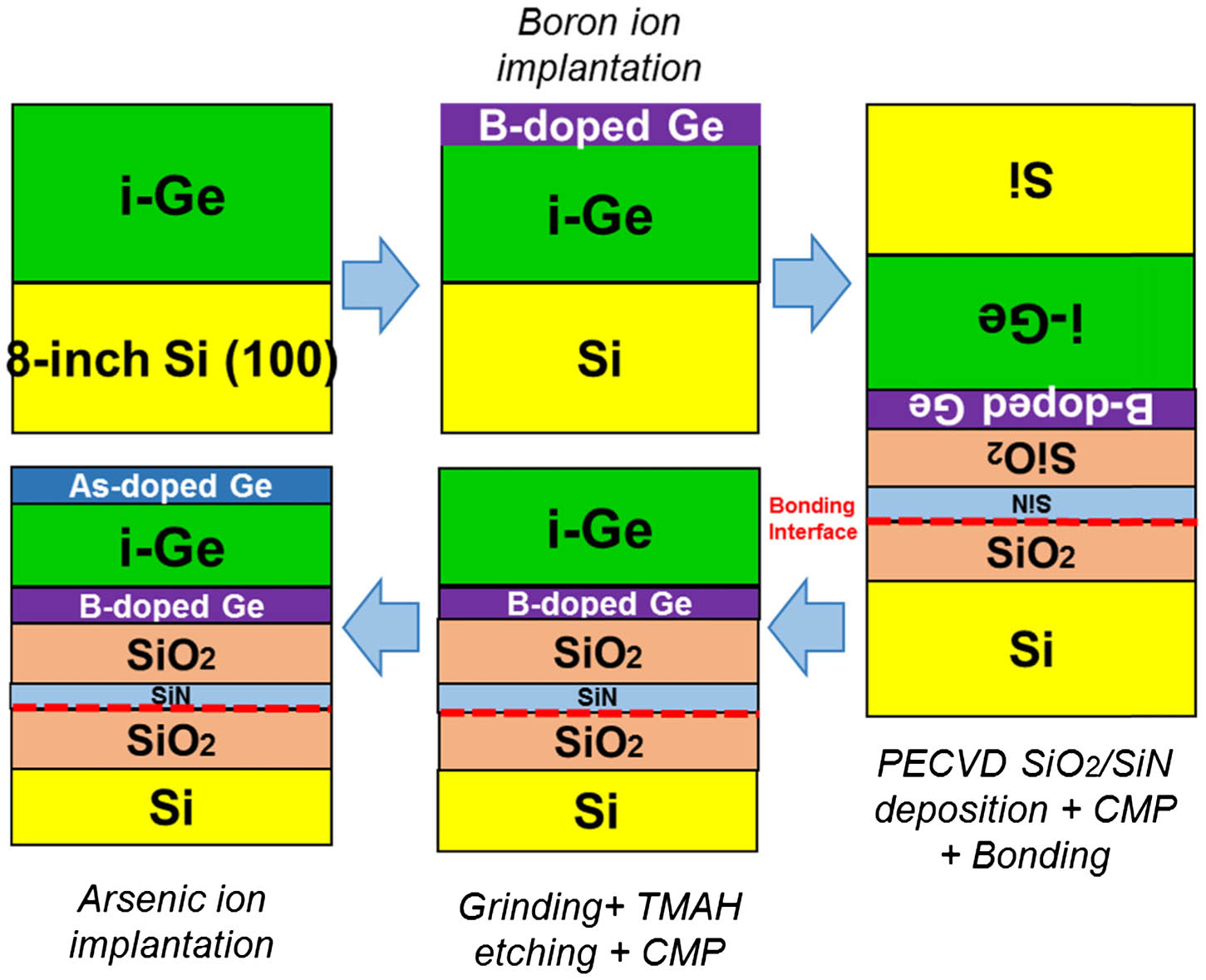
Fig. 1. Schematic of bonding and layer transfer technique for GOI p - i - n
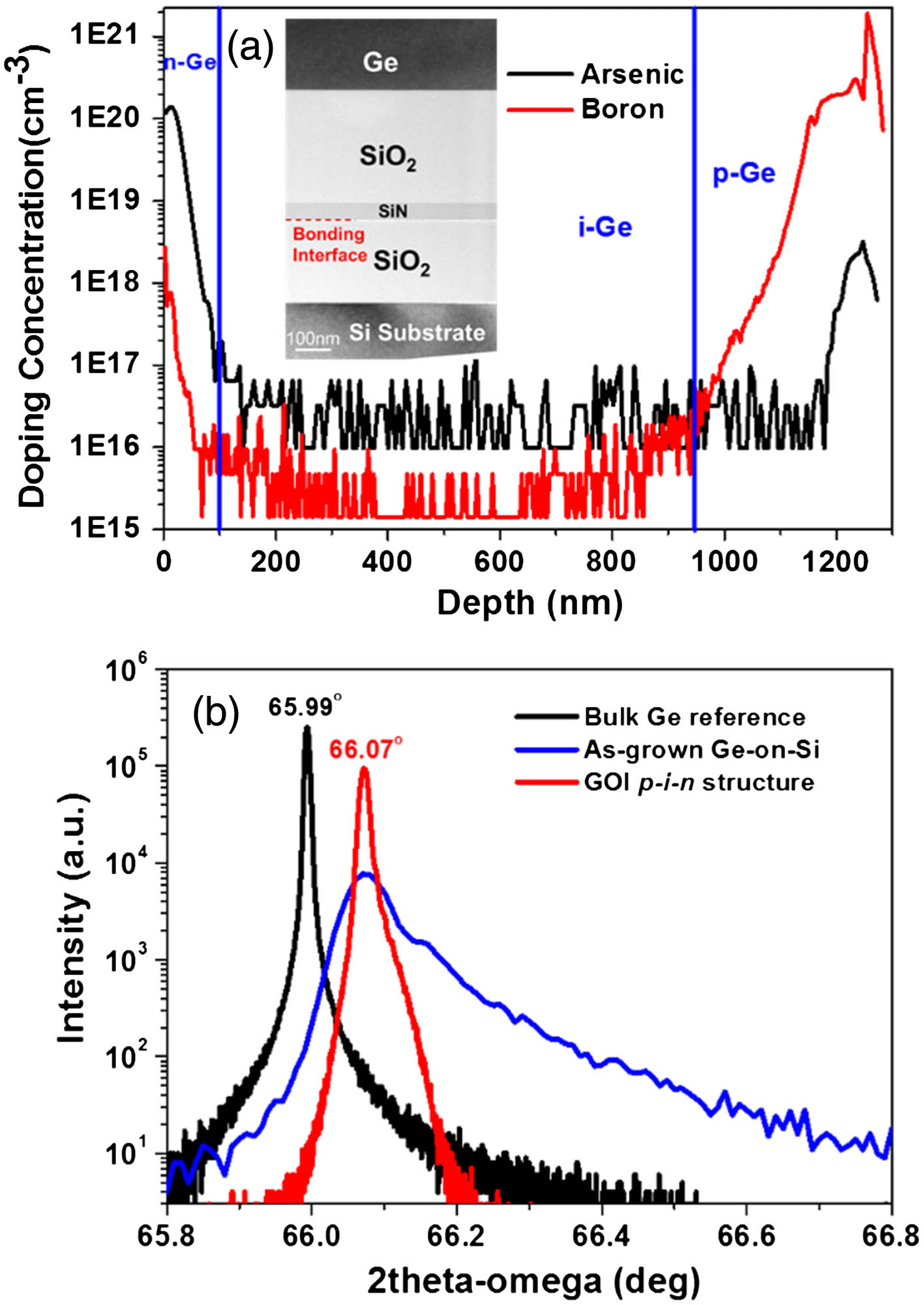
Fig. 2. (a) SIMS doping profiles of B and As in Ge vertical p - i - n p - i - n 2 θ − ω p - i - n ∼ 0.15 % 2 θ − ω
Fig. 3. (a) Cross-sectional schematic of a GOI vertical p - i - n
Fig. 4. (a) Dark current density-voltage characteristic of GOI vertical p - i - n p - i - n − 0.5 V
Fig. 5. (a) Photocurrent of a GOI vertical p - i - n I-V characteristic as a reference. Inset shows the corresponding measurement configuration. (b) Optical responsivity spectrum of GOI vertical p - i - n
Fig. 6. Performance comparison of Ge-based PDs. i i p - i - n
Fig. 7. (a) Frequency response of GOI vertical p - i - n − 2 V I-V characteristics. (b) Calculated 3 dB bandwidth of GOI vertical p - i - n R s = 30 Ω − 2 V i
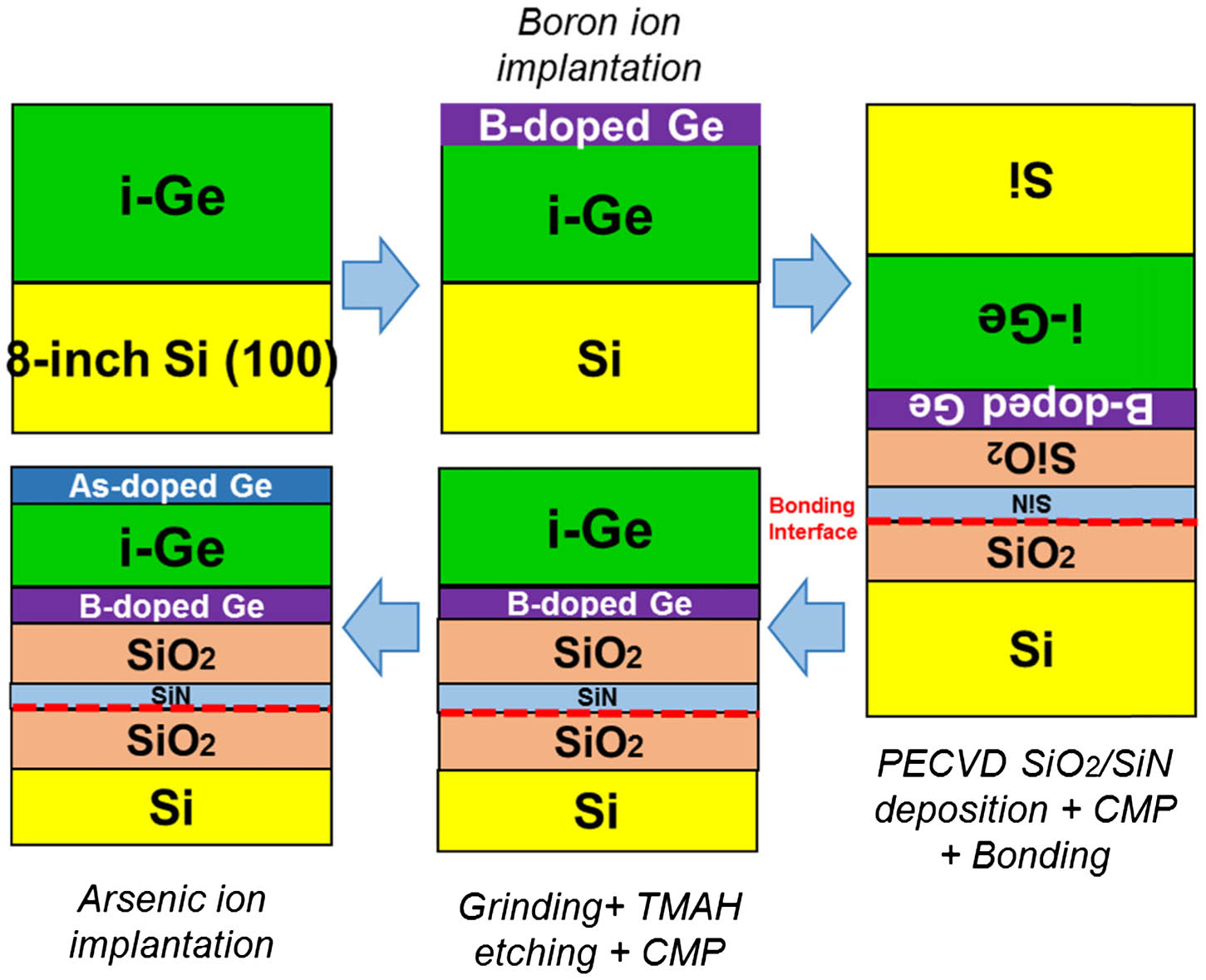
Set citation alerts for the article
Please enter your email address



