Maosong Sun, Jinfeng Li, Jicai Zhang, Wenhong Sun. The fabrication of AlN by hydride vapor phase epitaxy[J]. Journal of Semiconductors, 2019, 40(12): 121803
Search by keywords or author
- Journal of Semiconductors
- Vol. 40, Issue 12, 121803 (2019)
![Gibbs energy diagram for different chemical species during the growth AlN grown by CVD[34].](/richHtml/jos/2019/40/12/121803/img_1.jpg)
Fig. 1. Gibbs energy diagram for different chemical species during the growth AlN grown by CVD[34 ].
![(a) The chemical reaction between the values of Ki and the change of temperature. (b) The relation between temperature and partial pressures[35].](/richHtml/jos/2019/40/12/121803/img_2.jpg)
Fig. 2. (a) The chemical reaction between the values of K i and the change of temperature. (b) The relation between temperature and partial pressures[35 ].
Fig. 3. The schematic diagram of low-temperature HVPE equipment[36 ].
Fig. 4. (Color online) The photo of thick AlN substrates: (a) the free-standing AlN wafer[37 ], (b) and (c) the 1.75-inch and 1-inch diameter AlN wafers[39 ], and (d) 2-inch 75 μm AlN wafer[40 ].
Fig. 5. (a) The double crystal XRC-FWHM values of (0002) and (10
41 ], (b) the relationship between XRC-FWHM values of AlN (0002) rocking curves and growth rates at temperatures of 1150, 1175 and 1200 °C[42 ].
Fig. 6. The SEM cross-section images of AlN films at temperatures (a) 1100, (b) 1150, (c) 1200 °C[42 ].
Fig. 7. (Color online) The surface morphology of AlN grown at initial stage[45 ].
Fig. 8. (Color online) The AFM pictures of AlN with various thickness (a) 390, (b) 650, (c) 1200 nm grown on sapphire substrates[44 ].
Fig. 9. (Color online) (a) Schematic diagram of the HT-HVPE system with high-power lamp[46 ]. (b) The vertical cold-wall HT-HVPE system with induce heating method[47 ]. (c) The conventional HVPE system with internal heating part.
Fig. 10. (Color online) Nomarski micrographs of AlN layers: (a) directly growth, (b) two-step (c) three-step[54 ].
Fig. 11. The TEM images of the AlN films: weak beam dark field (a) g = 0002 and (b) g =
55 ].
Fig. 12. (Color online) (a) The XRC-FWHMs values of AlN films grown on AlN templates and sapphire substrates without nucleation layers[55 ]. (b) Dark-field TEM image of dislocation evolution in AlN grown on AlN/sapphire templates with g = (11
58 ].
Fig. 13. (Color online) The AFM images of AlN grown at different temperatures: (a) 1150, (b) 1200, (c) 1400, and (d) 1450 °C[58 ].
Fig. 14. (Color online) The XRD θ –2 θ scans of AlN nucleation layers grown at 850 and 650 °C[61 ].
Fig. 15. The dark field TEM images for AlN epilayer grown with buffer layers, g = 11
63 ].
Fig. 16. (Color online) The schematic diagram of dislocation evolution by ELOG technique[65 ].
Fig. 17. (Color online) The optical microscopy pictures of AlN grown on: (a) patterned substrate and (b) flat substrate[66 ]. The cross-sectional SEM of AlN grown on patterned 6H-SiC with trench along (c) <1
67 ].
Fig. 18. (Color online) (a) The section STEM images of AlN films with voids. (b) The dependence of Raman shift of E 2(high) mode on the position of samples with and without voids[71 ]. The horizontal line is the stress-free frequency 657.4 cm–1[72 ].
Fig. 19. (a) The corss-sectional SEM of voids in the interface below the 100-nm AlN buffer. (b) The photograph of self-separation AlN substrates with thickness of 79 μ m[76 ].
Fig. 20. (Color online) The photographs: (a) the PVT-AlN substrates, (b) the free-standing AlN substrates[79 ].
Fig. 21. (Color online) The optical microscopy figures of AlN thick films grown by HVPE on (a) on-axis and (b) miscut 5° PVT-AlN substrates[80 ].
|
Table 1. The freestanding AlN fabricated with different techniques.
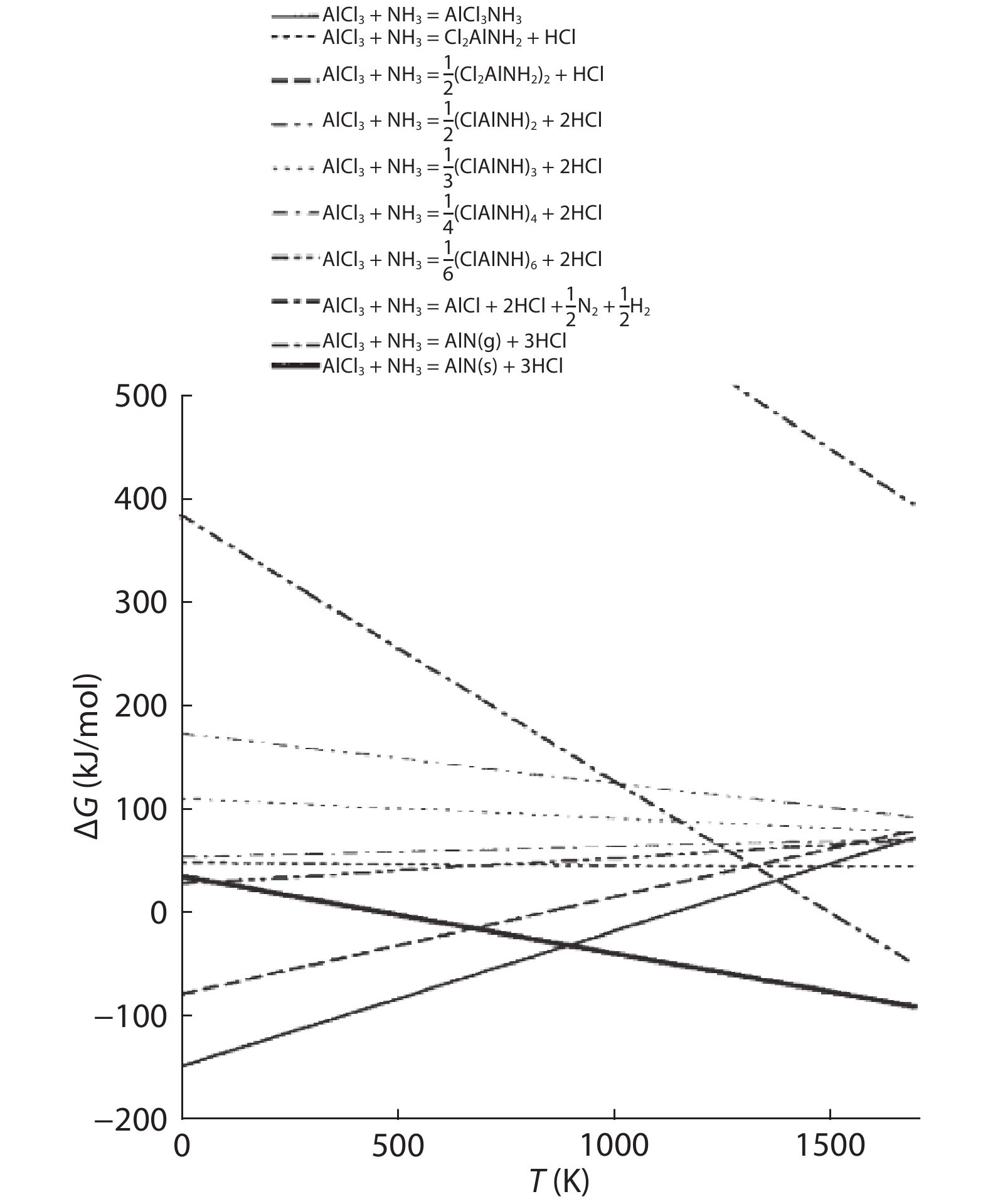
Set citation alerts for the article
Please enter your email address



