Jianqiu Hou, Zengwen Hu, Kuowen Lai, Yule Sun, Bo Shao, Chunyang Wang, Xinran Liu, Karson Liu. The investigation of DARC etch back in DRAM capacitor oxide mask opening[J]. Journal of Semiconductors, 2021, 42(7): 074101
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 7, 074101 (2021)
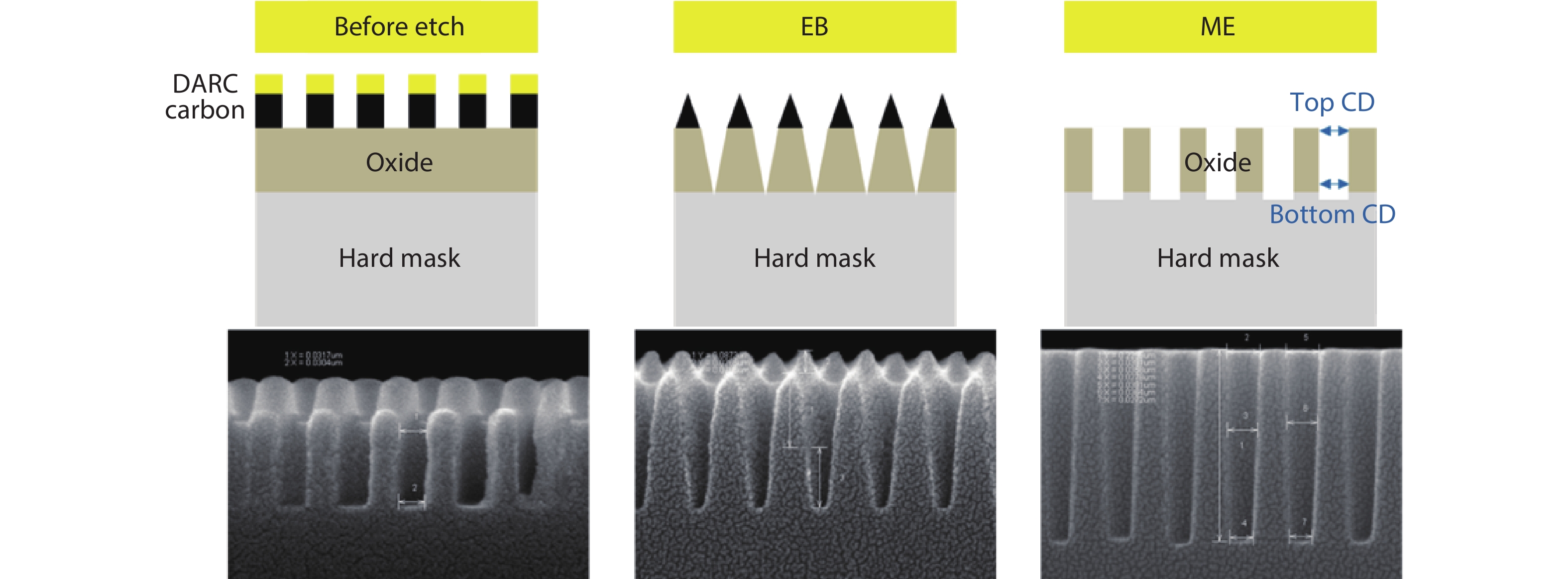
Fig. 1. The strategy of etching oxide mask in the DRAM capacitor.
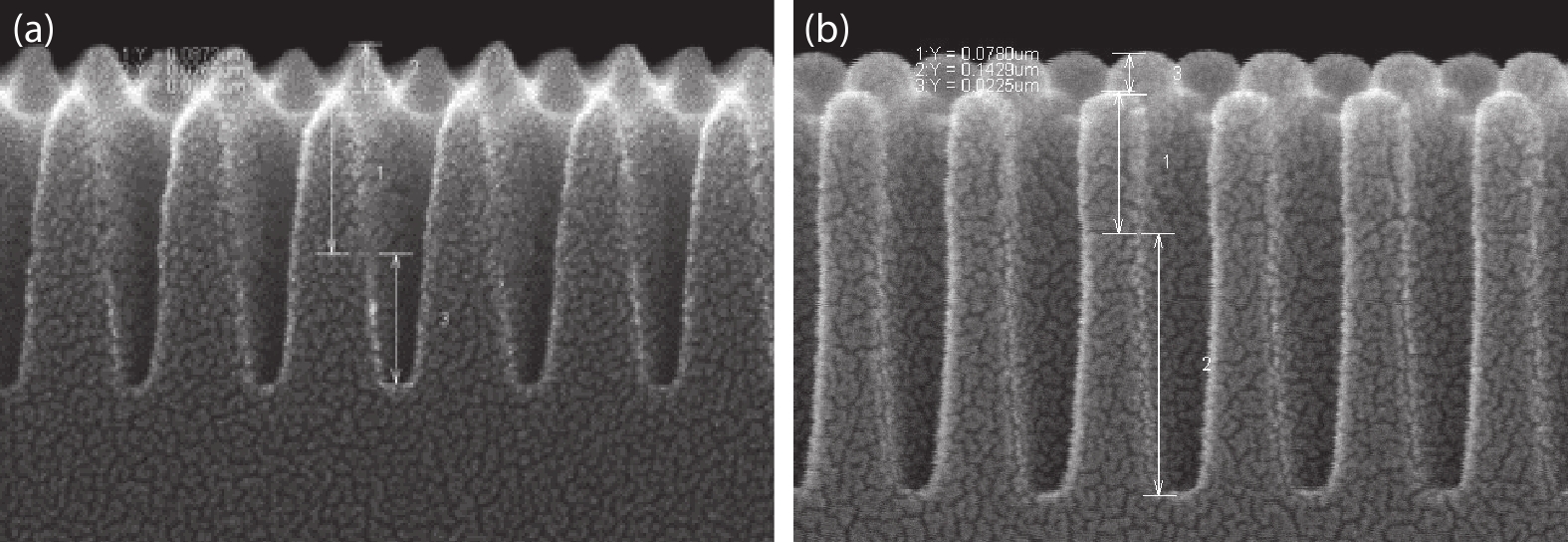
Fig. 2. The XSEM of (a) 30 s partial etch in EB step, (b) 30 s partial etch in ME step.
Fig. 3. The XSEM of various profiles with the condition of (a) 30 s EB + 51 s ME, 77% B/T ratio, (b) 60 s EB + 36 s ME, 70% B/T ratio, (c) 90 s EB + 21 s ME, 52% B/T ratio.
Fig. 4. (a) The DARC remaining issue. (b) The SEM cross section with the conditio of “40 s EB + 0 s ME + 100 s Strip”.
Fig. 5. The SEM top view of the SiOx mask with the condition of (a) 0 s EB + 30 s ME, (b) 30 s EB + 0 s ME, (c, d) 40 s EB + 0 s ME, (e) 50 s EB + 0 s ME, (f) 60 s EB + 0 s ME.
Fig. 6. The trend of SiOx mask CD (current CD, blue one, left axis) and capacitor CD (final CD, red one, right axis) with CH2F2 flow.
Fig. 7. The blanket Si3N4 ER of EB step.
Fig. 8. (Color online) The mechanism of reversed CD trend.
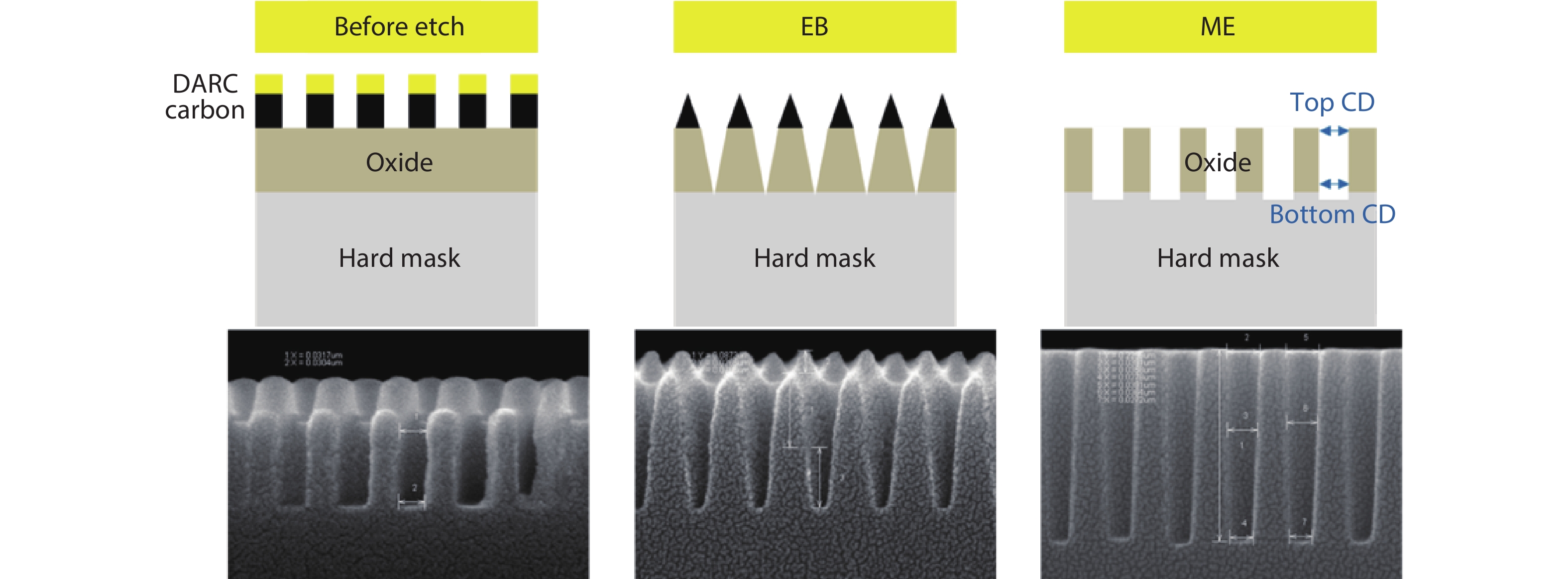
Set citation alerts for the article
Please enter your email address



