Baoshun Wang, Jiangwei Cui, Qi Guo, Qiwen Zheng, Ying Wei, Shanxue Xi. The influence of total ionizing dose on the hot carrier injection of 22 nm bulk nFinFET[J]. Journal of Semiconductors, 2020, 41(12): 122102
Search by keywords or author
- Journal of Semiconductors
- Vol. 41, Issue 12, 122102 (2020)
![(Color online) The structure diagram of nFinFET. (a) A 3D model of bulk FinFET. (b) A cross-section view along A–A’ direction[13].](/richHtml/jos/2020/41/12/122102/img_1.jpg)
Fig. 1. (Color online) The structure diagram of nFinFET. (a) A 3D model of bulk FinFET. (b) A cross-section view along A–A’ direction[13 ].
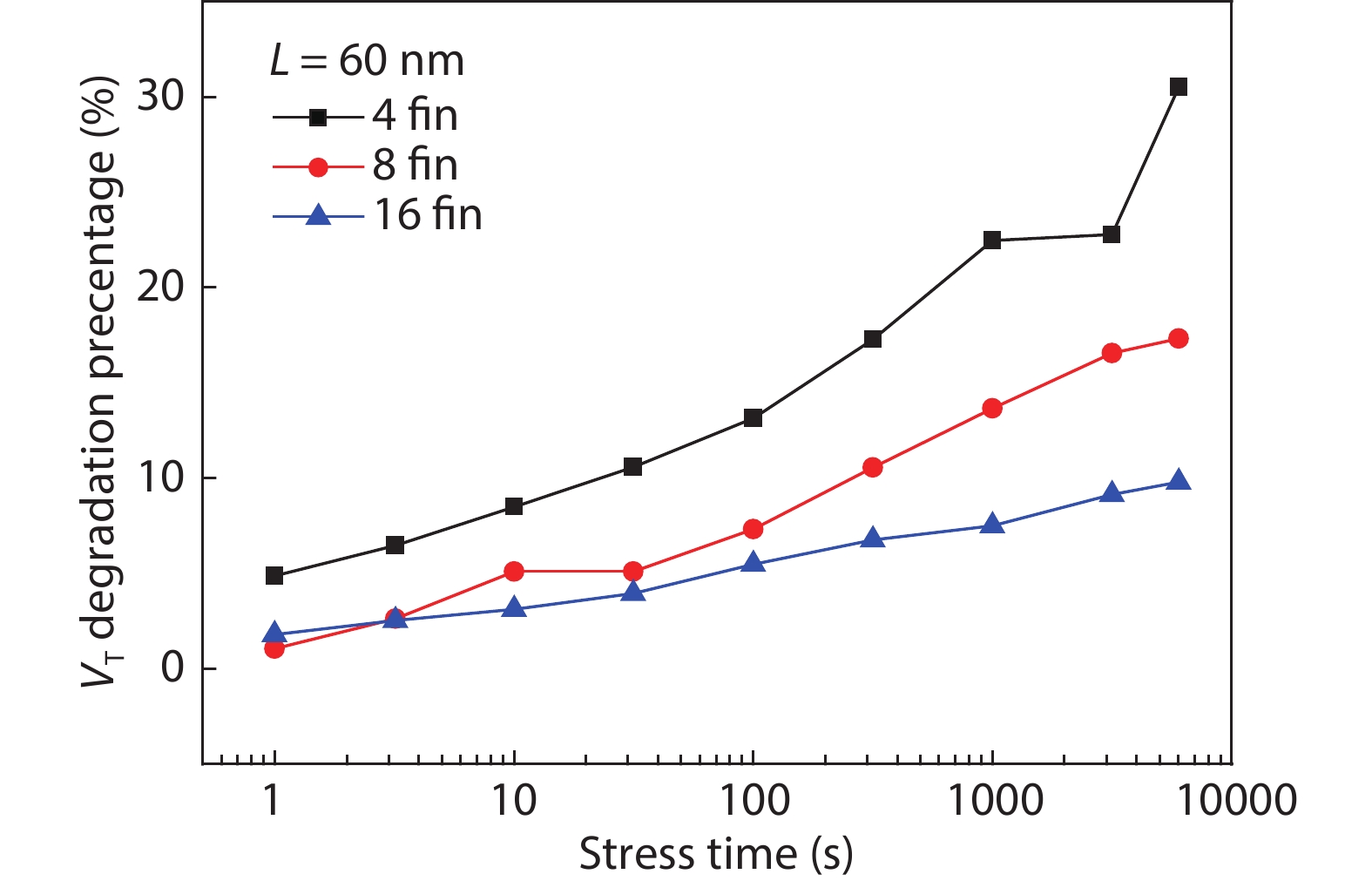
Fig. 2. (Color online) Degradation of V T for nFinFETs with different numbers of fins under HCI stress for samples with a 60 nm gate length.
Fig. 3. (Color online) Degradation of saturation current (I DSAT) for nFinFETs with different numbers of fins under HCI stress for samples with a 60 nm gate length.
Fig. 4. I DS–V GS curves as a function of the irradiation dose for nFinFET with 8 fins and a 60 nm gate length biased at the ON state.
Fig. 5. (Color online) Degradation of V T as a function of stress time for un-irradiated nFinFETs and for irradiated nFinFETs in different bias conditions during irradiation. (a) For 4 fin samples with a 60 nm gate length. (b) For 8 fin samples with a 60 nm gate length.
Fig. 6. (Color online) Degradation of I DSAT as a function of stress time for un-irradiated nFinFETs and for irradiated nFinFETs in different bias condition during irradiation. (a) For 4 fin samples with a 60 nm gate length. (b) For 8 fin samples with a 60 nm gate length.
Fig. 7. (Color online) A schematic diagram showing that total dose irradiation causes trap holes in STI[15 ].
|
Table 1. V T degradation percentage of un-irradiated devices, OFF-bias irradiated devices, TG-bias irradiated devices, and ON-bias irradiated devices in different groups after 6000 s hot carrier stress.
|
Table 2. I DSAT degradation percentage of un-irradiated devices, OFF-bias irradiated devices, TG-bias irradiated devices, and ON-bias irradiated devices in different groups after 6000 s hot carrier stress.
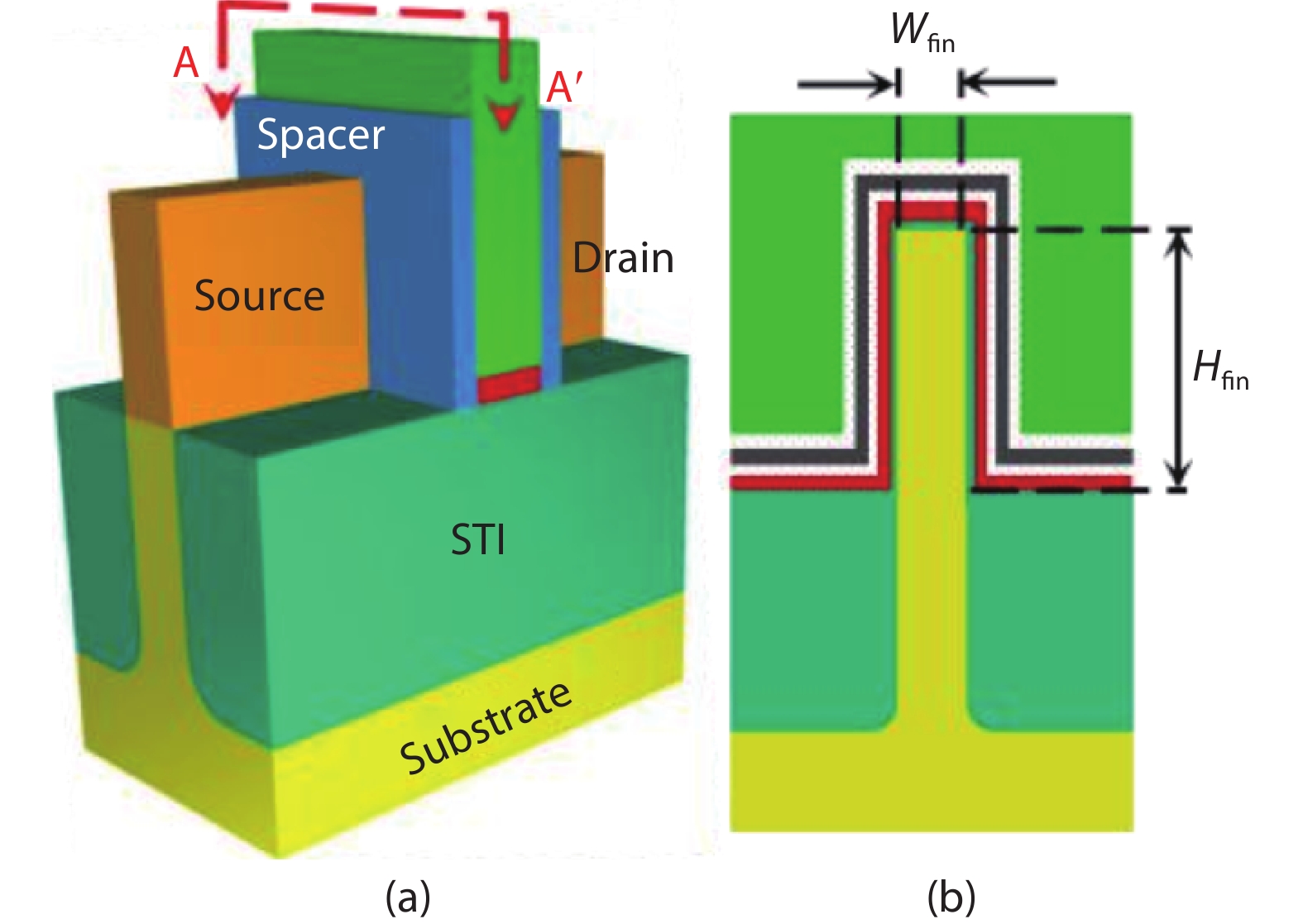
Set citation alerts for the article
Please enter your email address



