Wei Cheng, Sikun Li, Zinan Zhang, Xiangzhao Wang. Research on Mask Defect Inspection and Compensation Techniques in Extreme Ultraviolet Lithography[J]. Laser & Optoelectronics Progress, 2022, 59(9): 0922022
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 59, Issue 9, 0922022 (2022)
![Simplified model for defective EUV multilayer based on single surface approximation[10]](/richHtml/lop/2022/59/9/0922022/img_01.jpg)
Fig. 1. Simplified model for defective EUV multilayer based on single surface approximation[10]
![Simulation model based on equivalent film layer method. (a) Partition of defective multilayer; (b) thickness distribution of layers for defect-free and defective multilayer [5]](/richHtml/lop/2022/59/9/0922022/img_02.jpg)
Fig. 2. Simulation model based on equivalent film layer method. (a) Partition of defective multilayer; (b) thickness distribution of layers for defect-free and defective multilayer [5]
Fig. 3. Schematic diagram of the optical setup for the ABI[40]
Fig. 4. Flow chart of the defect profile parameter reconstruction[19]
Fig. 5. Schematic diagram of two initialization repair patterns. (a) Initialization pattern 1; (b) initialization pattern 2[4]
|
Table 1. Penetration depth of different wavelengths used in the EUV multilayer [37]
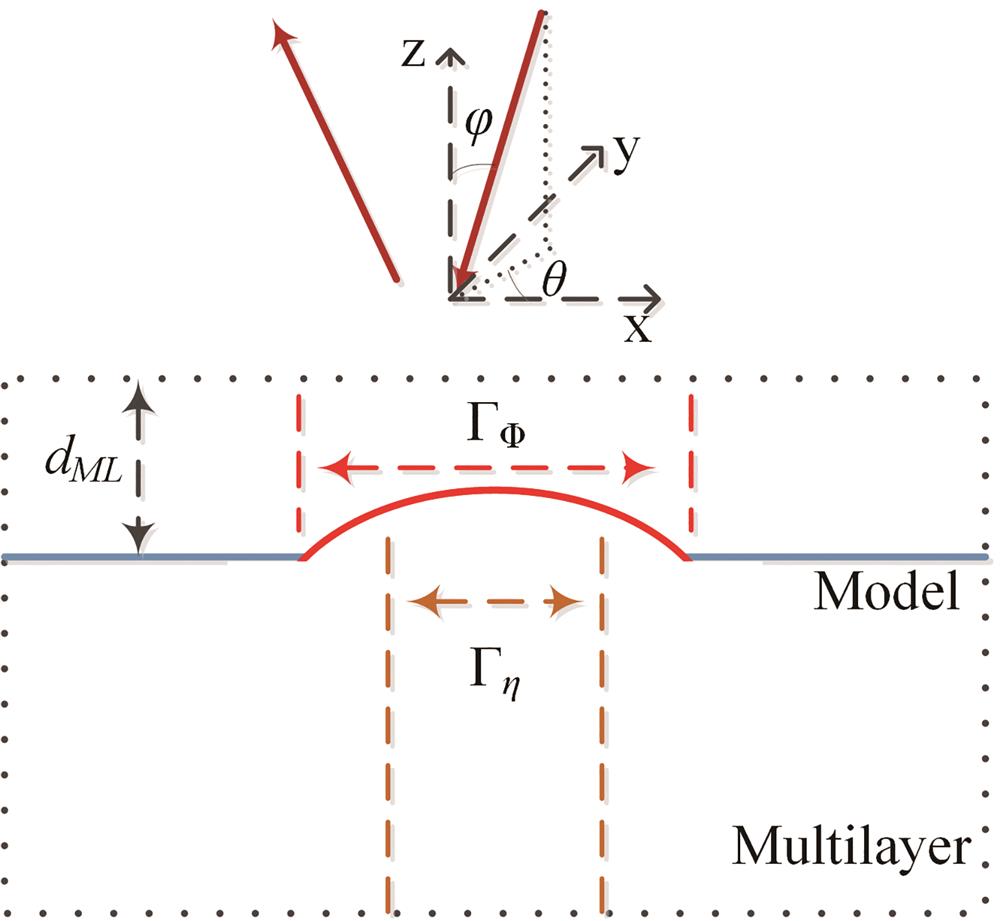
Set citation alerts for the article
Please enter your email address



