Zhijun Luo, Ziyu Liu, Shuhong Wang, Duan Wang, Zongsong Gan, Xinyao Du. Exploration to Next Generation of Lithography Technology: Concept, Technique, and Future of the 6th Generation of Super-Resolution Lithographic System[J]. Laser & Optoelectronics Progress, 2022, 59(9): 0922028
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 59, Issue 9, 0922028 (2022)
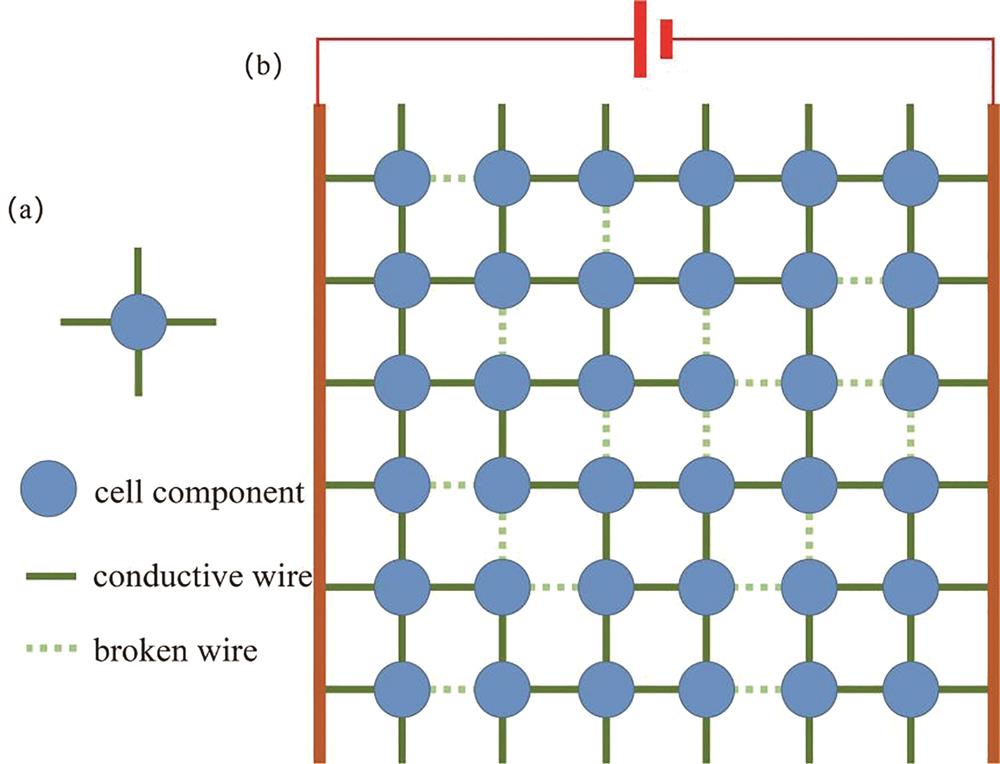
Fig. 1. Schematic diagram of 2D bond overpass when the average number of single components is 4. (a) Single components can be connected or not connected in four directions; (b) single components form a 2D conductive network that is connected or not connected in four directions with a certain probability

Fig. 2. Schematic diagram of the final effect of the Yin and Yang complementary mask and its dual-beam projection lithography
Fig. 3. Dual-beam super-resolution lithographic system introduces a second beam of laser to correct the first laser diffraction edge. (a) With the complementary mask shape, the introduced second beam of auxiliary laser will narrow the exposure distribution of the photoresist at the first laser diffraction edge; (b) under the action of the second beam of dual-beam super-resolution lithography, the dual-beam lithography between the two patterns will widen the spatial size of the exposure between the two patterns not exceeding the threshold when the single exposure is far apart
Fig. 4. Comparison of single-beam and double-beam projected lithography density. (a) Single-beam lithography can only perform 2 repeated exposures; (b) double-beam lithography can make repeated exposures more times, with higher density
Fig. 5. Schematic diagram of the energy direction and guidance mechanism. (a) Energy absorption direction of photoresist can be diverted by adding the energy direction channel or changing the energy flow speed of each channel; (b) using the method of stimulated radiation depletion, photoresist can be excited from the ground state to the excited state and relaxed to the low energy excited state, thus changing the direction of energy flow
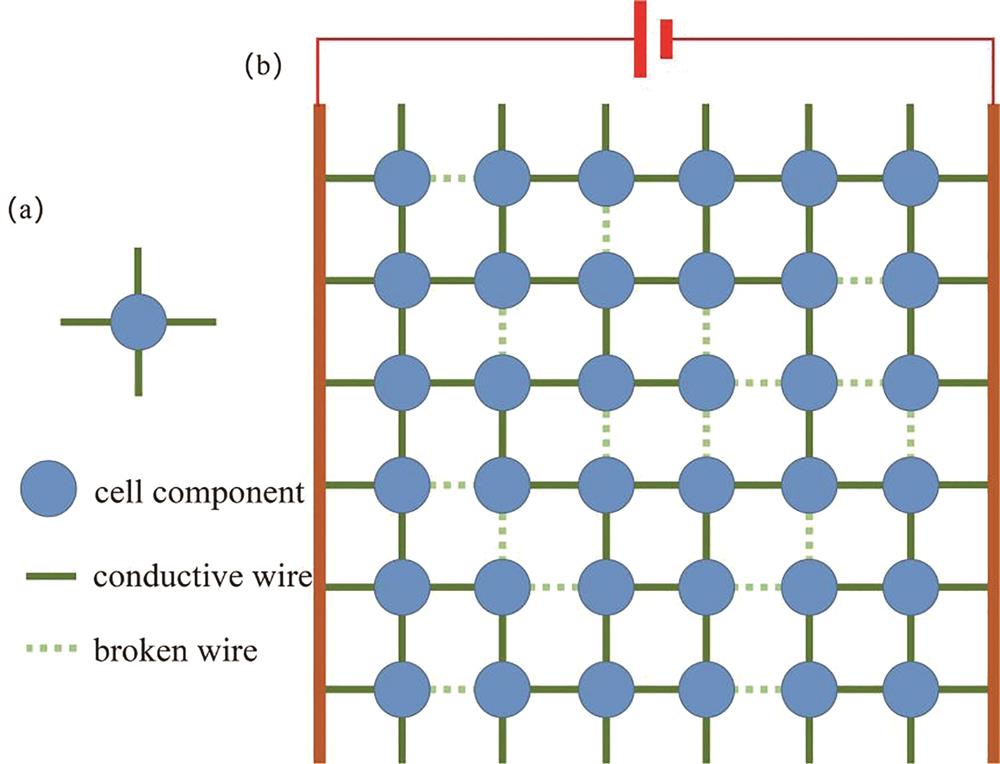
Set citation alerts for the article
Please enter your email address



