Quan Wang, Changxi Chen, Wei Li, Yanbin Qin, Lijuan Jiang, Chun Feng, Qian Wang, Hongling Xiao, Xiufang Chen, Fengqi Liu, Xiaoliang Wang, Xiangang Xu, Zhanguo Wang. Fabrication and characterization of AlGaN/GaN HEMTs with high power gain and efficiency at 8 GHz[J]. Journal of Semiconductors, 2021, 42(12): 122802
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 12, 122802 (2021)
Abstract
| (1) |
View in Article
| (2) |
View in Article
| (3) |
View in Article
| (4) |
View in Article
| (5) |
View in Article
| (6) |
View in Article
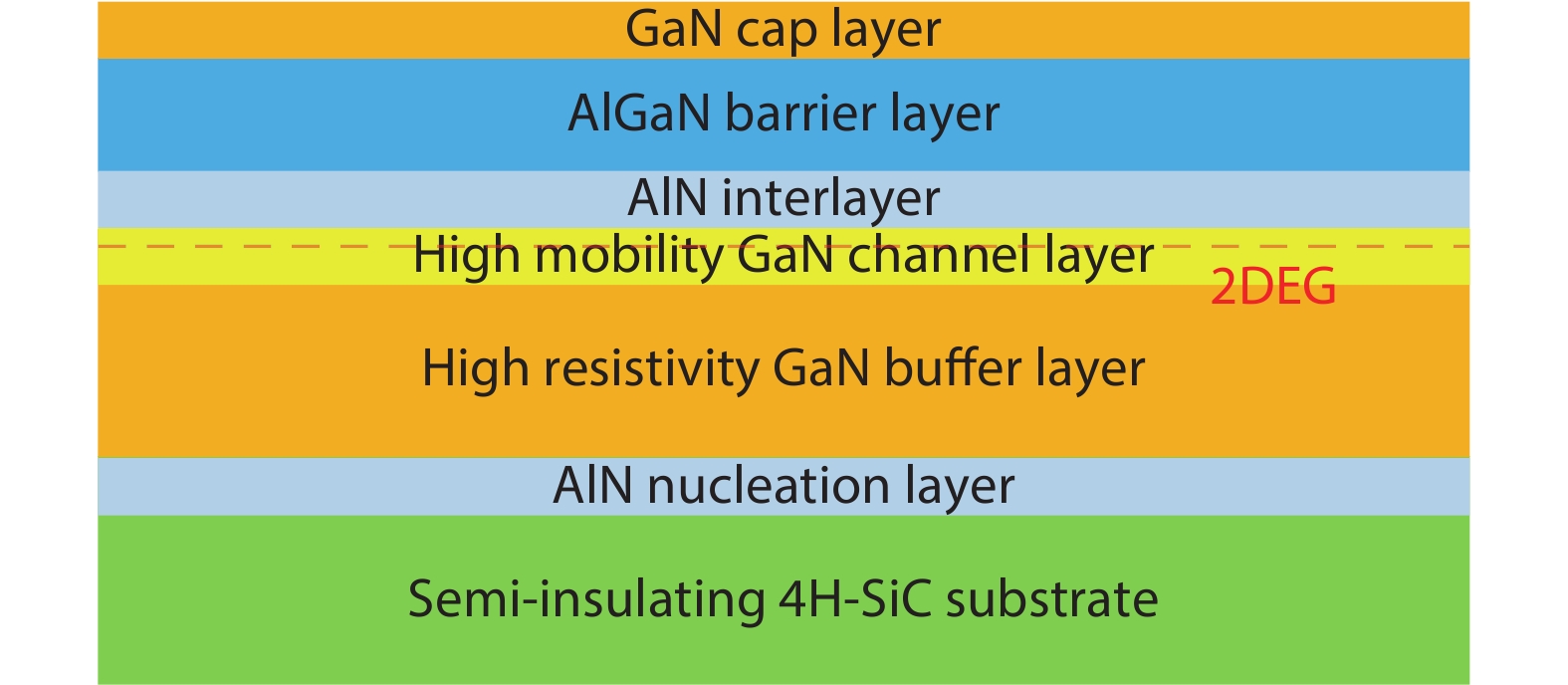
Set citation alerts for the article
Please enter your email address



