Side Song, Guozhu Liu, Hailiang Zhang, Lichao Chao, Jinghe Wei, Wei Zhao, Genshen Hong, Qi He. Reliability evaluation on sense-switch p-channel flash[J]. Journal of Semiconductors, 2021, 42(8): 084101
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 8, 084101 (2021)
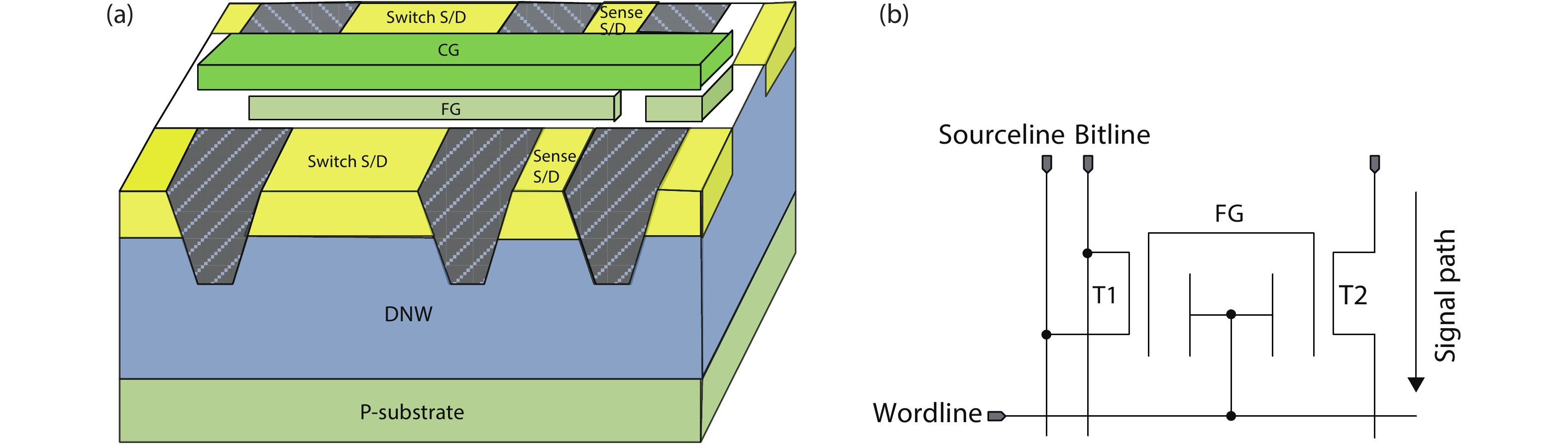
Fig. 1. (Color online) (a) The three-dimensional sense-switch p-channel flash diagram. (b) The basic working schematic.
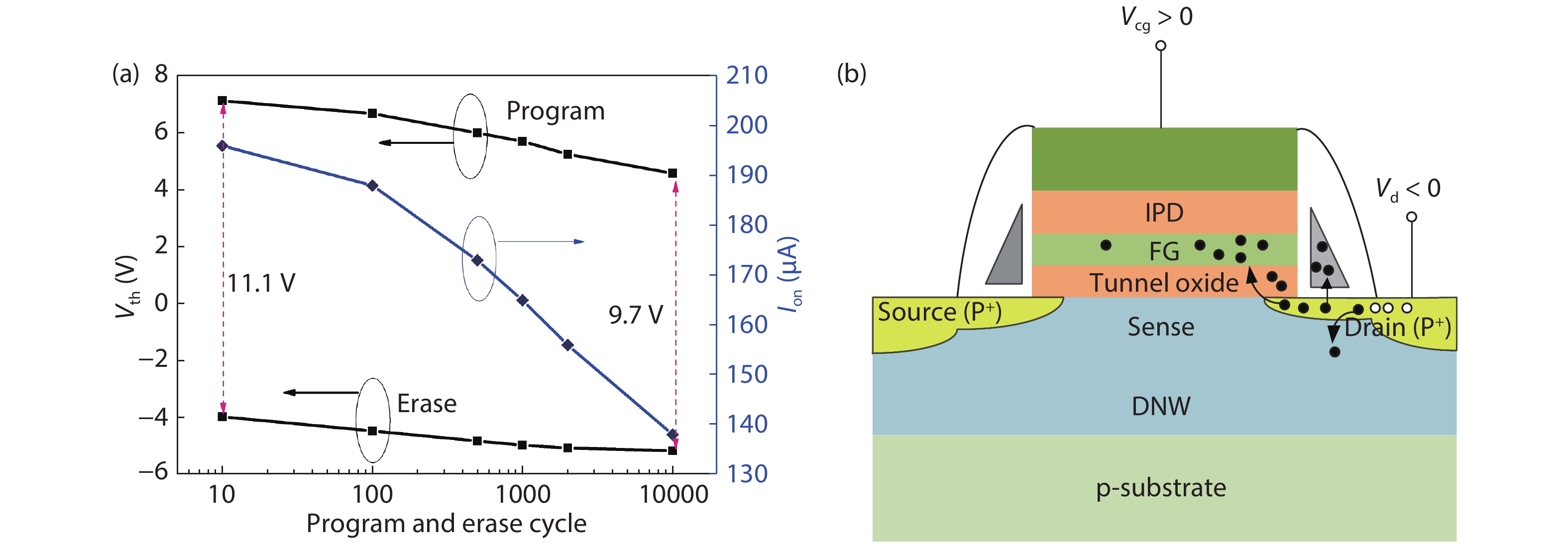
Fig. 2. (Color online) (a) The threshold voltage and drive current as a function of the program and erase cycles. (b) Electron trapping in the tunnel oxide or spacer at the drain side when programmed.
Fig. 3. (Color online) (a) Current–time curve during read stress at room temperature. (b) I–V characteristic before and after read stress. I–V characteristic before and after high temperature storage (c) without cycling and (d) with 500 program and erase cycles before DRB. (e) Degradation of drive current versus time in bake. (f) I–V characteristic of the erased state device under high temperature storage.
Fig. 4. (Color online) (a) The output characteristics of the programmed switch. (b) The programmed and erased state of the switch under different temperatures. (c) The threshold voltage and drive current with different temperature cycling.
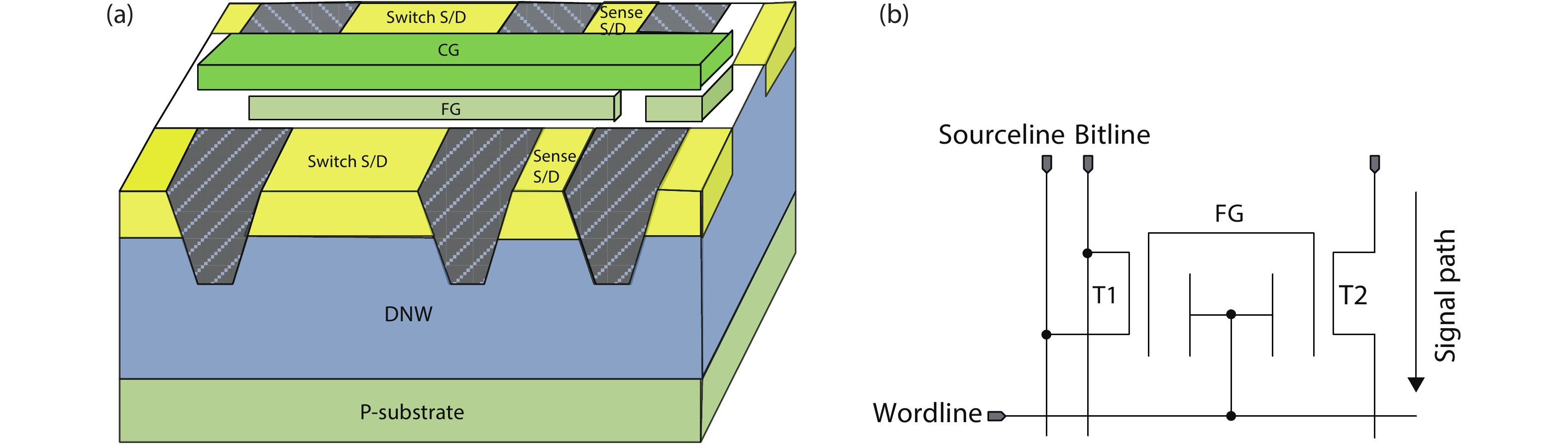
Set citation alerts for the article
Please enter your email address



