Xiongliang Wei, Syed Ahmed Al Muyeed, Haotian Xue, Elia Palmese, Renbo Song, Nelson Tansu, Jonathan J. Wierer, "Near-infrared electroluminescence of AlGaN capped InGaN quantum dots formed by controlled growth on photoelectrochemical etched quantum dot templates," Photonics Res. 10, 33 (2022)
Search by keywords or author
- Photonics Research
- Vol. 10, Issue 1, 33 (2022)
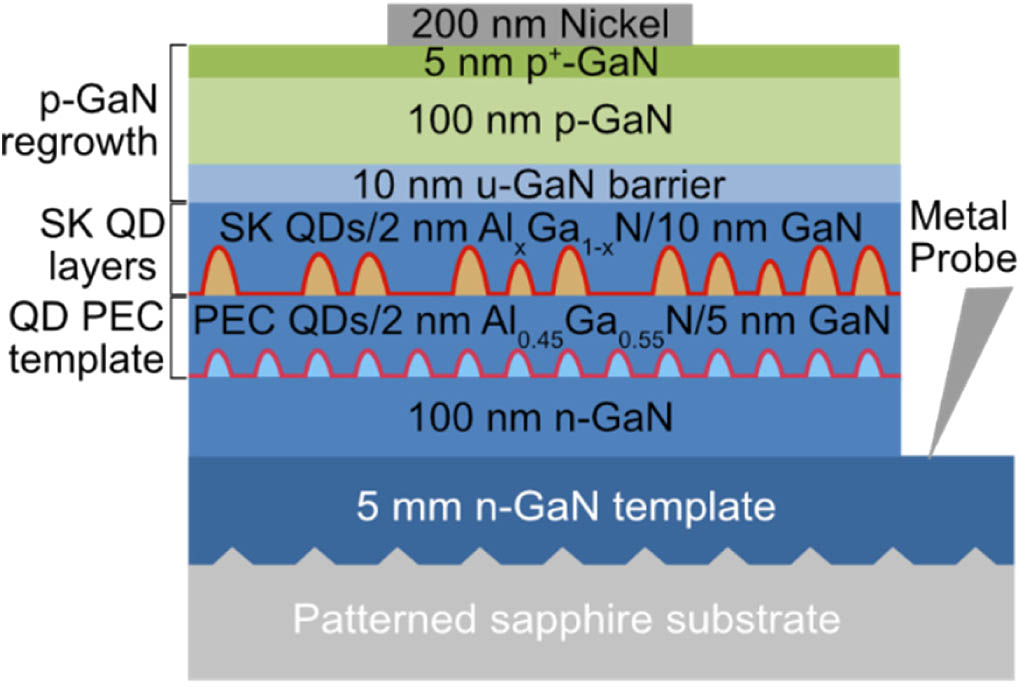
Fig. 1. Schematic cross section of the entire LED structure consisting of Stranski–Krastanov (SK) quantum dots (QDs) grown on photoelectrochemical (PEC) etched QD templates. Both QD layers are capped with AlGaN layers to protect the QDs. The p-GaN contact is formed by Ni evaporation through a shadow mask, and an electrical “flash” process creates the n-contact.
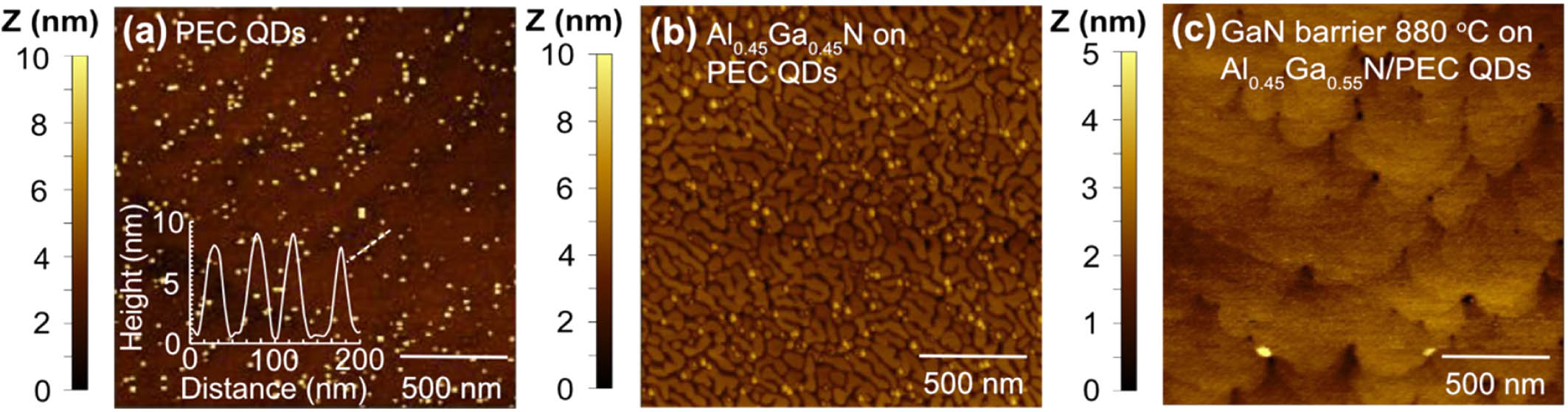
Fig. 2. Atomic force microscope (AFM) images of a PEC QD template at different synthesized steps: (a) PEC QDs after etching, (b) PEC QDs with Al 0.45 Ga 0.55 N Al 0.45 Ga 0.55 N Al 0.45 Ga 0.55 N
Fig. 3. AFM images of SK QDs grown on a PEC QD template and with Al 0.1 Ga 0.9 N Al 0.1 Ga 0.9 N Al 0.1 Ga 0.9 N
Fig. 4. AFM images of SK QDs with an Al 0.9 Ga 0.1 N Al 0.9 Ga 0.1 N
Fig. 5. STEM images of SK QDs capped with an Al 0.9 Ga 0.1 N Al 0.45 Ga 0.55 N Al 0.9 Ga 0.1 N
Fig. 6. Electroluminescence measurement of the QD LED. (a) Voltage, external quantum efficiency (EQE), and light power versus current of the QD LED. The threshold voltage is < 2 V ∼ 25 Ω
Fig. 7. (a) Simulated peak wavelength and wave function overlap squared of the ground state transitions versus carrier screening for a single In 0.25 Ga 0.75 N Al 0.9 Ga 0.1 N
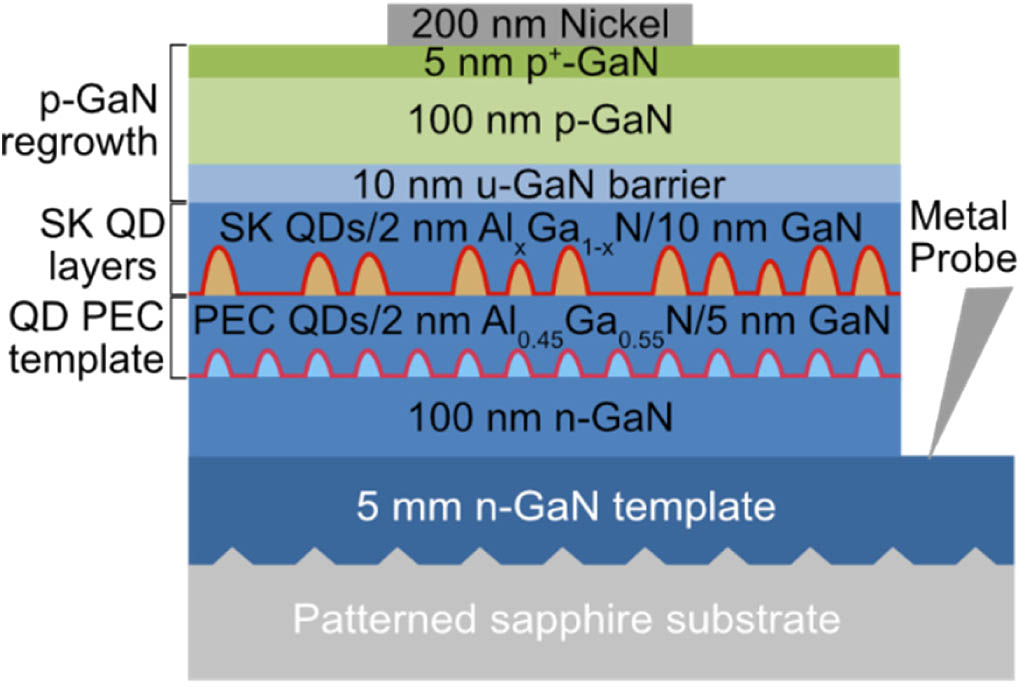
Set citation alerts for the article
Please enter your email address



