Zehong Wan, Enkang Cui, Shengtao Yu, Yu Lei, Chengqun Gui, Shengjun Zhou. Effects of Reactive Ion Etching Parameters on Etching Rate and Surface Roughness of 4H-SiC[J]. Laser & Optoelectronics Progress, 2021, 58(19): 1922002
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 58, Issue 19, 1922002 (2021)
Abstract
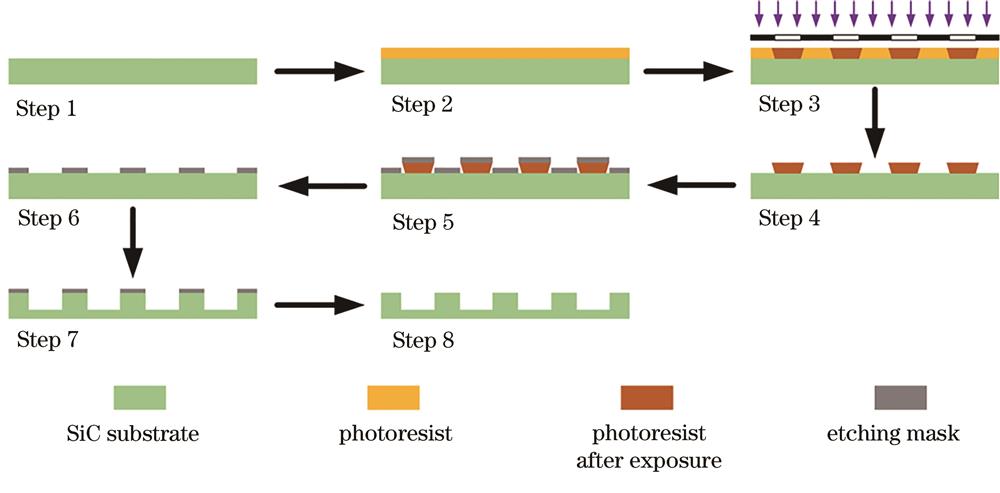
Set citation alerts for the article
Please enter your email address



