Yongkang Xu, Sannian Song, Wencheng Fang, Chengxing Li, Zhitang Song. The etching process and mechanism analysis of Ta-Sb2Te3 film based on inductively coupled plasma[J]. Journal of Semiconductors, 2020, 41(12): 122103
Search by keywords or author
- Journal of Semiconductors
- Vol. 41, Issue 12, 122103 (2020)
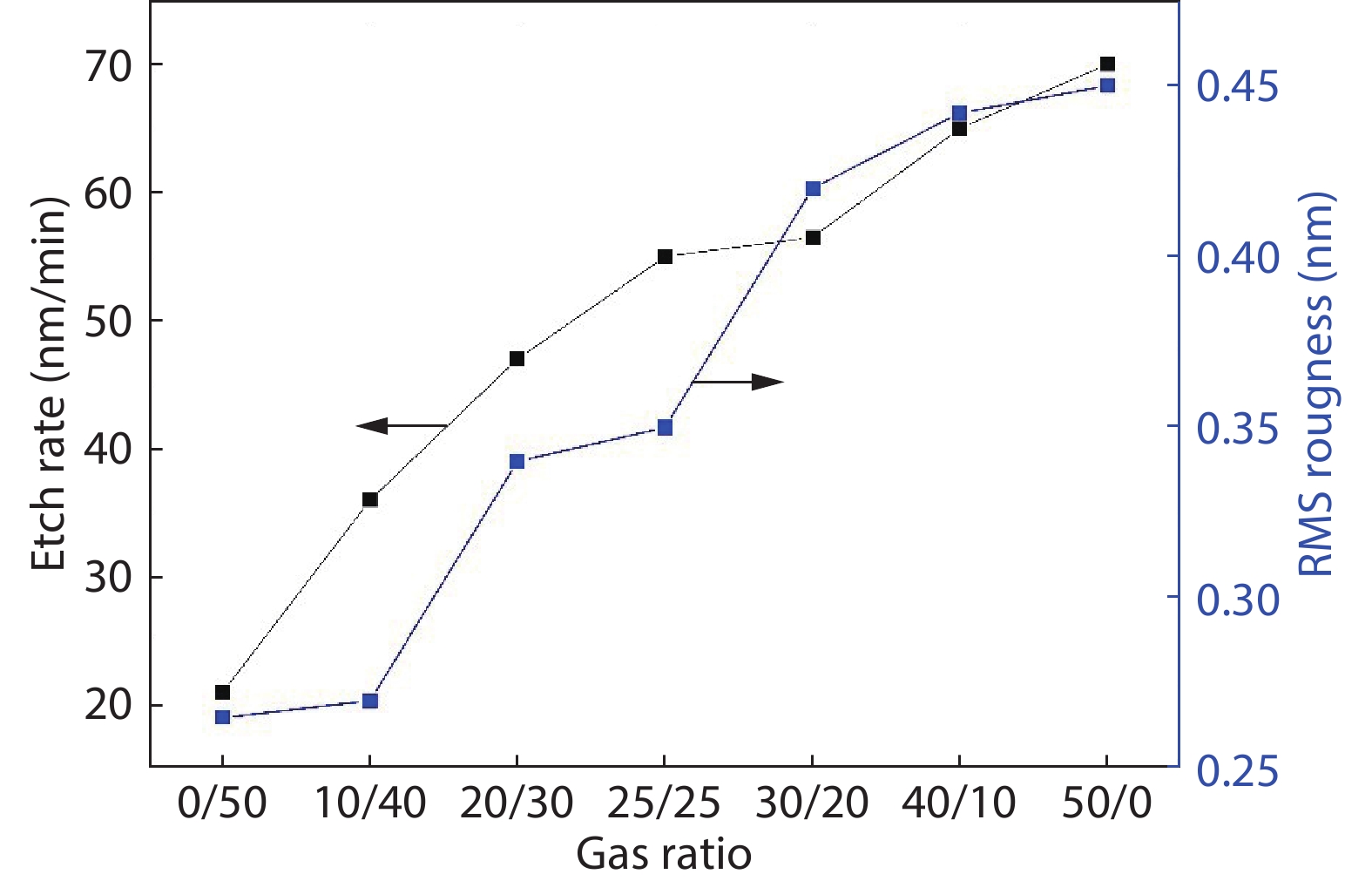
Fig. 1. Effect of gas composition on etching rate and surface roughness.

Fig. 2. (Color online) AFM images of Ta-Sb2Te3 surface (a) CF4/Ar = 10/40, RMS = 0.27, (b) CF4/Ar = 20/30, RMS = 0.34, (c) CF4/Ar = 25/25, RMS = 0.35, (d) CF4/Ar = 30/20 and RMS = 0.42.
Fig. 3. Effect of chamber pressure on etching rate and surface roughness.
Fig. 4. SEM of cross sections of Ta-Sb2Te3 after ICP etching with pressure of (a)1.0 Pa, (b) 1.5 Pa, (c) 2.0 Pa, (d) 2.25 Pa, (e) 2.5 Pa, (f) 2.75 Pa with CF4 flow of 25 sccm, Ar flow of 25 sccm, ICP power of 600 W.
Fig. 5. Effects of ICP source power on RMS roughness and etching rate of Ta-Sb2Te3.
Fig. 6. (Color online) XPS spectrum of each component of the Ta-Sb2Te3 film after ICP etching.
Fig. 7. (Color online) XRD curves before and after ICP etching.
|
Table 1. The boiling point of fluoride.
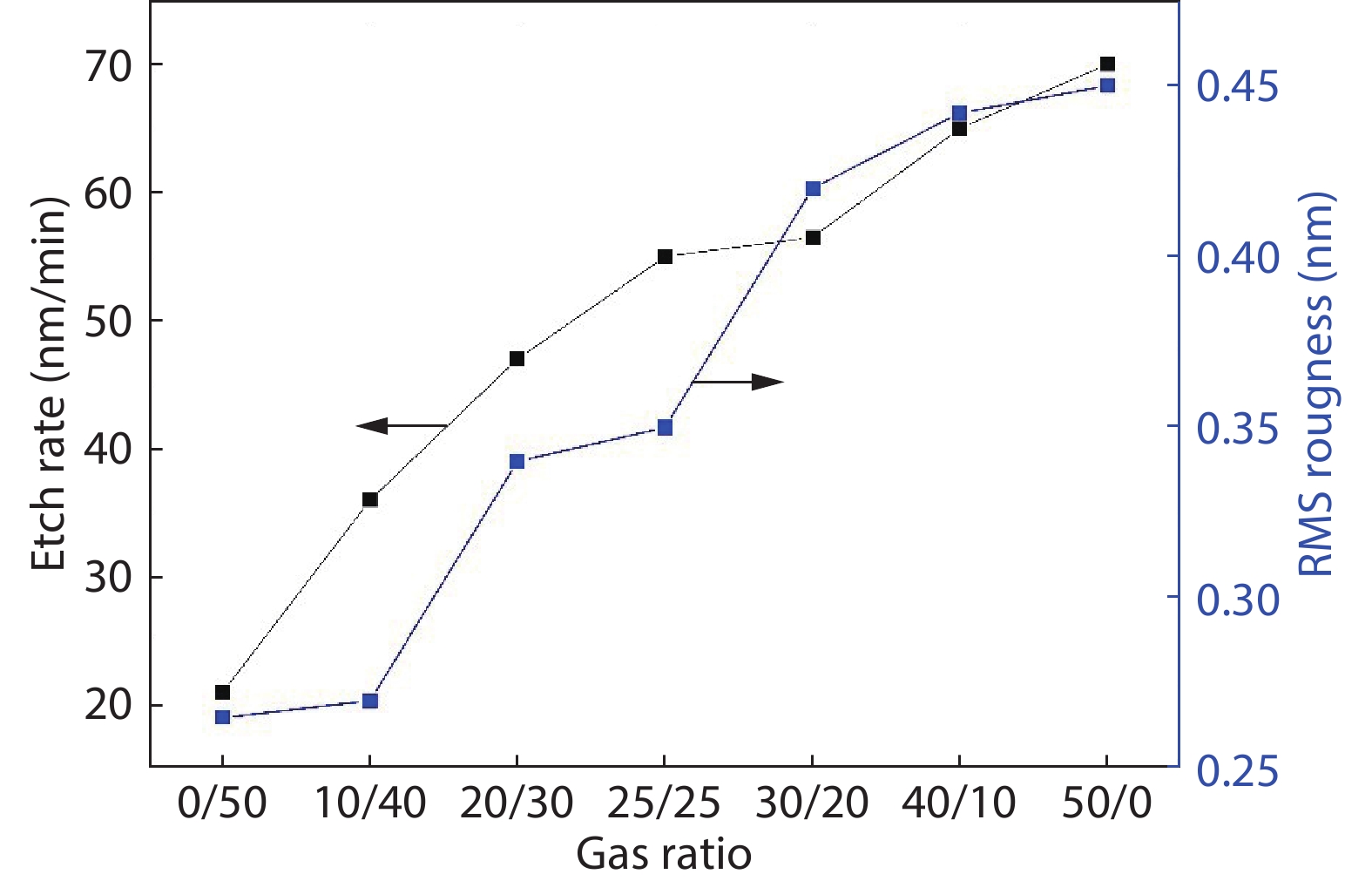
Set citation alerts for the article
Please enter your email address



