Ye Tao, Xuhong Li, Zhongqiang Wang, Gang Li, Haiyang Xu, Xiaoning Zhao, Ya Lin, Yichun Liu. Neutron irradiation-induced effects on the reliability performance of electrochemical metallization memory devices[J]. Journal of Semiconductors, 2021, 42(1): 014103
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 1, 014103 (2021)

Fig. 1. (Color online) (a) Schematic diagrams of Ag/AIST/a-C/Pt ECM device. (b) Photograph of packaged Ag/AIST/a-C/Pt ECM devices. (c) Three devices were fastened in different positions to be exposed to different neutron fluences.
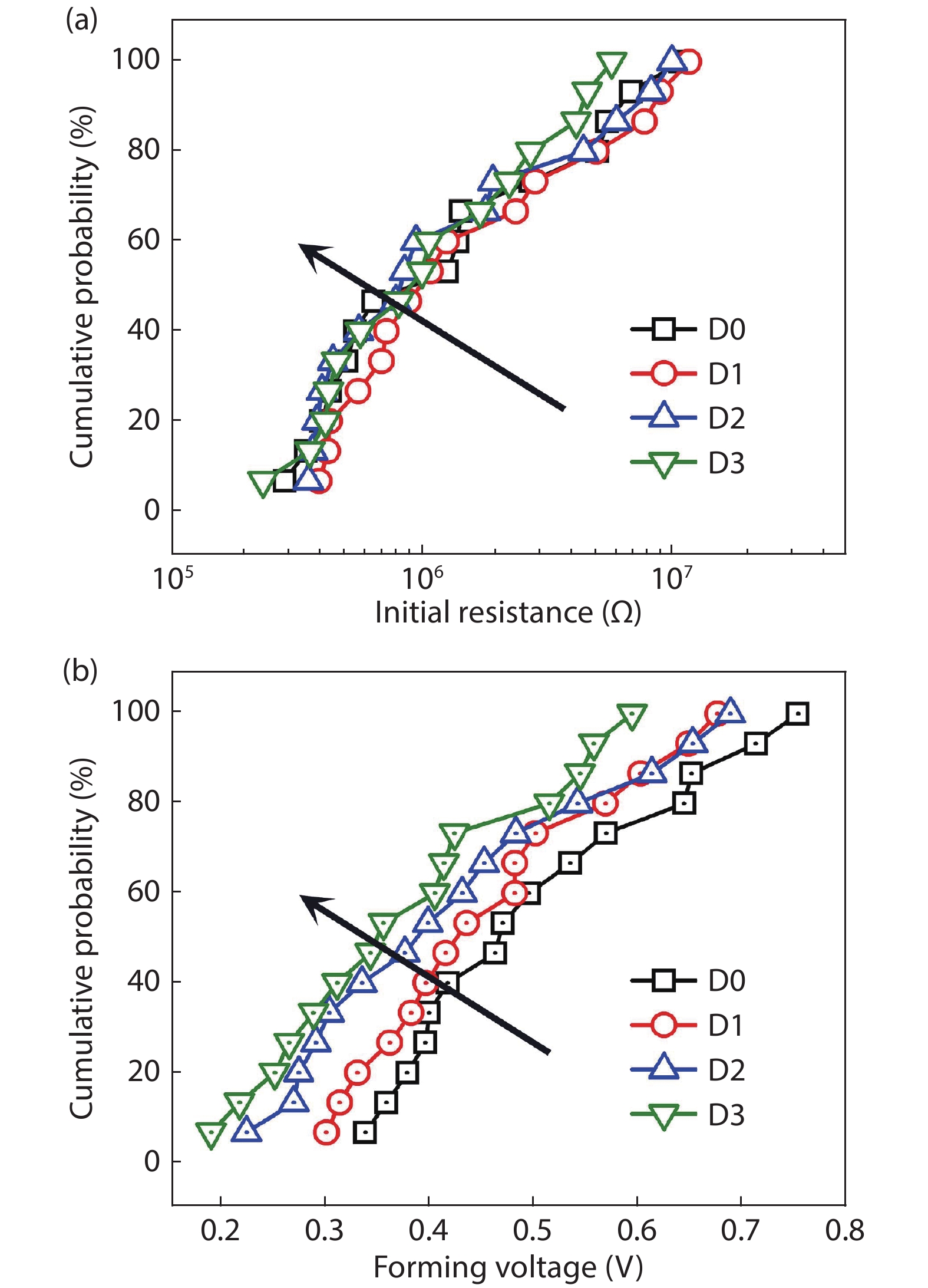
Fig. 2. (Color online) (a) Initial resistance and (b) forming voltage of the four types of packaged ECM devices, D0, D1, D2, and D3, respectively.
Fig. 3. Typical I–V characteristics of D0, D1, D2 and D3.
Fig. 4. (Color online) (a) HRS and LRS variations and (b) SET and RESET voltage variations of the ECM devices D0, D1, D2, and D3.
Fig. 5. (Color online) (a) Device-to-device variation of LRS/HRS resistances and (b) SET and RESET voltages. Data was obtained for 15 randomly selected cells.
Fig. 6. (Color online) Schematic diagrams of (a) the pristine ECM device, (b) the device after neutron irradiation, (c) the SET process, and (d) the RESET process.
Fig. 7. (Color online) Retention performance of the HRS and LRS of the four ECM device packages, D0, D1, D2, and D3.

Set citation alerts for the article
Please enter your email address



