A. Hezabra, N. A. Abdeslam, N. Sengouga, M. C. E. Yagoub. 2D study of AlGaN/AlN/GaN/AlGaN HEMTs’ response to traps[J]. Journal of Semiconductors, 2019, 40(2): 022802
Search by keywords or author
- Journal of Semiconductors
- Vol. 40, Issue 2, 022802 (2019)
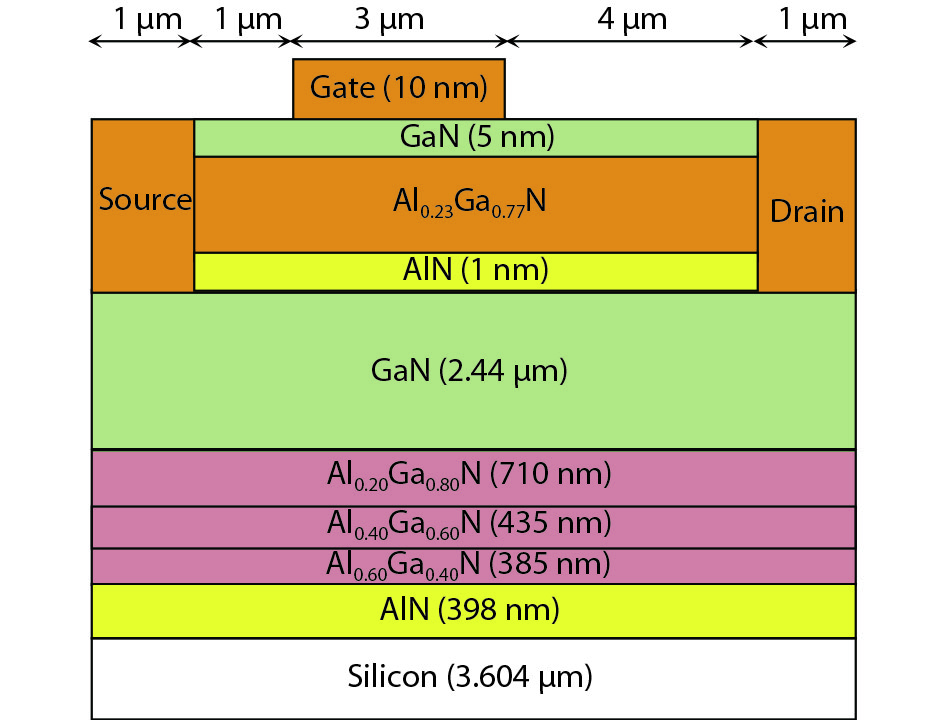
Fig. 1. (Color online) Cross-section of the AlGaN/AlN/GaN/AlGaN HEMT structure simulated in this work.
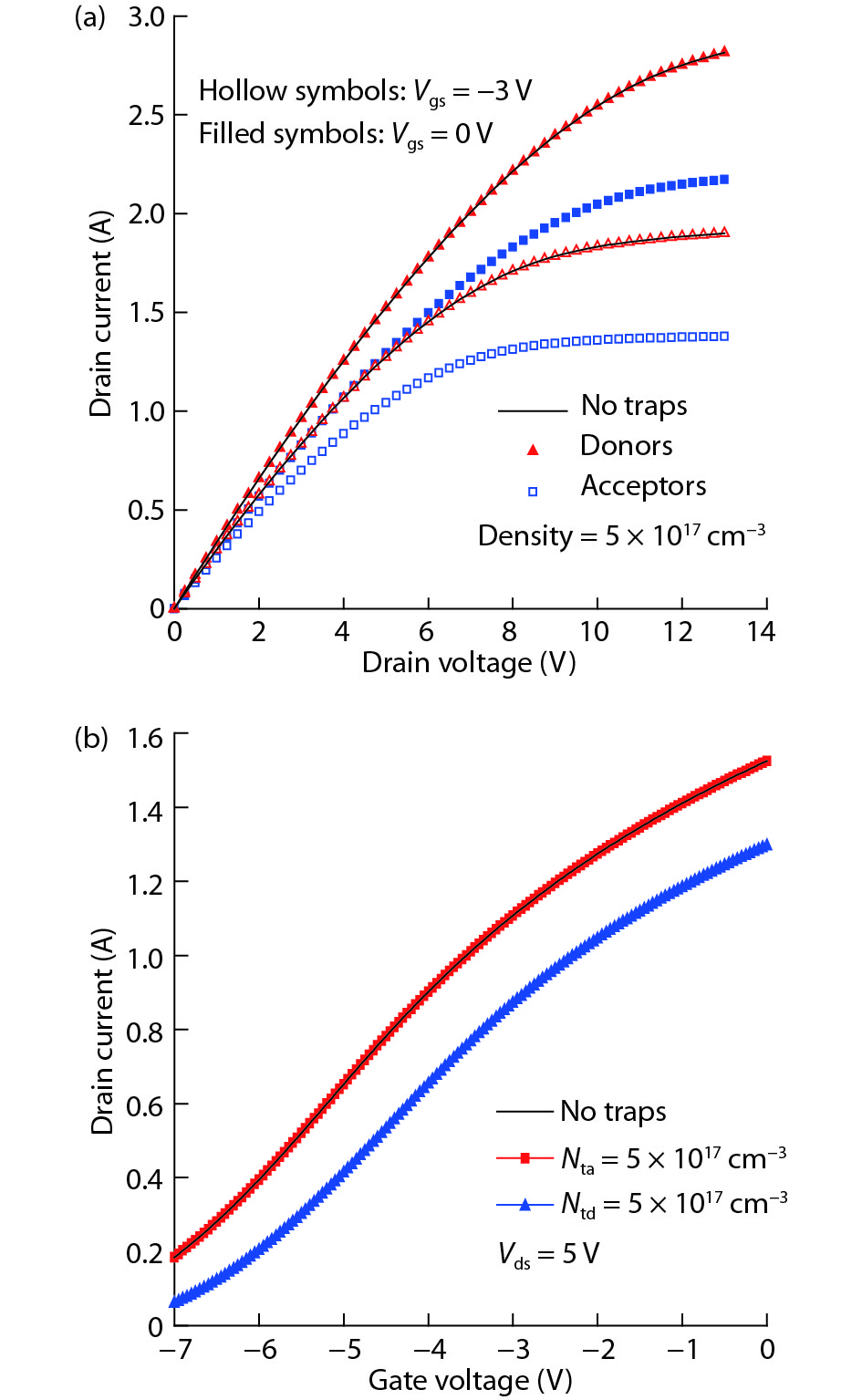
Fig. 2. (Color online) Simulated (a) DC characteristics for different gate-source voltages and (b) transfer characteristics in the presence of acceptor and donor traps in the GaN channel compared to the case with no traps. Trap energy level is 0.3 eV below E c for the acceptor and 0.3 eV above E v for the donor.
Fig. 3. (Color online) Influence of acceptor traps located below the conductance band on the (a) output characteristics, (b) transfer characteristics, and (c) transconductance of the AlGaN/AlN/GaN/AlGaN HEMT device at V ds = 5 V. Acceptor traps in the GaN channel have a density of 5 × 1017 cm−3.
Fig. 4. (Color online) Influence of acceptor trap concentration on the (a) output and (b) transfer characteristics and (c) the transconductance of the device. Acceptor traps in the channel are located at E ta = 0.3 eV. The drain voltage is V ds = 5 V.
Fig. 5. (Color online) Passivated and unpassivated structures under the same bias conditions. (a) The output and (b) transfer characteristics and (c) the transconductance of the device. Acceptor traps in the channel have a density of N ta = 5 × 1017 cm−3 and are located at E ta = 0.3 eV below the conduction band.
Fig. 6. (Color online) Influence of the temperature variations on (a) DC characteristics, (b) transfer characteristics, and (c) the transconductance of the device in the presence of acceptor traps (N ta = 5 × 1017 cm−3, E ta = 0.3 eV).
Fig. 7. Drain current recovery curve after bias stressing with a pulse width of 1 ms on the gate (V gs = 0, −5 V and V ds = 25 V) in the presence of acceptor-like traps (N ta = 5 × 1017 cm−3, E ta = 0.3 eV).
Fig. 8. Drain current recovery curve after bias stressing on the gate (V gs = 0, −5 V and V ds = 10 V) in the presence of acceptor-like traps (N ta = 5 × 1017 cm−3, E ta = 0.3 eV).
|
Table 1. Summary of the material parameters used in the simulations.
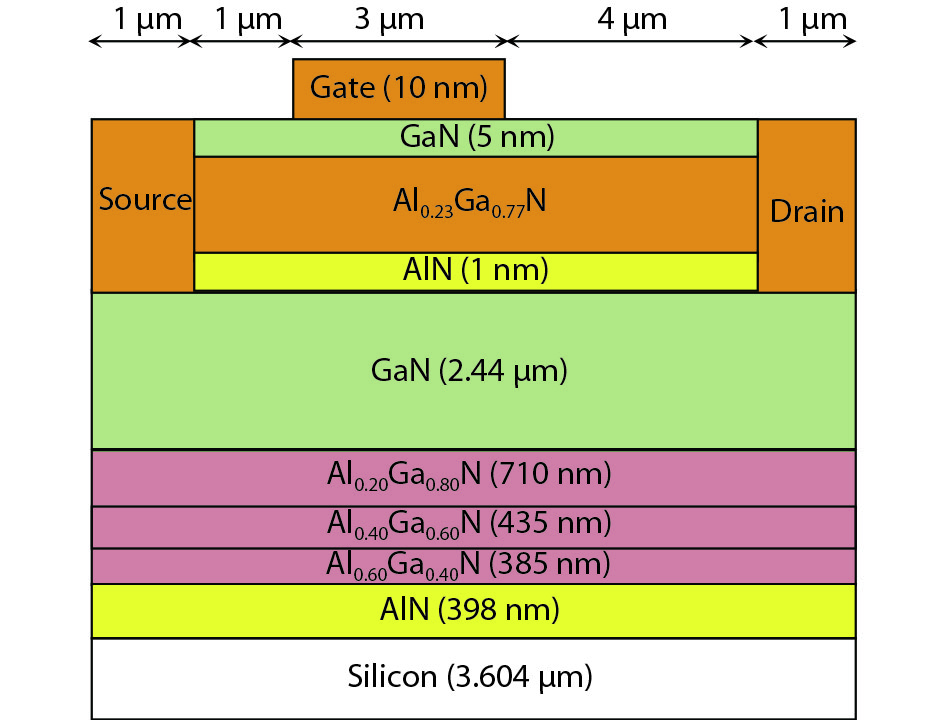
Set citation alerts for the article
Please enter your email address



