Changxi Chen, Quan Wang, Wei Li, Qian Wang, Chun Feng, Lijuan Jiang, Hongling Xiao, Xiaoliang Wang. Effect of the post-gate annealing on the gate reliability of AlGaN/GaN HEMTs[J]. Journal of Semiconductors, 2021, 42(9): 092802
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 9, 092802 (2021)
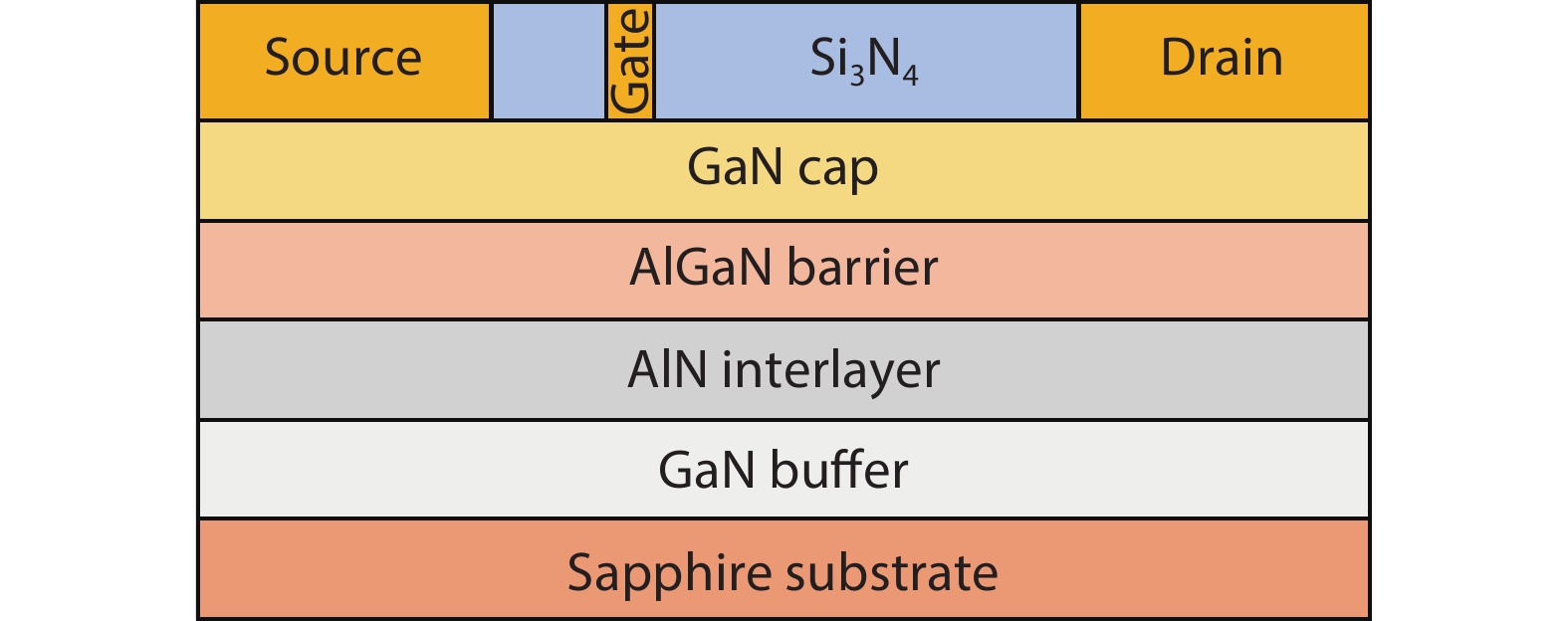
Fig. 1. (Color online) The cross-section schematic of the AlGaN/GaN HEMT.
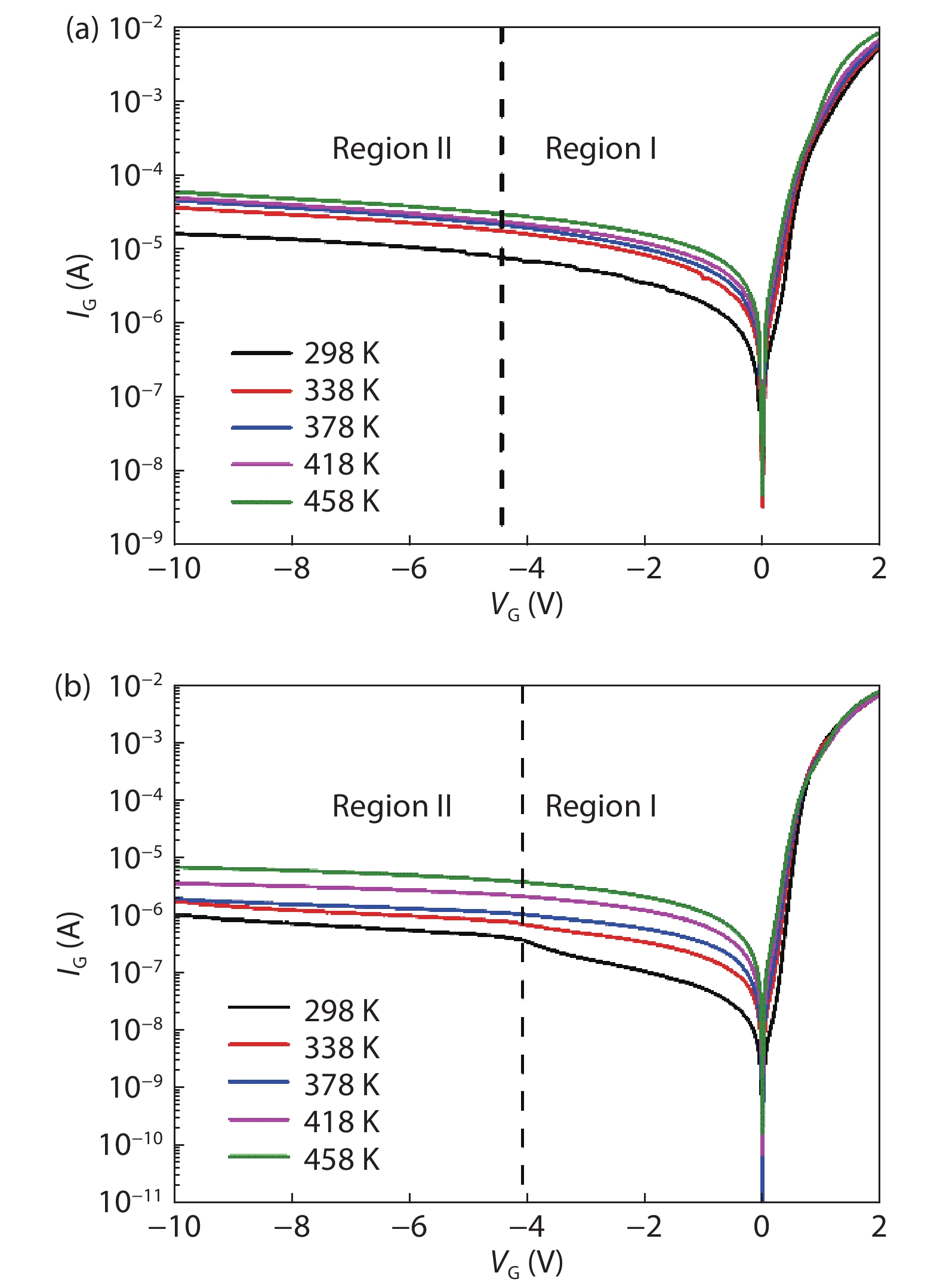
Fig. 2. (Color online) Reverse I–V characteristics measured from 298 to 458 K in a step of 40 K of (a) unannealed HEMT, (b) annealed HEMT.
Fig. 3. (Color online) (a) The gate capacitance versus V G characteristics of both HEMTs. (b) The electric fields across AlGaN as the function of V G for both HEMTs.
Fig. 4. (Color online) The ln (J /E ) versus E 0.5 and the linear fit for the slope and intercepts of (a) unannealed HEMT, (b) annealed HEMT. Inset: the B (T ) versus
Fig. 5. (Color online) Gate leakage measured during the reverse gate-bias step stress of (a) unannealed HEMT, (b) annealed HEMT. Inset: absolute value of reverse gate-bias step stress versus times (V step = –5 V, t step = 60 s).
Fig. 6. (Color online) Gate leakage current before and after reverse bias step stress of (a) unannealed HEMT, (b) annealed HEMT, (c) maximum output currents, and (d) transfer characteristics before and after reverse bias step stress of the unannealed HEMT.
Fig. 7. (Color online) Schematic of the gate leakage at reverse gate bias before the stress of (a) unannealed HEMT, (b) annealed HEMT.
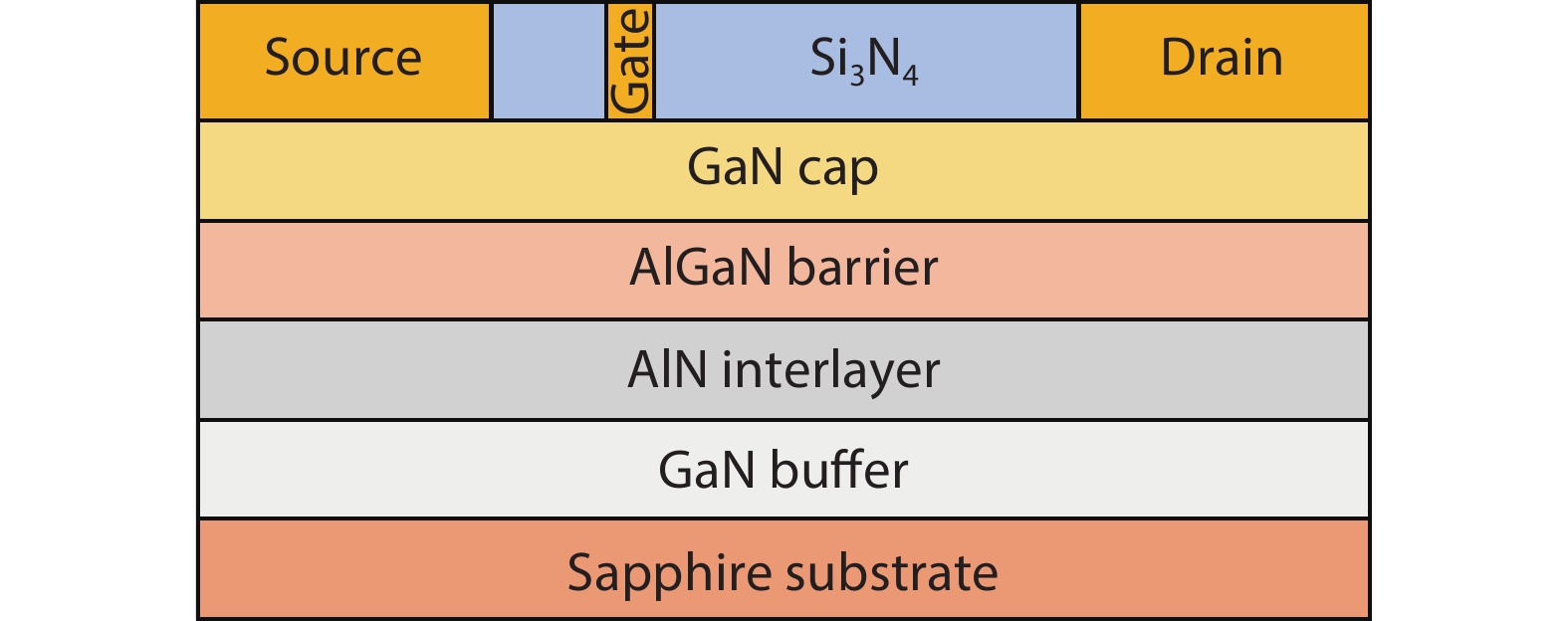
Set citation alerts for the article
Please enter your email address



