Changxi Chen, Quan Wang, Wei Li, Qian Wang, Chun Feng, Lijuan Jiang, Hongling Xiao, Xiaoliang Wang. Effect of the post-gate annealing on the gate reliability of AlGaN/GaN HEMTs[J]. Journal of Semiconductors, 2021, 42(9): 092802
Search by keywords or author
- Journal of Semiconductors
- Vol. 42, Issue 9, 092802 (2021)
Abstract
| (1) |
View in Article
| (2) |
View in Article
| (3) |
View in Article
| (4) |
View in Article
| (5) |
View in Article
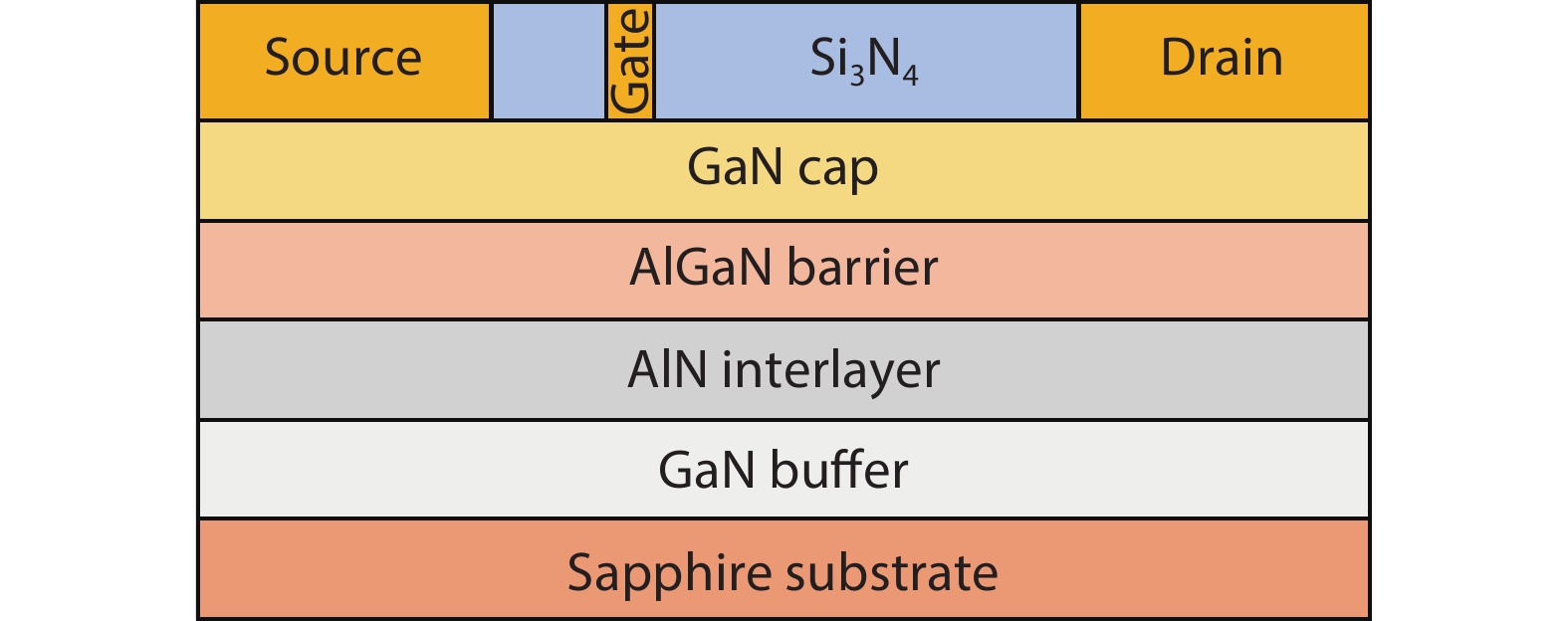
Set citation alerts for the article
Please enter your email address



