Jingyuan Fu, Rui Su, Xiaodong Ruan, Xin Fu. Research Status and Progress of Contamination Control in Immersion Liquid System of Immersion Lithography Machine[J]. Laser & Optoelectronics Progress, 2022, 59(9): 0922014
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 59, Issue 9, 0922014 (2022)
![Comparison of dry lithography and immersion lithography[8]](/richHtml/lop/2022/59/9/0922014/img_01.jpg)
Fig. 1. Comparison of dry lithography and immersion lithography[8]
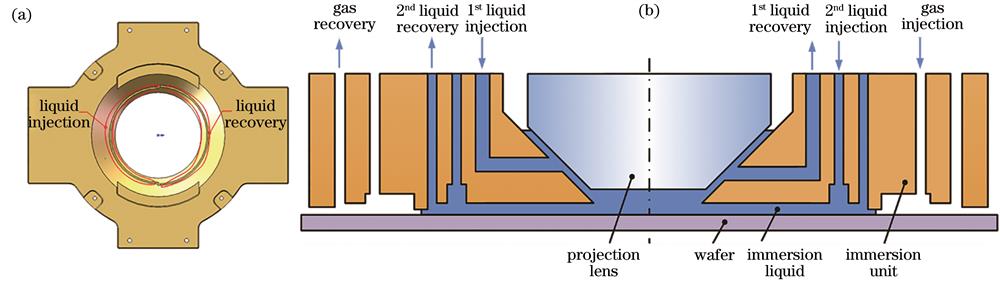
Fig. 2. Schematic diagrams of key components of lithography immersion system. (a) Immersion nozzle; (b) immersion unit
Fig. 3. Schematic diagram of immersion lithography scanning in the opposed flow configuration[19]
Fig. 4. SEM images of wafer surface under different processing conditions. (a) Wetting before exposure (size is 5 μm); (b) wetting after exposure (size is 0.8 μm); (c) wetting after exposure (size is 1.5 μm); (d) wetting after exposure (size is 2.5 μm)[38]
Fig. 5. Aggregation mechanism of air impurities[42]
Fig. 6. Transfer mechanism of particles on the topcoat to the resist after topcoat removal[21]
Fig. 7. Carboxylation of photoresist resin due to exposure[56]
Fig. 8. Estimated origins and mechanism of resist immersion defects[59]
Fig. 9. Bubble chart of analytical resolution vs detection limit[62]
Fig. 10. Basic structure of the AS7 cleaning system[76]
Fig. 11. Normal immersed lithographic exposure routing and 2 defect-reducing special routings[89]
Fig. 12. Preparation process of polarity-changed polymeric resist materials[92]
Fig. 13. Hydrophobic modification of objective lens coated surface[48]
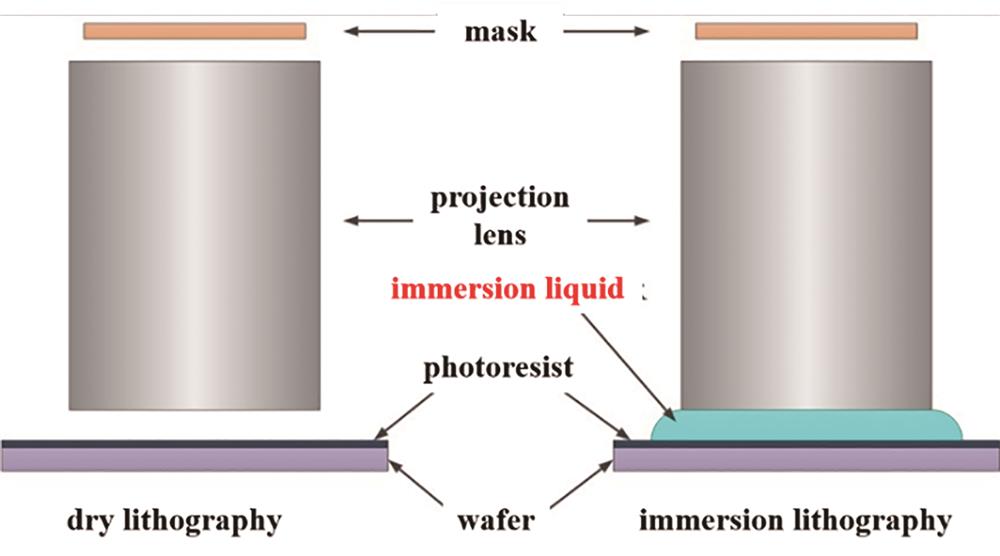
Set citation alerts for the article
Please enter your email address



