[22] D K Schroder. Oxide and interface trapped charges, oxide thickness. John Wiley & Sons, Inc., 319(2005).
[23] S M Sze, K K Ng. Physics of semiconductor devices. John Wiley & Sons, Inc.(2006).
[22] D K Schroder. Oxide and interface trapped charges, oxide thickness. John Wiley & Sons, Inc., 319(2005).
[23] S M Sze, K K Ng. Physics of semiconductor devices. John Wiley & Sons, Inc.(2006).
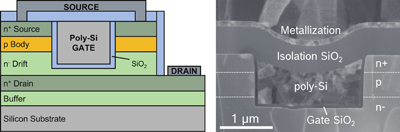
Set citation alerts for the article
Please enter your email address