Bo Wang, Liheng Wang, Weixin Liu, Zebin Kong, Yudong Li, Zhen Li, Kunshu Wang, Weiming Zhu, Ming Xuan. Single-Event Upset and Damage Mechanism in 8T-Global Shutter CMOS Image Sensors[J]. Acta Optica Sinica, 2019, 39(5): 0504001
Search by keywords or author
- Acta Optica Sinica
- Vol. 39, Issue 5, 0504001 (2019)
Abstract
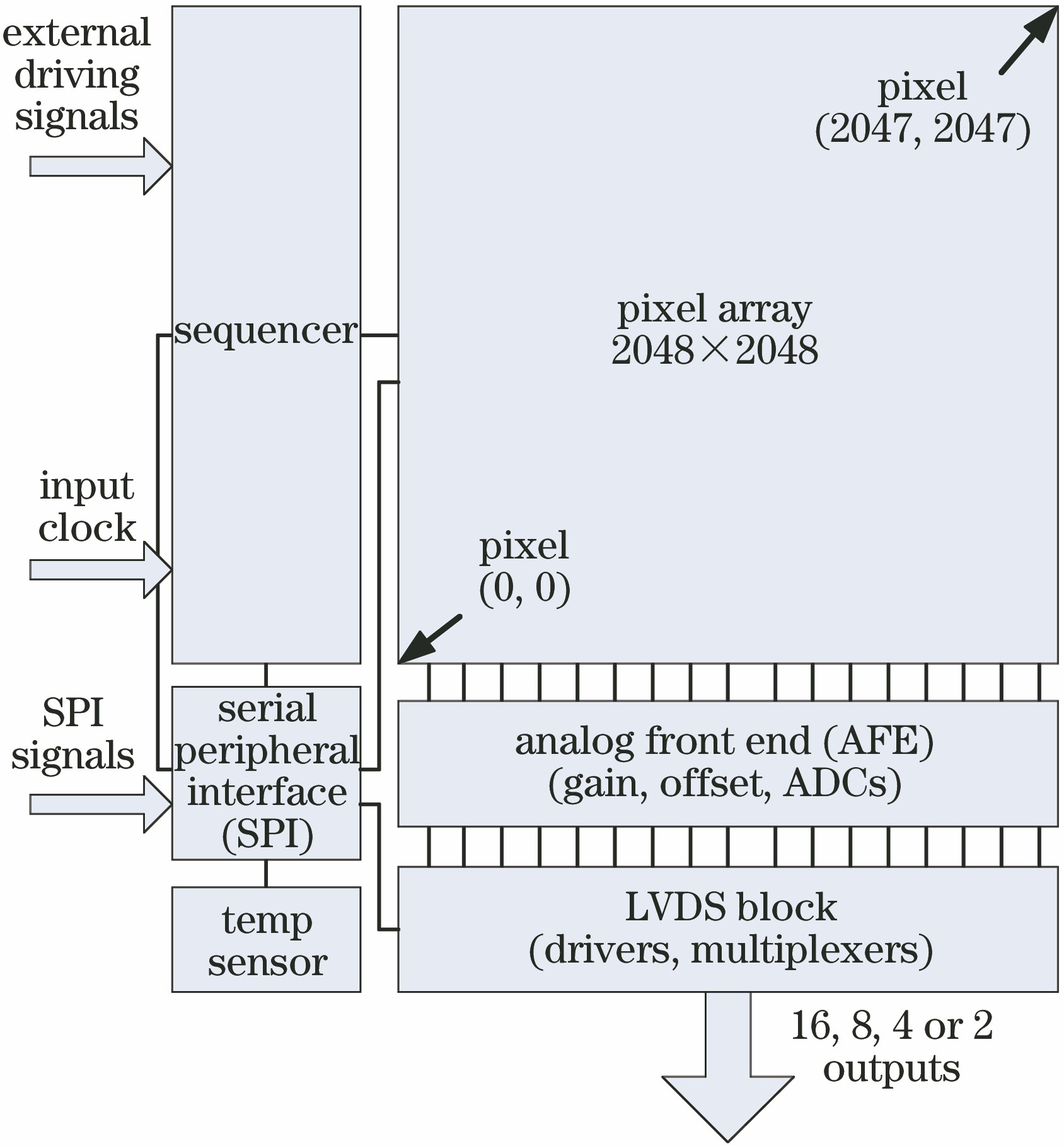
Set citation alerts for the article
Please enter your email address



