Yisha Cao, Feng Tang, Xiangzhao Wang, Yang Liu, Peng Feng, Yunjun Lu, Fudong Guo. Measurement Techniques for Distortion of Lithography Projection Objective[J]. Laser & Optoelectronics Progress, 2022, 59(9): 0922012
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 59, Issue 9, 0922012 (2022)
![Formation principle of the distortion[22]](/richHtml/lop/2022/59/9/0922012/img_01.jpg)
Fig. 1. Formation principle of the distortion[22]

Fig. 2. Distortion of the optical system. (a) Radial symmetry distortion (
Fig. 3. Imaging results of the optical system. (a) Imaging result of an optical system without distortion; (b) imaging result of an optical system with positive distortion (
Fig. 4. Radial distortion component and tangential distortion component in decentering distortion
Fig. 5. Schematic diagram of actual imaging position and ideal imaging position
Fig. 6. Distortion detection principle of the lithography projection objective
Fig. 7. Diagram of the distortion measurement device of lithography projection objective
Fig. 8. Flow chart of distortion measurement based on exposure
Fig. 10. Box measurement mark[2]
Fig. 11. Shear exposure field. (a) X shear exposure field; (b) Y shear exposure field[2]
Fig. 12. Schematic diagram of exposure distortion measurement of the SMEE[3]
Fig. 13. Schematic diagram of aerial image position measurement based on slit scanning method[4]
Fig. 14. Distortion detection based on aerial image[6]
Fig. 15. Principle of the differential measurement[14]
Fig. 16. Principle of the Shaker-Hartmann sensor. (a) Ideal wavefront; (b) deformed wavefront[11]
Fig. 17. Principle of measuring the position deviation of the marked image point with the Shake-Hartmann sensor. (a) Horizontal; (b) vertical[15]
Fig. 18. Principle of the SMEE interferometer[45]
Fig. 19. Optical path diagram of the point diffraction interferometer for measuring distortion[16]
Fig. 20. Wave aberration detection system of projection objective based on Ronchi shearing interference[51]
Fig. 21. Schematic diagram of the measurement grid[19]
Fig. 22. Reticle alignment marks (2×7) on both ends of the mask are used to align the reticle[52]
Fig. 23. Principle of measuring distortion of the projection objective of the lithography machine based on Moiré fringe[53]
|
Table 1. Absolute distortion of the projection objective of different lithography machines
|
Table 2. Comparison results of three distortion detection technologies
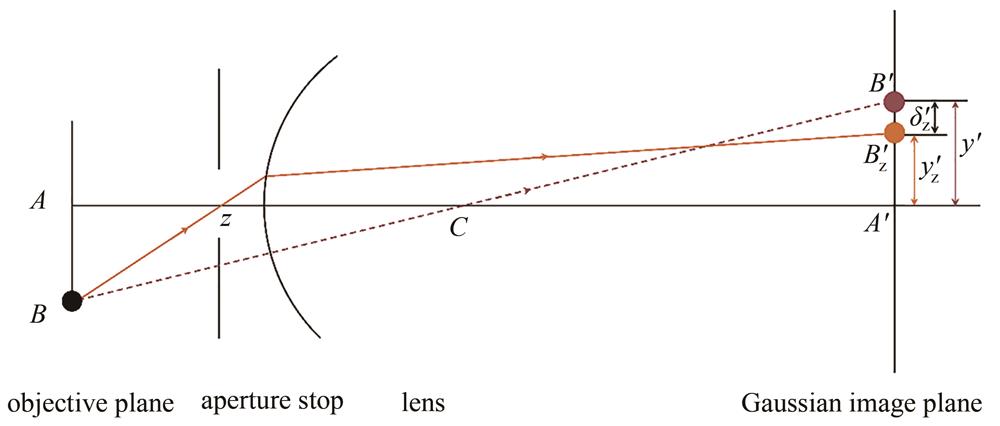
Set citation alerts for the article
Please enter your email address



