Wei Liu, Zhuxin Li, Zengliang Shi, Ru Wang, Yizhi Zhu, Chunxiang Xu. Nano-buffer controlled electron tunneling to regulate heterojunctional interface emission[J]. Opto-Electronic Advances, 2021, 4(9): 200064-1
Search by keywords or author
- Opto-Electronic Advances
- Vol. 4, Issue 9, 200064-1 (2021)
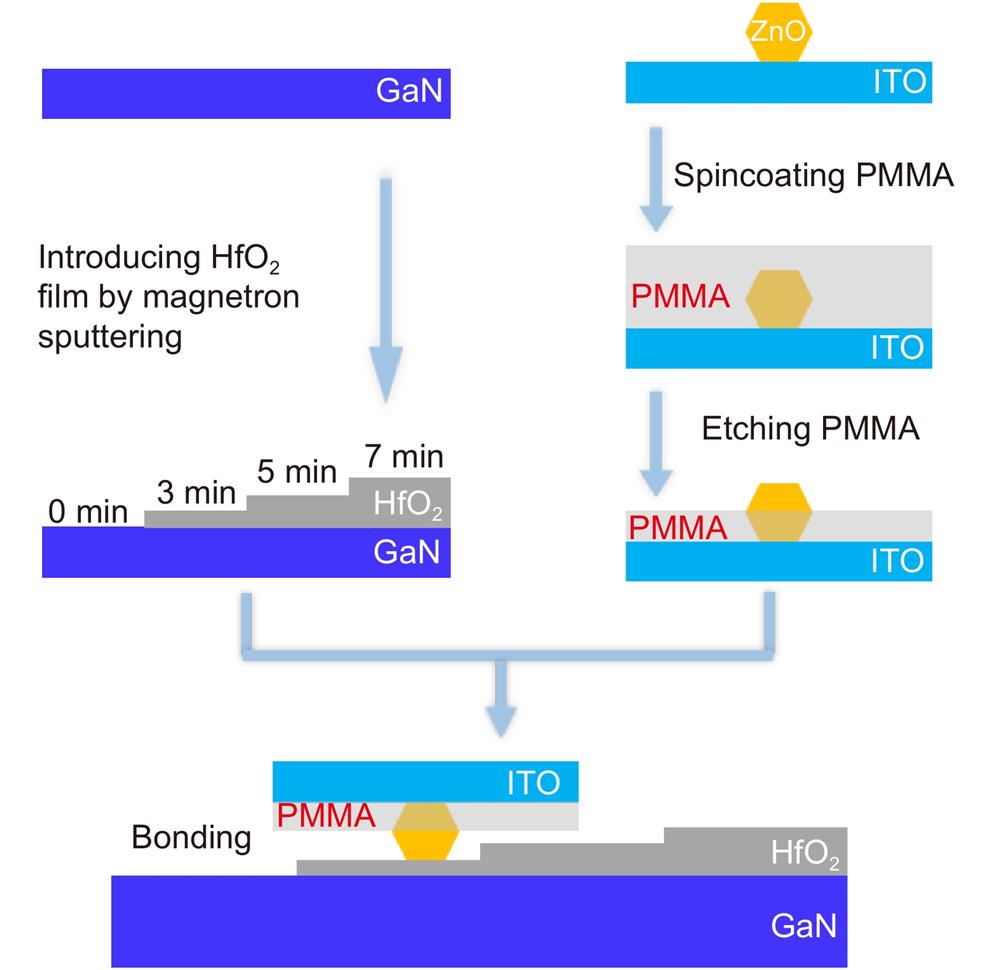
Set citation alerts for the article
Please enter your email address



