Fu Chen, Wen-Xin Tang, Guo-Hao Yu, Li Zhang, Kun Xu, Bao-Shun Zhang. Effect of U-shape trench etching process on electrical properties of GaN vertical trench metal-oxide-semiconductor field-effect transistor [J]. Acta Physica Sinica, 2020, 69(9): 098501-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 9, 098501-1 (2020)
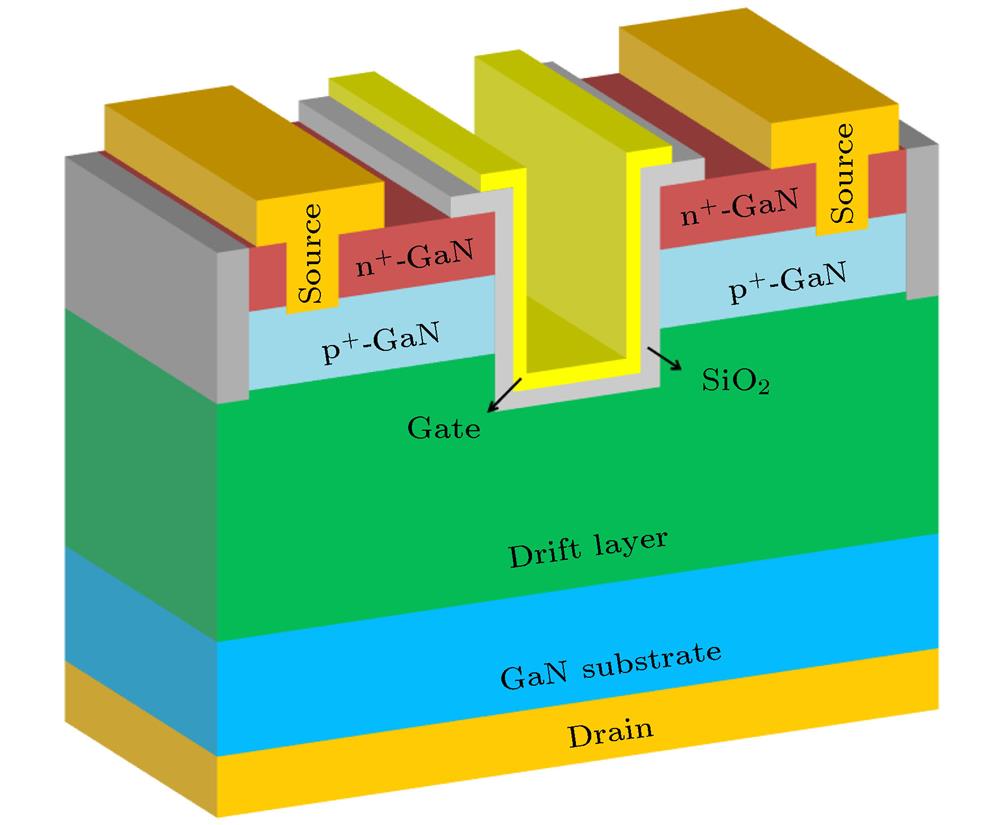
Fig. 1. Cross-sectional schematic of a vertical GaN UMOSFET.

Fig. 2. Electrical characteristics of GaN UMOSFETs fabricated with RF power of 50, 75 and 135 W (I GS and I DS are gate and drain currents): (a) Transfer characteristics; (b) field-effect channel mobility as a function of gate voltage; (c) subthreshold characteristics; (d) breakdown characteristics.
Fig. 3. Electrical characteristics of GaN UMOSFETs with SiO2 and photoresist as etching masks: (a) Transfer characteristics; (b) field-effect channel mobility vs. gate voltage; (c) output
 characteristics; (d) subthreshold characteristics.
characteristics; (d) subthreshold characteristics.
 characteristics; (d) subthreshold characteristics.
characteristics; (d) subthreshold characteristics. Fig. 4. (a) Etching morphology of the U-shape trench using different etching masks; (b) high-energy ion reflection at the sidewall of etching masks.
Fig. 5. SEM image of U-shape trench after dry etching with photoresist etching mask.
|
Table 1. Experiment parameters of the dry etching process.
Set citation alerts for the article
Please enter your email address



