Yiding Lin, Danhao Ma, Kwang Hong Lee, Rui-Tao Wen, Govindo Syaranamual, Lionel C. Kimerling, Chuan Seng Tan, Jurgen Michel. PIC-integrable, uniformly tensile-strained Ge-on-insulator photodiodes enabled by recessed SiNx stressor[J]. Photonics Research, 2021, 9(7): 1255
Search by keywords or author
- Photonics Research
- Vol. 9, Issue 7, 1255 (2021)
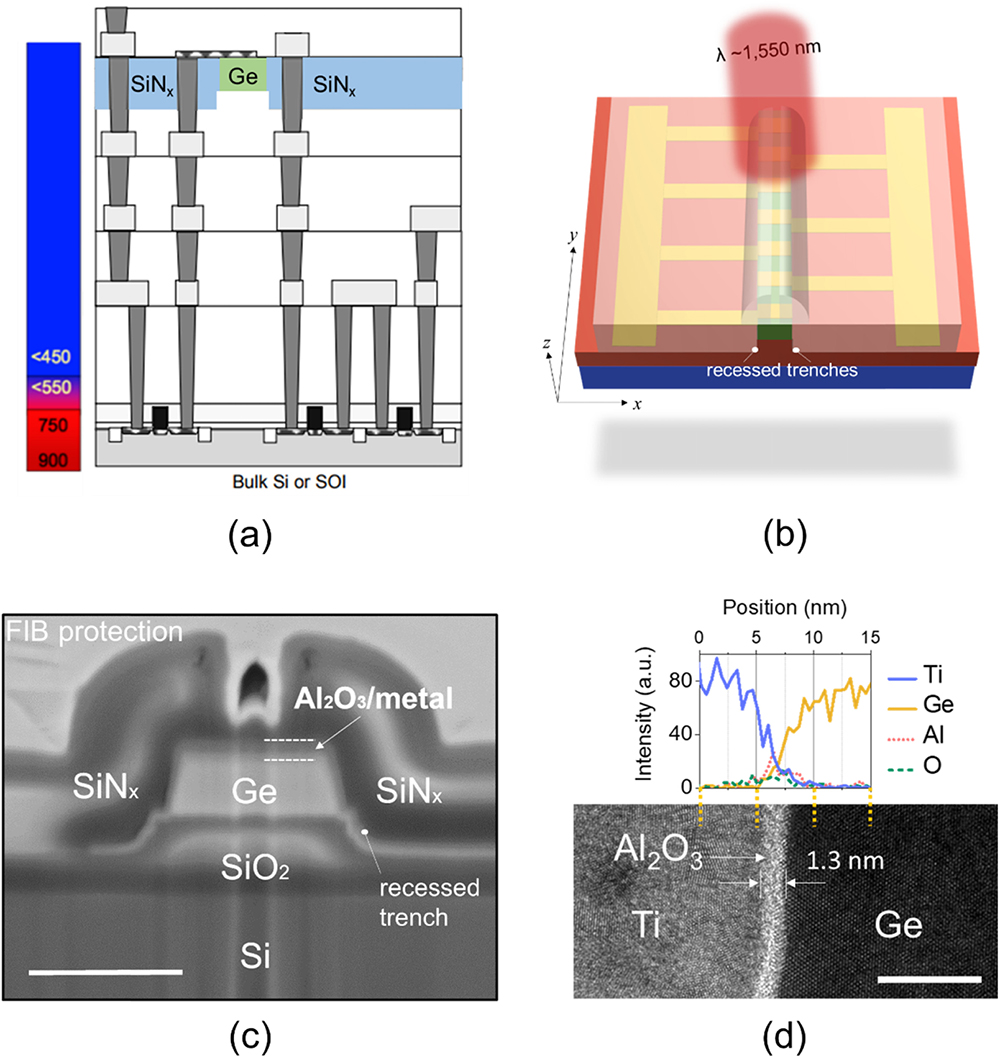
Fig. 1. Recess-strained GOI photodiodes for PICs. (a) Schematic showing the integration of high-quality recess-strained Ge photodiodes with CMOS circuits at back-end-of-line (BEOL). (b) A 3D schematic of a normal-incidence recess SiN x ⟨ 100 ⟩ SiO 2 SiN x Ge / Al 2 O 3 / metal

Fig. 2. Characterization of the recess strained GOI MSM photodiodes. (a) Current-voltage (I-V ) characteristics of the device without (black) and with (red) an incident power of ∼ 20 mW
Fig. 3. Effect of recessed SiN x SiN x ε x x SiN x ∼ 300.8 cm − 1 SiN x α y In 0.53 Ga 0.47 As
Fig. 4. Strain, bandgap edge, and absorption coefficient analysis. (a) The simulated Ge ε x x 3 (a) and 3 (b), (ii)] and the Ge bandgap edges [from Fig. 3 (d)] agree well with the deformation potential theory. (b) Calculated bandgap edges and α
Fig. 5. (a) ε x x SiN x ε x x W /T ) ratio. (b) ε x x ε x x A.1 . The SiN x ε x x
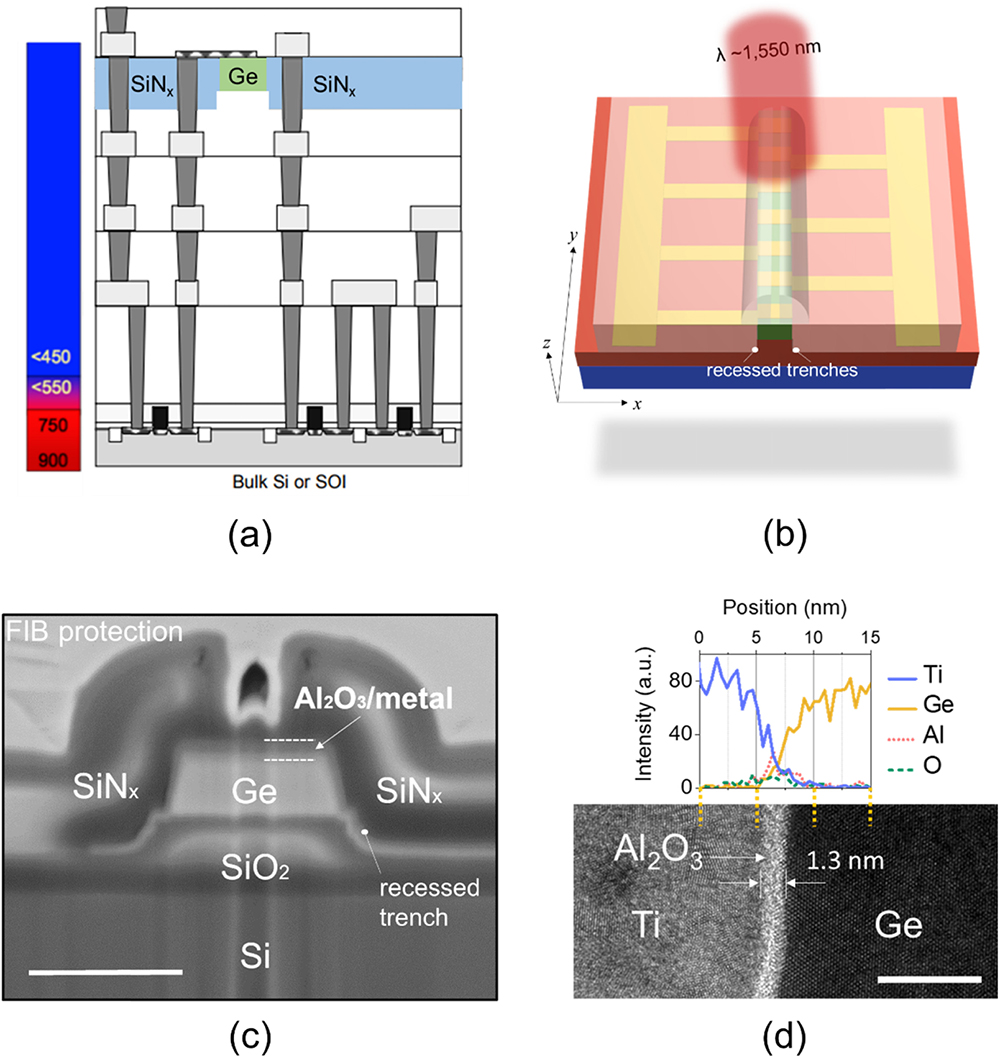
Set citation alerts for the article
Please enter your email address



