Xuanhu Chen, Fangfang Ren, Shulin Gu, Jiandong Ye, "Review of gallium-oxide-based solar-blind ultraviolet photodetectors," Photonics Res. 7, 381 (2019)
Search by keywords or author
- Photonics Research
- Vol. 7, Issue 4, 381 (2019)
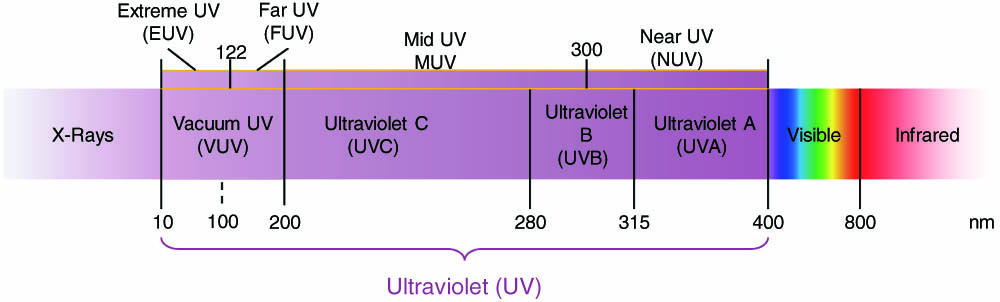
Fig. 1. UV spectral region and its subdivisions.

Fig. 2. Schematic structures of different semiconductor photodetectors.
Fig. 3. (a) Energy band diagram of a metal and a semiconductor before contact; (b) ideal energy band diagram of a metal/n–semiconductor junction for ϕ m > ϕ s
Fig. 4. Dependence of the Schottky barrier height on the metal work function of different metals, and the ideal Schottky barrier height based on the Schottky–Mott model (short dashed curve).
Fig. 5. Chart illustrating transformation relationships among the forms of Ga 2 O 3 et al. [93]. Copyright 1952 American Chemical Society.
Fig. 6. Various Ga 2 O 3 γ - Ga 2 O 3 et al. [196]. Copyright 2010 American Chemical Society. (b) β - Ga 2 O 3 et al. [229]. Copyright 2007 American Institute of Physics. (c) Ga 2 O 3 / GaN : O x @ SnO 2 et al. [234]. Copyright 2015 Elsevier B.V. (d) β - Ga 2 O 3 et al. [244]. Copyright 2009 Wiley-VCH Verlag GmbH & Co. KGaA, Weinheim. (e) As-synthesized β - Ga 2 O 3 et al. [256]. Copyright 2014 Wiley-VCH Verlag GmbH & Co. KGaA, Weinheim. (f) Branched multiwire nanostructures (left) and its X-ray fluorescence (XRF) map (right). Reprinted with permission from Martinez-Criado et al. [224]. Copyright 2014 American Chemical Society.
Fig. 7. The crystal structure of β - Ga 2 O 3 ( 2 ¯ 01 )
Fig. 8. Band structure of β - Ga 2 O 3 et al. [275]. Copyright 2017 American Physical Society.
Fig. 9. ( α h ν ) 2 h ν E | | c E | | a * E | | a E | | b et al. [12]. Copyright 2015 The Japan Society of Applied Physics.
Fig. 10. (a) 1 μm × 1 μm I –V characteristics of a photodetector. Closed (black) and open (red) symbols represent current in the dark condition and current in the presence of 250 nm light irradiation, respectively. (c) Photocurrent spectral response (blue) and photoresponsivity of the photodetector (black) at a reverse bias of 10 V. The dashed line indicates the photoresponsivities expected in the case without carrier multiplication. Reprinted with permission from Oshima et al. [304]. Copyright 2008 The Japan Society of Applied Physics. (d) Transient response of the detector. (e) Signal from the flame detection system during the demonstration. Reprinted with permission from Oshima et al. [305]. Copyright 2009 The Japan Society of Applied Physics.
Fig. 11. (a) Dark I –V characteristics of the Au - Ga 2 O 3 et al. [87]. Copyright 2009 American Institute of Physics. (c) Time-dependent photoresponse of the β - Ga 2 O 3 et al. [310]. Copyright 2014 American Institute of Physics. (d) Temporal response tests of the PDs with KrF pulse laser illumination at 10 V bias. Reprinted with permission from Cui et al. [315]. Copyright 2017 Wiley-VCH Verlag GmbH & Co. KGaA, Weinheim.
Fig. 12. (a) Photoresponsivity of metal–semiconductor–metal deep ultraviolet photodetectors. (b) Low-frequency noise power density as a function of frequency of metal–semiconductor–metal deep-ultraviolet photodetectors. Reprinted with permission from Lee et al. [320]. Copyright 2018 IEEE. (c) EDX line scan along the In gradient (the black dashed lines separate different crystallographic phases); (d) single XRD patterns selected from each phase. (e) Responsivity versus photon energy of 10 MSM-PDs along the In gradient. (f) Spectrally resolved J –V measurements of an SC [the analyzed ϕ Bn , eff et al. [326]. Copyright 2016 American Institute of Physics.
Fig. 13. (a) Real-time photoresponse of the detector to 254 nm light. (b) Enlarged rise and decay edges for the first “ON” and “OFF”, respectively. Reprinted with permission from Feng et al. [266]. Copyright 2006 American Institute of Physics. (c) Enlarged SEM images of the photo switch made of an individual Au - in - Ga 2 O 3 et al. [207]. Copyright 2008 American Chemical Society.
Fig. 14. (a) Time-dependent photoresponse of the bridged β - Ga 2 O 3 ∼ 2 mW · cm − 2 ∼ 5 × 10 4 ∼ 5 × 10 6 β - Ga 2 O 3 et al. [331]. Copyright 2010 Wiley-VCH Verlag GmbH & Co. KGaA, Weinheim. (e) Schematic illustration of the fabrication of the β - Ga 2 O 3 I −V characteristics of the device in the dark and under the illumination of 254 nm light in the logarithmic scale. Inset shows the photovoltaic characteristic of the device near zero bias. (g) Time-dependent photocurrent response of an Au / β - Ga 2 O 3 2 mW · cm − 2 et al. [203]. Copyright 2016 American Chemical Society.
Fig. 15. (a) Atomic force microscopy image of a 2D β - Ga 2 O 3 et al. [258]. Copyright 2014 Royal Society of Chemistry. (b) I –V characteristics of the device in the dark. (c) I –V characteristics of the device under irradiation with 254 nm light at different light intensities. Reprinted with permission from Zhong et al. [259]. Copyright 2015 Elsevier B.V. All rights reserved. (d) The ON/OFF cycle of the β - Ga 2 O 3 9.835 × 10 − 5 W / cm 2 et al. [256]. Copyright 2014 Wiley-VCH Verlag GmbH & Co. KGaA, Weinheim. (e) Time-dependent photoresponse of the fabricated photodetector under various illumination conditions (254, 365, 532, and 650 nm light exposure). (f) Experimental and fitted curves of the current rise and decay process at 254 nm illumination under a gate bias of 0 V. Reprinted with permission from Oh et al. [169]. Copyright 2016 Royal Society of Chemistry.
Fig. 16. (a) Schematic diagram of the APD device. (b) I –V characteristics of the photodetector under dark and illumination conditions with 254 nm light of 1.67 mW / cm 2 I –V characteristics at 300, 330, and 370 K in the reverse voltage under the dark condition; the inset shows the dependence of the avalanche breakdown voltage on the recording temperature. (d) Spectral response of the device at − 6 V − 6 V et al. [240]. Copyright 2015 American Chemical Society.
Fig. 17. (a) Dependence of current–voltage characteristics on intensity of UV light illumination of a deuterium lamp. (b) Top, reverse-current response of a photodiode to deep-UV light pulses (reverse-bias voltage is 2 V); bottom, light waveform measured by a silicon pin photodiode for the same light pulses. Reprinted with permission from Nakagomi et al. [342]. Copyright 2013 American Institute of Physics. (c) Spectral response of photodiodes based on a β - Ga 2 O 3 / GaN β - Ga 2 O 3 β - Ga 2 O 3 / SiC β - Ga 2 O 3 et al. [340]. Copyright 2015 Elsevier B.V. All rights reserved.
Fig. 18. (a) I –V characteristics of the β - Ga 2 O 3 / SnO 2 − 5.5 V bias − 5.5 V Ga 2 O 3 − 34.8 V et al. [181]. Copyright 2017 American Chemical Society.
|
Table 1. Summary of Ohmic Contact Properties on β - Ga 2 O 3
|
Table 2. Summary of Reported Schottky Barrier Contacts to β - Ga 2 O 3
|
Table 3. Summary of the Basic Parameters of Ga 2 O 3
| |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 4. Summary of the Reported Basic Parameters of Representative Ga 2 O 3
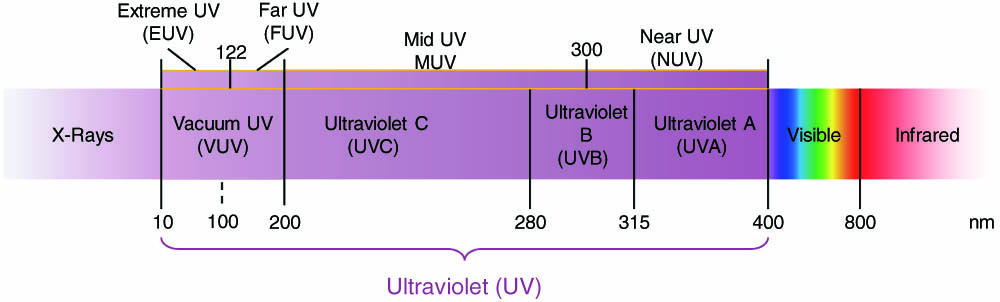
Set citation alerts for the article
Please enter your email address



