Heng Zhang, Sikun Li, Xiangzhao Wang, Wei Cheng. 3D Rigorous Simulation of Defective Masks used for EUV Lithography via Machine Learning-Based Calibration[J]. Acta Optica Sinica, 2018, 38(12): 1222002
Search by keywords or author
- Acta Optica Sinica
- Vol. 38, Issue 12, 1222002 (2018)
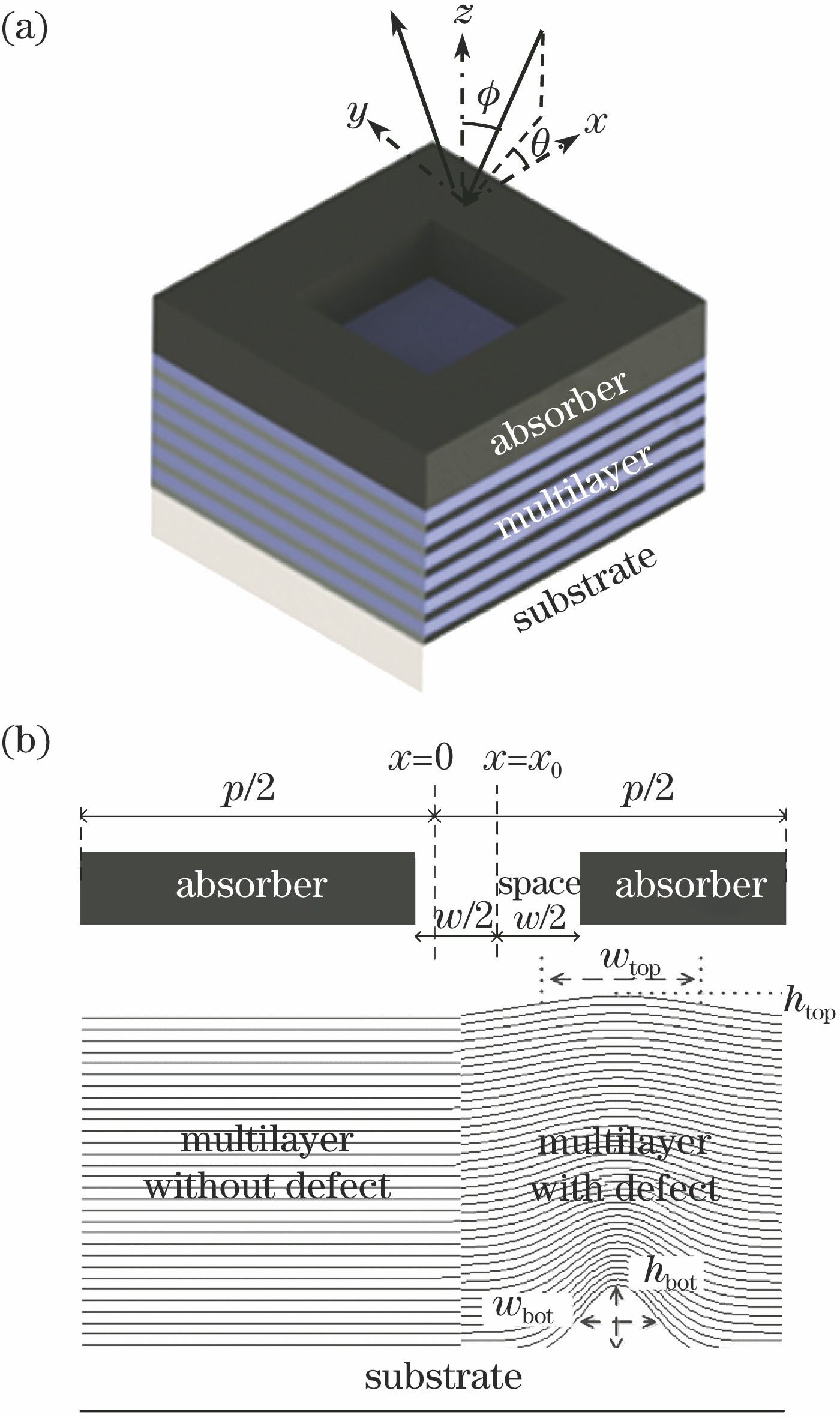
Fig. 1. Schematic of EUVL 3D mask. (a) 3D view; (b) side view
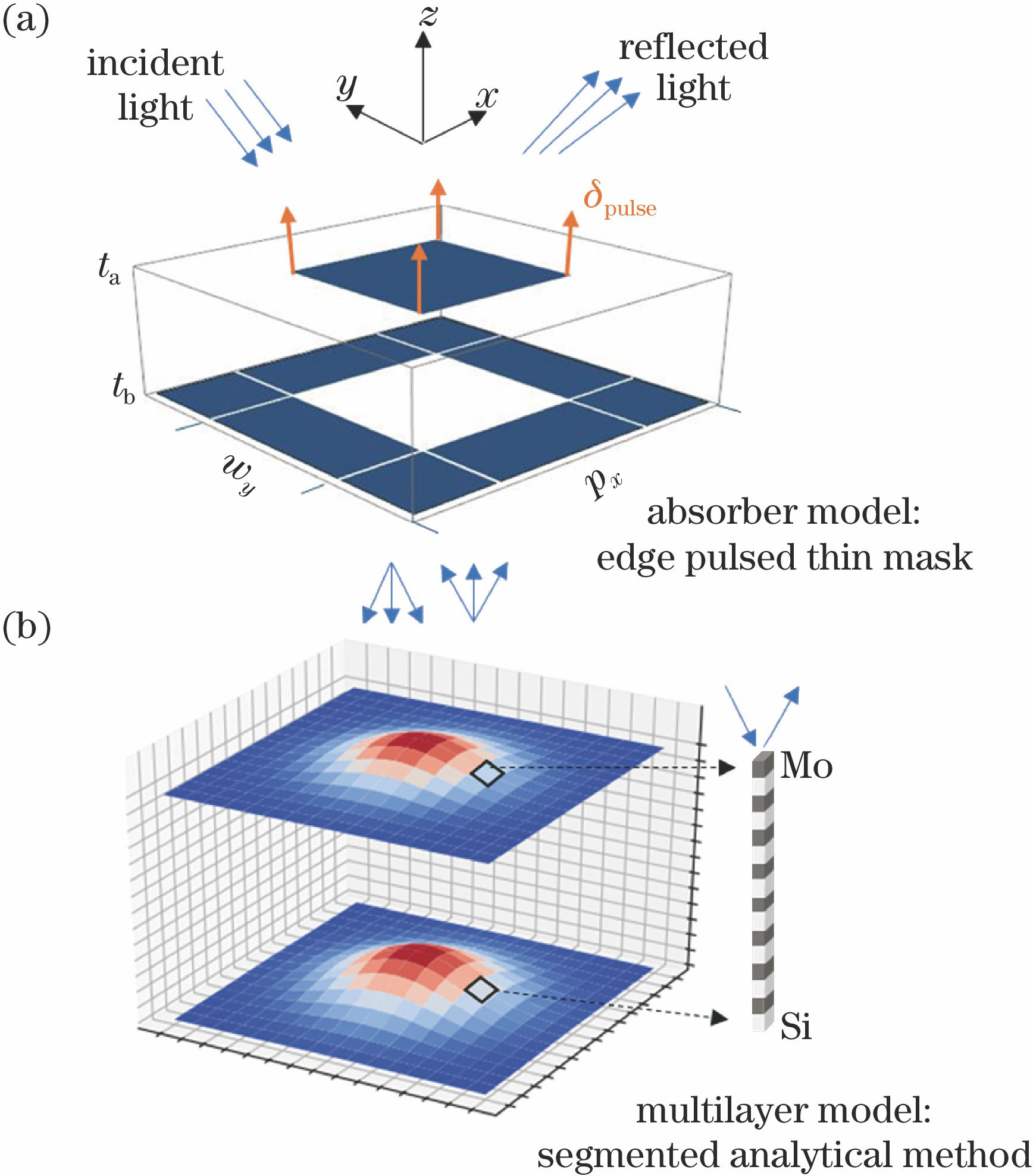
Fig. 2. Schematic of mask simulation model. (a) Absorber model; (b) multilayer model
Fig. 3. Flow chart of training and predicting process employed in machine learning methods
Fig. 4. Comparison of simulation results for fast models with and without model parameter calibration using different machine learning methods
Fig. 5. Comparison of the simulation accuracy of a parameter calibrated fast model and an advanced single-surface approximation model
Fig. 6. Comparison of the aerial images of mask simulations. (a) Rigorous simulation of a defect-free mask; (b) rigorous simulation of defective uncompensated mask; (c) defect compensation using a rigorous model; (d) defect compensation using a fast model
| ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 1. Training data for different masks
| |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 2. Testing data for different masks
|
Table 3. Comparison of simulation accuracy of different parameter calibration methods
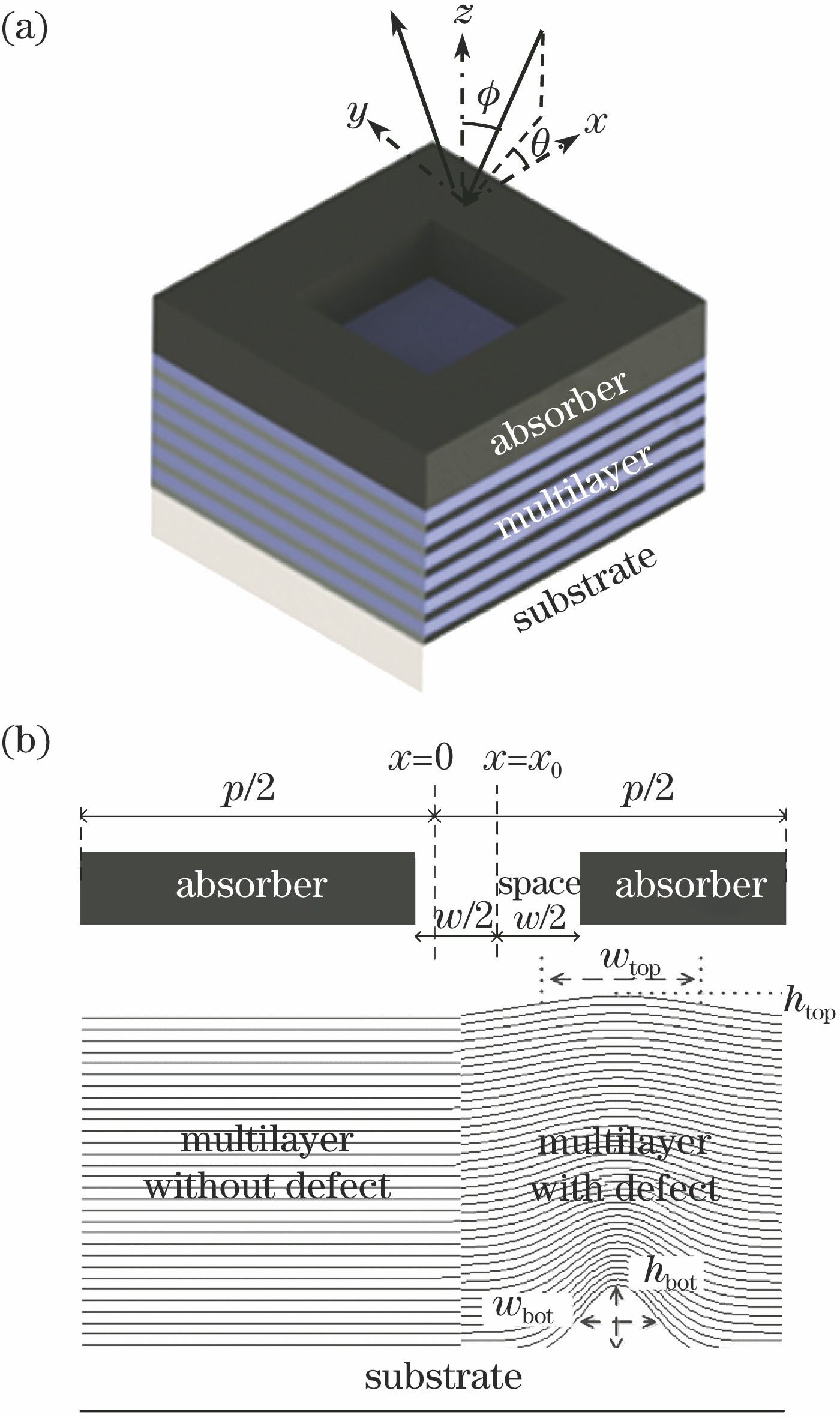
Set citation alerts for the article
Please enter your email address



