Yu GUO, Tong-Hua PENG, Chun-Jun LIU, Zhan-Wei YANG, Zhen-Li CAI. Correlation between Stacking Faults in Epitaxial Layers of 4H-SiC and Defects in 4H-SiC Substrate [J]. Journal of Inorganic Materials, 2019, 34(7): 748
Search by keywords or author
- Journal of Inorganic Materials
- Vol. 34, Issue 7, 748 (2019)
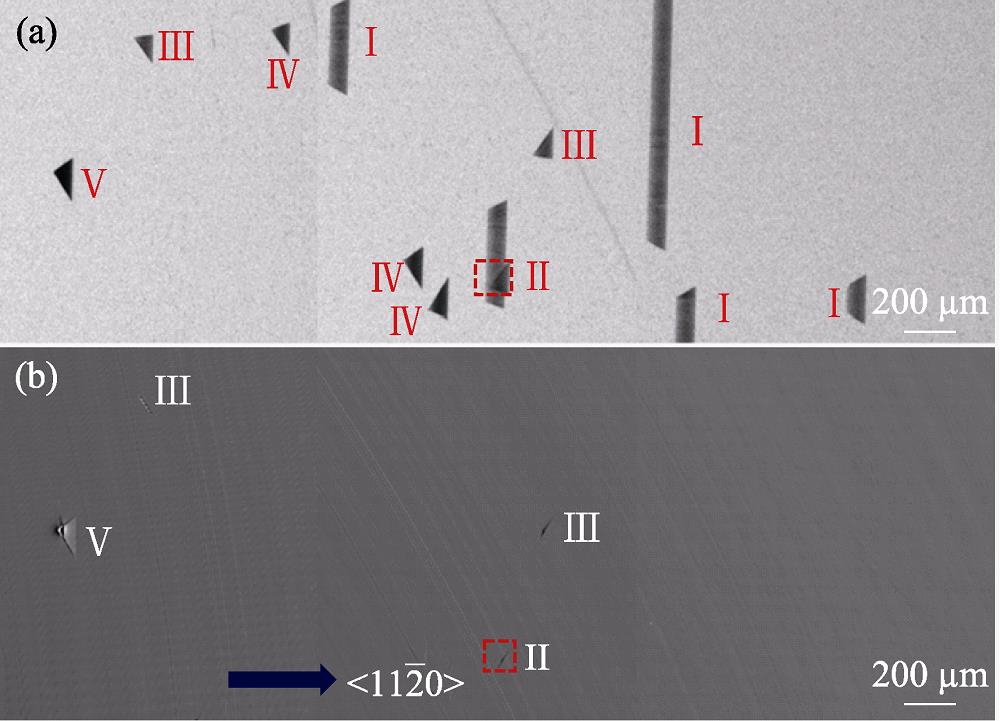
1. SF images tested by CS920 (a) PL images excited by 355 nm wavelength; (b) morphology images

2. Originations and propagations of SF I and SF II<11$\bar{2}$0> is the direction of lower steps of crystal growth. D 1-D 6 are the moving distances of BPD lines. H 1-H 6 are the removing thickness of epitaxial layers
3. Propagation diagrams of (a) SF I, (b) SF II, (c)-(d) SF III, and (e)-(f) SF IV
4. Originations and propagations of SF III<11$\bar{2}$0> is the direction of lower steps of crystal growth. D 1-D 4 are the moving distances of BPD lines. H 1-H 4 are the removing thickness of epitaxial layers
5. Originations and propagations of SF IV<11$\bar{2}$0> is the direction of lower steps of crystal growth. H 1~H 6 are the removing thickness of epitaxial layers. L 1~L 8 are bottom lengths of triangle defects. W 1~W 8 are widths of triangle defects
|
Table 1. Relationship of moving distance D of BPD lines and removing thickness H of epitaxial layers in Fig. 2
|
Table 2. Nitrogen concentration in substrate and epitaxial layers tested by SIMS
|
Table 3. Relationship of the moving distance D of BPD lines and the removing thickness H of epitaxial layers in Fig. 3
|
Table 4. Relationship of the moving distance D of BPD lines, the removing thickness H of epitaxial layers and width of trianagle defects W with bottom lengths of triangle defects in Fig. 3
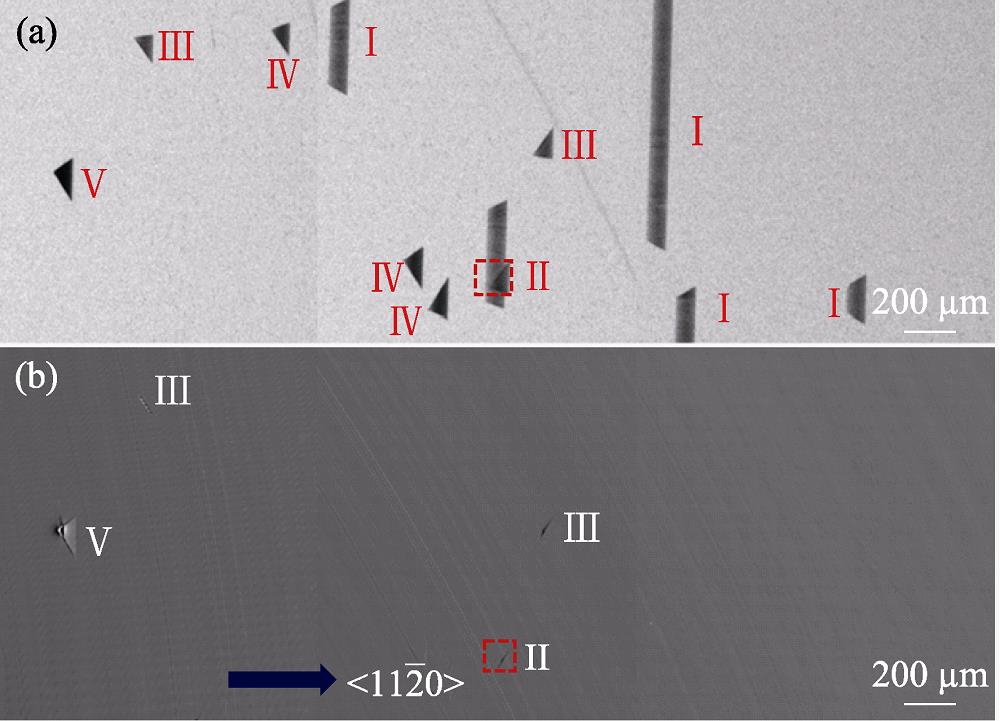
Set citation alerts for the article
Please enter your email address



