Jiasheng Cao, Tao Li, Hongzhen Wang, Chunlei Yu, Bo Yang, Yingjie Ma, Xiumei Shao, Xue Li, Haimei Gong. Study on InP/InGaAs hetero-structure detector with unintentionally doping absorption layer[J]. Infrared and Laser Engineering, 2021, 50(11): 20210073
Search by keywords or author
- Infrared and Laser Engineering
- Vol. 50, Issue 11, 20210073 (2021)
Abstract
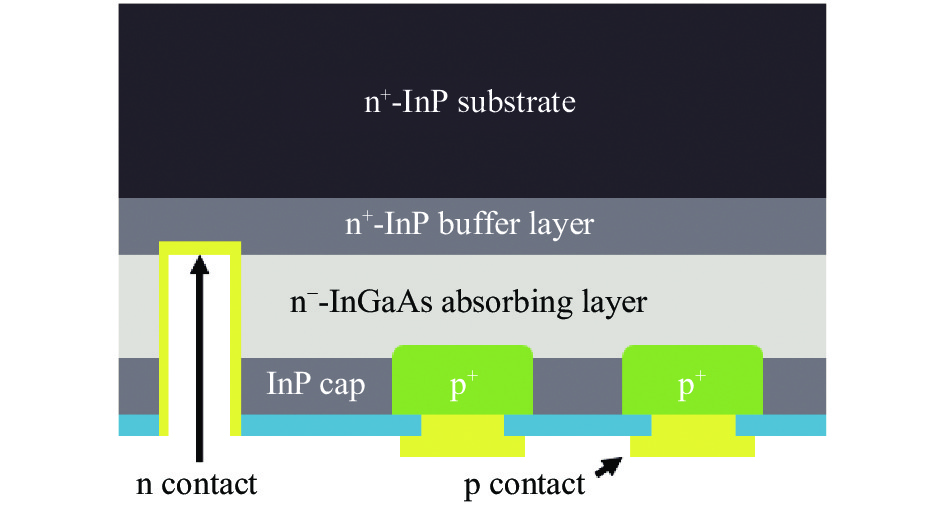
Set citation alerts for the article
Please enter your email address



