DaeHwan Ahn, Sunghan Jeon, Hoyoung Suh, Seungwan Woo, Rafael Jumar Chu, Daehwan Jung, Won Jun Choi, Donghee Park, Jin-Dong Song, Woo-Young Choi, Jae-Hoon Han. High-responsivity InAs quantum well photo-FET integrated on Si substrates for extended-range short-wave infrared photodetector applications[J]. Photonics Research, 2023, 11(8): 1465
Search by keywords or author
- Photonics Research
- Vol. 11, Issue 8, 1465 (2023)
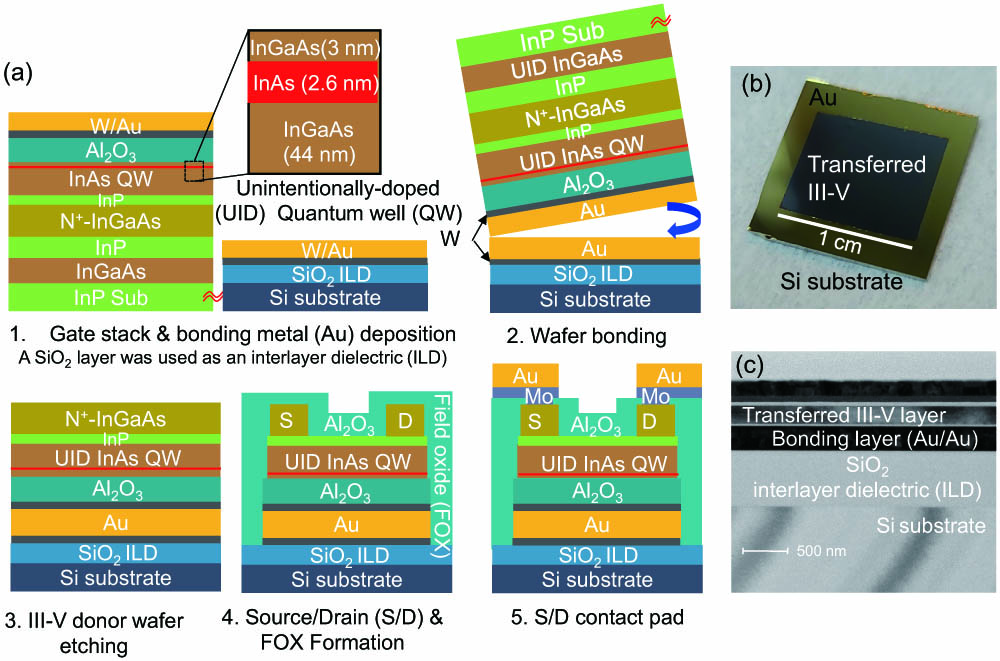
Fig. 1. (a) Fabrication flow of InAs QW photo-FETs integrated on SiO 2
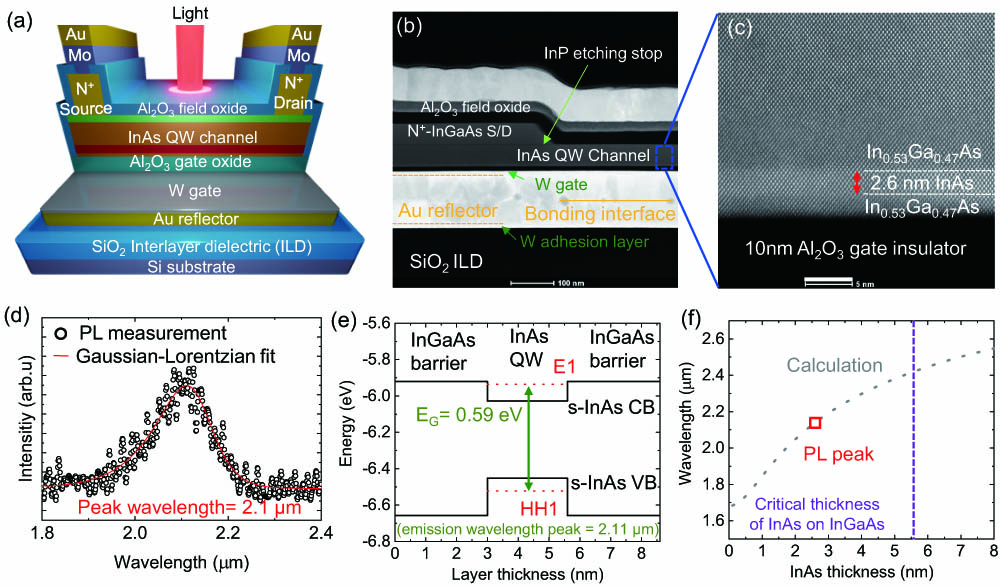
Fig. 2. (a) Schematic image of an InAs QW photo-FET. (b) High-angle annular dark-field scanning TEM (HAADF-STEM) image of an InAs QW photo-FET, confirming successful selective etching of N +
Fig. 3. (a) Measurement configuration based on the confocal microscopy. (b) I D - V G I D - V G I D - V D
Fig. 4. (a) Photocurrent and (b) responsivity for the InAs QW photo-FET with various channel lengths. (c) Relationship between the responsivity and channel length for the InAs QW photo-FET under the low optical power of 0.5 nW.
Fig. 5. (a) Schematic image of the time response measurement. (b) Time response for the InAs QW photo-FET at the different V G − 0.6 V V G I D - V G
Fig. 6. (a) Photocurrent and (b) responsivity of InAs QW photo-FETs under 1.3, 1.55, and 2 μm wavelength optical sources. (c) Benchmark of responsivity of our InAs QW photo-FETs with commercialized InGaAs and extended InGaAs photodiodes (PDs) and InGaAs and InAs NW photo-FETs and PD.
|
Table 1. Benchmark of Our InAs QW Photo-FET with Previously Reported III-V Photo-FETsa
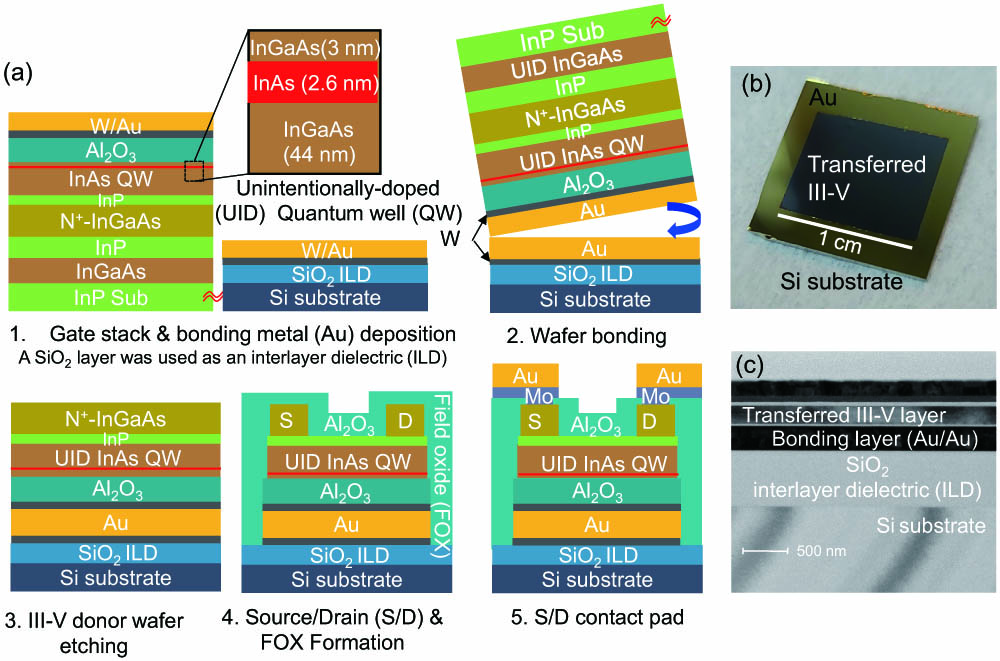
Set citation alerts for the article
Please enter your email address



