Yuzhao Liu, Zhili Chen, Mangmang Fei, Yingxue Xi, Weiguo Liu. Irradiation of Sapphire Under Different Kr
+-Ion Beam Parameters
[J]. Laser & Optoelectronics Progress, 2019, 56(12): 121601
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 56, Issue 12, 121601 (2019)

Fig. 1. Roughness and etching rates under different factors. (a) Angle of incidence; (b) ion beam flux density; (c) ion energy; (d) etching time
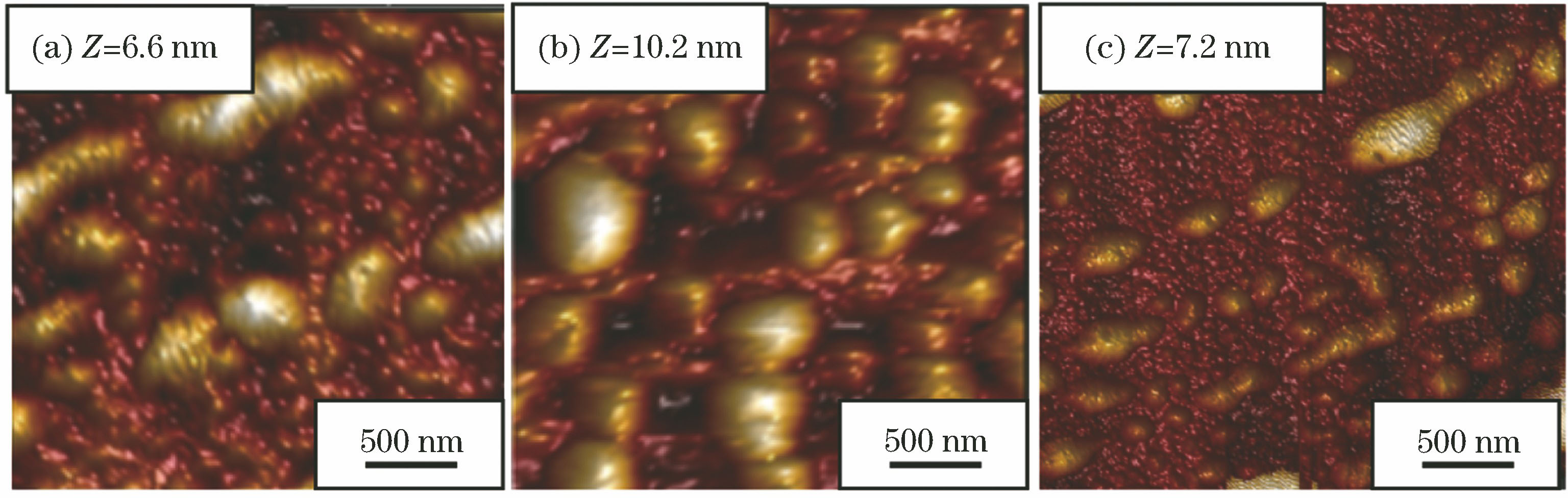
Fig. 2. AFM images of sapphire under different etching parameters
Fig. 3. Sample surface morphologies. (a) Surface roughness; (b) etching rate
|
Table 1. Level-factor distribution
| ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 2. Orthogonal test
| |||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 3. Range analysis of surface roughness and etching rate
| |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 4. Variance analysis of surface roughness and etching rate

Set citation alerts for the article
Please enter your email address



