Shi-Jian Dong, Hong-Xia Guo, Wu-Ying Ma, Ling Lv, Xiao-Yu Pan, Zhi-Feng Lei, Shao-Zhong Yue, Rui-Jing Hao, An-An Ju, Xiang-Li Zhong, Xiao-Ping Ouyang. Ionizing radiation damage mechanism and biases correlation of AlGaN/GaN high electron mobility transistor devices [J]. Acta Physica Sinica, 2020, 69(7): 078501-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 7, 078501-1 (2020)
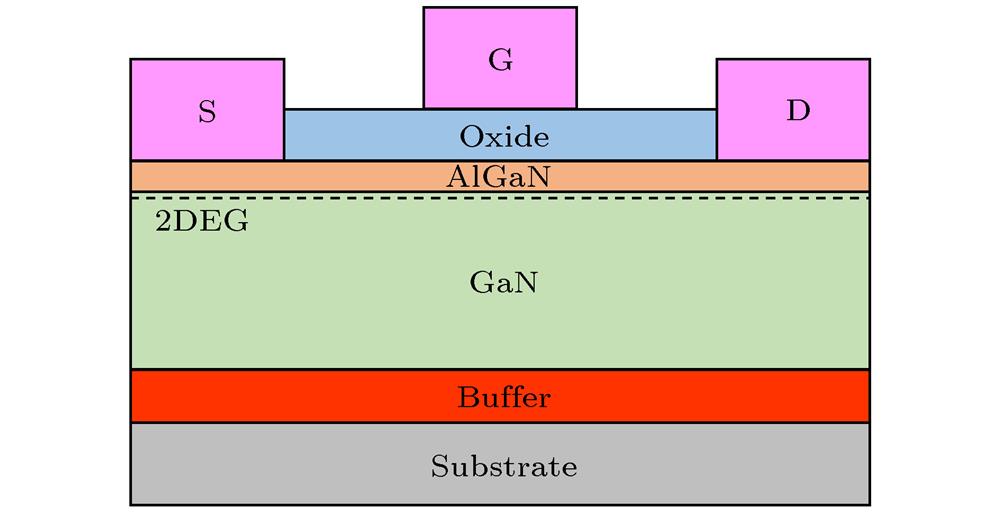
Fig. 1. AlGaN/GaN HEMT devices’ cross-section.

Fig. 2. AlGaN/GaN HEMT devices’ low frequency noise measurement system.
Fig. 3. The output characteristic curve (a) and transfer characteristic curve (b) of the AlGaN/GaN HEMT device before and after irradiation under the zero-bias.
Fig. 4. Charge distribution patterns of AlGaN/GaN HEMT devices: (a) The off and semi-on states; (b) zero-bias.
Fig. 5. Normalized channel current noise power spectral density in the AlGaN/GaN HEMT devices before and after irradiation: (a) OFF state; (b) SEMI-ON state; (c) zero-bias.
Fig. 6. Normalized channel current noise power spectral density versus overdrive voltage in the AlGaN/GaN HEMT devices before and after irradiation: (a) OFF state; (b) SEMI-ON state; (c) zero-bias (dot: measured value; continuous line: fitted value).
Fig. 7. Normalized channel current noise power spectral density versus channel current in the AlGaN/GaN HEMT devices before and after irradiation: (a) OFF state; (b) SEMI-ON state; (c) zero-bias (f = 25 Hz, dot: measured value; continuous line: fitted value).
Fig. 8. Extracted spatial distribution of trapped charges in the AlGaN/GaN HEMT devices’ barrier layer: (a) OFF state; (b) SEMI-ON state; (c) zero-bias.
|
Table 1. The biases set of AlGaN/GaN HEMT device irradiation experiment.
|
Table 2.
Variation of saturation drain current and maximum transconductance before and after irradiation in AlGaN/GaNHEMT devices with different biases.
不同偏置下AlGaN/GaN HEMT器件辐照前后饱和漏电流与最高跨导的变化
|
Table 3.
Flat-band voltage noise power spectral density in the AlGaN/GaN HEMT devices before and after irradiation under different biases (in V2·Hz–1).
不同偏置下AlGaN/GaN HEMT器件辐照前后平带电压噪声功率谱密度(单位: V2·Hz–1)
|
Table 4.
The defect density in the AlGaN/GaN HEMT devices before and after irradiation under different biases (in cm–3·eV–1).
不同偏置下AlGaN/GaN HEMT器件辐照前后缺陷密度(单位: cm–3·eV–1)
Set citation alerts for the article
Please enter your email address



