Yonghui Zhang, Zihui Zhang, Chong Geng, Shu Xu, Tongbo Wei, Wen'gang Bi, "Versatile nanosphere lithography technique combining multiple-exposure nanosphere lens lithography and nanosphere template lithography," Chin. Opt. Lett. 15, 062201 (2017)
Search by keywords or author
- Chinese Optics Letters
- Vol. 15, Issue 6, 062201 (2017)
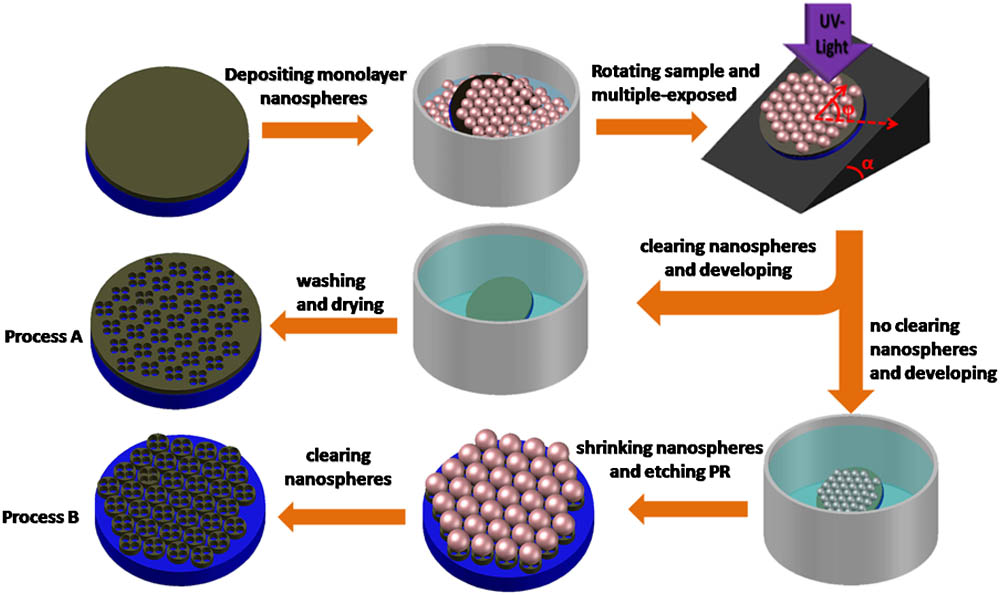
Fig. 1. Process flowchart of MENSLL (Process A) and NSCL (Process B).

Fig. 2. (a) Simulated structure of FDTD; Electric field distributions for (b) 1200-nm-diameter nanosphere and (c) 600-nm-diameter nanosphere; Electric field distribution in XY plane for tilt exposure with the tilted angle (d) XZ plane.
Fig. 3. Plane-view SEM images for samples after (a) twin exposures when
Fig. 4. SEM images of (a) the nanosphere monolayer after developing, (b) the nanosphere cleared partly, and (c) close-pack nanorings. The black scale bar is 2 μm.
Fig. 5. SEM images of nanring fabricated by shrinking silica spheres for (a) 180, (b) 270, and (c) 360 s. Insets: side view images. The black scale bar is 1 μm.
Fig. 6. SEM images of nanorescents fabricated in the conditions of (a)
Fig. 7. SEM images of hierarchical multiple structures with (b) triple exposures when
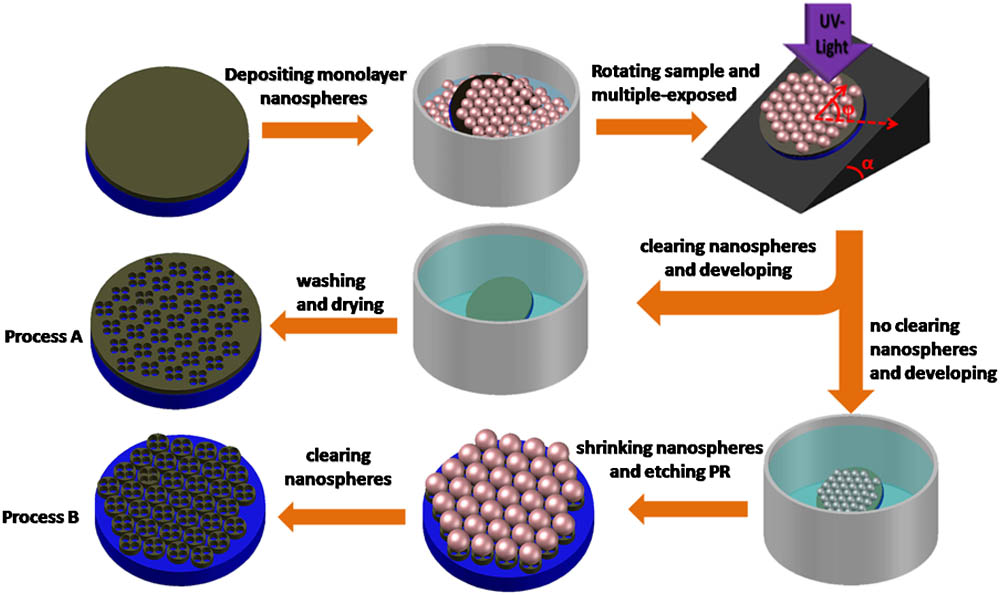
Set citation alerts for the article
Please enter your email address



