Yuhan Li, Huapan Xiao, Hairong Wang, Xiaoya Liang, Changpeng Li, Xin Ye, Xiaodong Jiang, Xinxiang Miao, Caizhen Yao, Laixi Sun. Review on Wet Etching Technique of Fused Silica Optical Elements[J]. Laser & Optoelectronics Progress, 2021, 58(15): 1516026
Search by keywords or author
- Laser & Optoelectronics Progress
- Vol. 58, Issue 15, 1516026 (2021)
![Damage morphologies on fused silica surface. (a) Damage at scratch edge[20]; (b) morphology of damage initiation site[23]](/richHtml/lop/2021/58/15/1516026/img_1.jpg)
Fig. 1. Damage morphologies on fused silica surface. (a) Damage at scratch edge[20]; (b) morphology of damage initiation site[23]
![Laser-induced damage resistance performances before and after fused silica leaching [5]. (a) Damage probability; (b) damage density](/richHtml/lop/2021/58/15/1516026/img_2.jpg)
Fig. 2. Laser-induced damage resistance performances before and after fused silica leaching [5]. (a) Damage probability; (b) damage density
Fig. 4. Laser damage growth of HF-etched laser damage sites with different sizes after laser irradiation [41].(a)Before irradiation;(b)after irradiation
Fig. 5. Surface impurity distributions of fused silica measured by TOF-SIMS at different process stages [18]. (a) Before leaching; (b) after HNO3/H2O2 leaching; (c) after HF etching 1 μm; (d) after HF etching 10 μm; (e) after HF etching 50 μm
Fig. 6. Evolution of light intensity distribution on cross-section of optical elements before and after etching [20]. (a) (b) Perpendicular to scratch; (c) (d) parallel to scratch
Fig. 7. Evolution of damage resistance performance of elements during etching. (a) LIDT[49]; (b) damage probability[42]; (c) damage density[18]
Fig. 8. Damage density comparison after AMP2 and AMP3 processing [50]
|
Table 1. LIDT improvement of fused silica under different etching conditions
|
Table 2. LIDT improvement of fused silica processed by composite technique
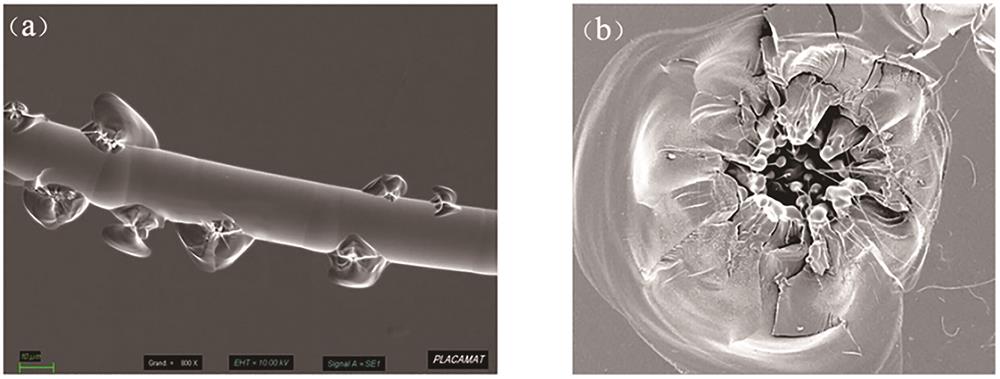
Set citation alerts for the article
Please enter your email address



