Jin Sui, Jiaxiang Chen, Haolan Qu, Yu Zhang, Xing Lu, Xinbo Zou. Emission and capture characteristics of deep hole trap in n-GaN by optical deep level transient spectroscopy[J]. Journal of Semiconductors, 2024, 45(3): 032503
Search by keywords or author
- Journal of Semiconductors
- Vol. 45, Issue 3, 032503 (2024)
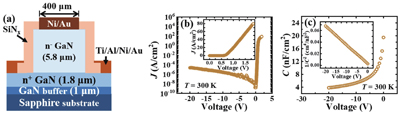
Fig. 1. (Colour online) (a) A cross-section diagram of a GaN quasi-vertical SBD under experimentation. (b) Forward and reverse J–V characteristics at 300 K presented by logarithmic scale. Inset: forward J–V characteristics at 300 K in linear scale. (c) C–V characteristics at 300 K. Inset: 1/C2–V curve at 300 K.

Fig. 2. (Colour online) (a) Energy band diagrams of hole trap in GaN for (1) capture and (2) emission process. (b) Inverted temperature-scanning ODLTS spectra. (c) Arrhenius plot for hole trap H1. (d) Apparent trap concentration profile versus depletion region width.
Fig. 3. (Colour online) (a) Isothermal ODLTS spectra for scanning TW with fixed UR of −6 V and tp of 1 s from 315 to 343 K. (b) τe derived by isothermal ODLTS at different temperatures. (c) Arrhenius plot of trap H1 extracted from temperature-dependent τe.
Fig. 4. (Colour online) (a) Electric-field-dependent τe of trap H1 extracted from capacitance transient spectra from 315 to 329 K. The ln(ep) of trap H1 as a function of (b) E2 and (c) E1/2 from 315 to 329 K. Black dotted lines are linear fitting curves.
Fig. 5. (Colour online) (a) Normalized capacitance transient amplitude as a function of tp. (b) Capacitance transient amplitude increases exponentially with tp. (c) τc from 315 to 343 K.
| ||||||||||||||||||||||||||||||||||||||||
Table 1. Comparison with other published comparable hole trap in n-GaN.
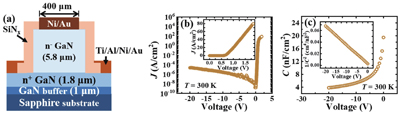
Set citation alerts for the article
Please enter your email address



