Chao Lu, Wei Chen, Yin-Hong Luo, Li-Li Ding, Xun Wang, Wen Zhao, Xiao-Qiang Guo, Sai Li. Effect of source-drain conduction in single-event transient on nanoscaled bulk fin field effect transistor [J]. Acta Physica Sinica, 2020, 69(8): 086101-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 8, 086101-1 (2020)
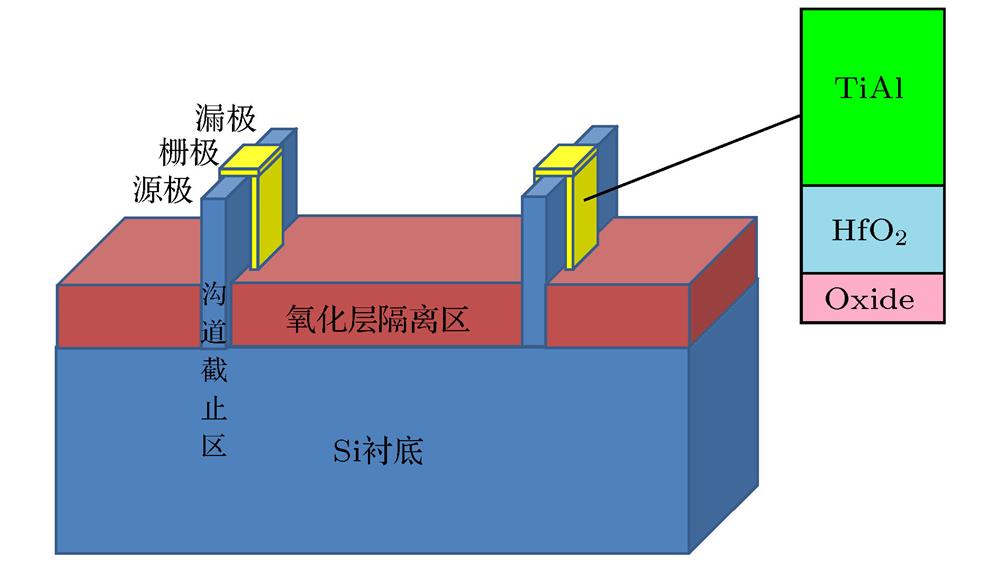
Fig. 1. The structure of two fin FinFET device.
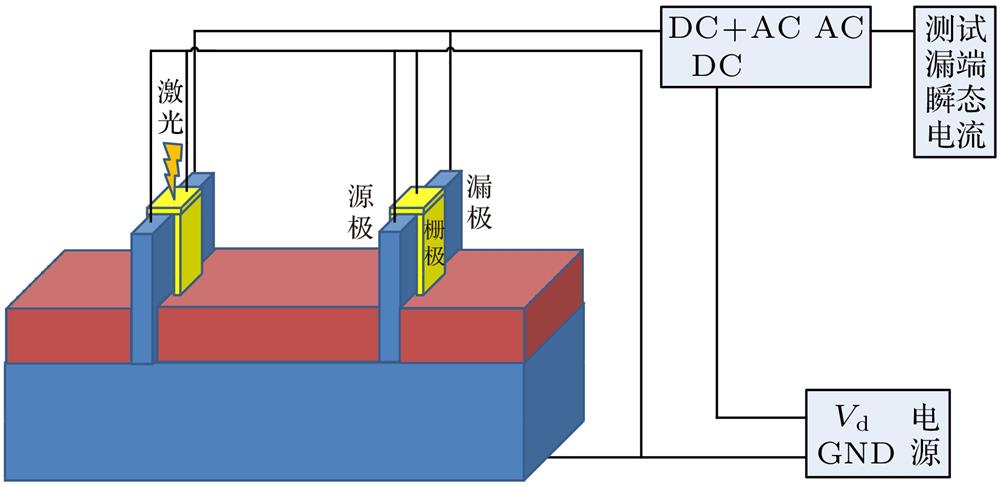
Fig. 2. The circuit schematic of experience.
Fig. 3. Drain current transients for 4 fin FinFET of different gate length during the 5 nJ laser testing.
Fig. 4. Drain charge collected for 4 fin FinFET of different gate length during the 5 nJ laser testing as a function of time.
Fig. 5. Drain current transients for 2 fin FinFET of different gate length during the 5 nJ laser testing.
Fig. 6. \begin{document}$ I_{\rm d}\text{-}V_{\rm g} $\end{document} ![]()
![]()
Fig. 7. Drain current transients for FinFET of different substrate thickness from TCAD simulation.
Fig. 8. Drain current transients for FinFET of different gate length from TCAD simulation.
Fig. 9. Charge generation radial distribution of heavy ion
Fig. 10. Temporary evolution of electronic density and electrostatic potential for a 30 nm FinFET.
Fig. 11. Electronic density for FinFET of different gate length at 1.5 ns.
Fig. 12. Drain current transient for 30 nm FinFET when heavy ion incident device with different radius.
Fig. 13. Drain current transient for a FinFET when heavy ion incident at drain and gate.
Set citation alerts for the article
Please enter your email address



