- Journal of Infrared and Millimeter Waves
- Vol. 41, Issue 2, 384 (2022)
Abstract
Introduction
InGaAs photodiodes are very promising and have been widely used in short wavelength infrared(SWIR)detection [
As an outstanding thin film deposition technology,ALD has broad prospects in semiconductor device fabrication [
In this paper,TEM and XPS measurements were performed to investigate the interface between two different dielectric films and In0.74Al0.26As layer. The two different dielectric films were ALD-Al2O3 and ICPCVD-SiNx respectively. In addition,MIS capacitors have been prepared by using above two dielectric films to further quantitatively study the interface state density between dielectric film and In0.74Al0.26As layer.
1 Experimental details
To investigate the interface state density of SiNx/In0.74Al0.26As and SiNx/Al2O3/ In0.74Al0.26As,two series of MIS capacitor were prepared. The SiNx or Al2O3 were deposited on the In0.74Al0.26As/In0.74Ga0.26As/InxAl1-xAs heterostructures that were grown on an InP substrate by gas source molecular beam epitaxy(MBE)[
TEM and XPS measurements were employed to investigate the interface between films and In0.74Al0.26As layer. The 20-nm-thick Al2O3 films were deposited on In0.74Al0.26As by 220 cycles of trimethylaluminum(TMA)and H2O at 150°C for the TEM and XPS measurements. For comparison purpose,about 20-nm-thick SiNx films were deposited on In0.74Al0.26As by ICPCVD of SiH4 and N2 at 75°C for the TEM and XPS measurements. Furthermore,bare In0.74Al0.26As wafer with native oxides was used as a control for XPS measurement. The insulator of sample A was deposited with 135-nm-thick SiNx film by ICPCVD. The insulator of sample B is ICPCVD-SiNx/ALD-Al2O3 bilayer,where 20-nm-thick Al2O3 was firstly deposited by ALD and 130-nm-thick SiNx was then deposited by ICPCVD.
![]()
Figure 1.(a)Sectional schematic diagram and(b)photography of MIS capacitor
2 Results and discussion
Pt was firstly deposited on the surface of In0.74Al0.26As wafer to protect the wafer from etching damage. Focused Ion Beam(FIB)was used to thin the sample,and then the thinned sample was subjected to TEM testing. The cross-section TEM images of ICPCVD-SiNx/In0.74Al0.26As and ALD-Al2O3/In0.74Al0.26As structure were shown in
![]()
Figure 2.The cross-sectional images(top)obtained by TEM and cross-sectional composition information(bottom)obtained by EDS of(a)ICPCVD-SiNx on In0.74Al0.26As and(b)ALD-Al2O3 on In0.74Al0.26As
In order to further study the interface state density between film and In0.74Al0.26As,XPS test combined with Ar+ sputtering(2 kV,20 μA)was utilized. XPS spectra were obtained with the Axis UltraDLD spectrometer(Kratos Analytical-A Shimadzu Group Company)with a monochromatic Al Kα source(hν=1486.6 eV)and a charge neutralization system. The spectra were taken when the vacuum of the analysis chamber was less than 5×10–9 Torr. The electron energy analyzer works in the hybrid magnification mode,and the take-off angle for the analyzer relative to sample surface is 90°. The X-ray source power was set to 105 W(15 kV,7 mA)for high-resolution spectra acquisition. The pass energy of 40 eV were utilized for narrow scan spectra. The energy step size of 0.1 eV were chosen for narrow scan spectra. The C 1s peak of environmental pollution carbon adsorbed on the sample surface is used as the reference peak for spectral energy correction to complete the peak position calibration:set the C 1s peak position of the pollution carbon to 284.8 eV. Calculate the relative percentage of elements through the peak area of the element peak and the sensitivity factor of the instrument.
In3d5/2 spectra obtained by XPS narrow scan was shown in
![]()
Figure 3.The 3d5/2 core level of In recorded from bare In0.74Al0.26As wafer,ICPCVD-SiNx/In0.74Al0.26As and ALD-Al2O3/In0.74Al0.26As(a)on the surface of bare In0.74Al0.26As,(b)in the bulk of In0.74Al0.26As,(c)on the surface of ICPCVD-SiNx,(d)in the bulk of ICPCVD-SiNx,(e)at the interface between ICPCVD-SiNx and In0.74Al0.26As,(f)on the surface of ALD-Al2O3,(g)in the bulk of ALD-Al2O3,and(h)at the interface between ALD-Al2O3 and In0.74Al0.26As
![]()
Figure 4.C-V curves of MIS capacitors measured at 210 K for different frequencies from 1 kHz to 1 MHz(a)SiNx/In0.74Al0.26As MIS capacitor,(b)SiNx/Al2O3 In0.74Al0.26As MIS capacitor
However,under the high frequency limit,the interface trapped charge can not keep up with the change of high frequency. Therefore,the capacitance of MIS capacitor(CHF)was equivalent to the series connection of semiconductor capacitance(Cs)and insulating layer capacitance(Ci). Thus,the CHF can be expressed as:
According to Eqs(1-2),the fast interface state density(Dit)can be expressed as(high-low frequency method)[
where A is the area of gate electrode.
In this paper,the CLF was the capacitance of MIS capacitor under 1 kHz,while the CHF was the capacitance of MIS capacitor under 1 MHz. The Dit values of sample A and B were 2.29×1013 cm-2eV-1 and 1.83×1012 cm-2eV-1 respectively,which were calculated by high-low frequency method. Apparently,the calculated Dit of sample B is an order of magnitude smaller than that of sample A. Thus,ALD-Al2O3 effectively reduces the Dit between Al2O3 and In0.74Al0.26As. This can be explained by the growth of Al2O3 deposited by ALD. Firstly,an aluminum source is introduced to effectively neutralize the dangling bonds on the surface of In0.74Al0.26As,and then a water source is introduced to form a bond with aluminum. Therefore,the interface state density(such as In2O3)between the dielectric film and In0.74Al0.26As is effectively reduced.
Combining the XPS test and the C-V measurement results of the MIS capacitors,it can be concluded that ALD-Al2O3 effectively reduces the fast interface state density between the film and the In0.74Al0.26As. Therefore,the lower 1/f noise and dark current density characteristics of In0.74Ga0.26As photodiodes passivated by SiNx/Al2O3 bilayer [
3 Conclusion
According to the study of the interface between dielectric film and In0.74Al0.26As,it is found that the interface between the ALD-Al2O3 and In0.74Al0.26As is sharper than that of ICPCVD-SiNx and In0.74Al0.26As. In addition,ALD-Al2O3 effectively reduces the In2O3 at the interface between ALD-Al2O3 and In0.74Al0.26As. Furthermore,the C-V results of the MIS capacitors also indicate that the ALD-Al2O3 effectively reduces the fast interface state density of the dielectric film and In0.74Al0.26As. In summary,using ALD-Al2O3 as the passivation film of the In0.74Ga0.26As photodiodes can theoretically reduce the dark current of the In0.74Ga0.26As photodiodes. Furthermore,the device verification results have confirmed this statement.
References
[4] O Sneh, R B Clark-Phelps, A R Londergan et al. Thin film atomic layer deposition equipment for semiconductor processing. Thin Solid Films, 402, 248-261(2002).
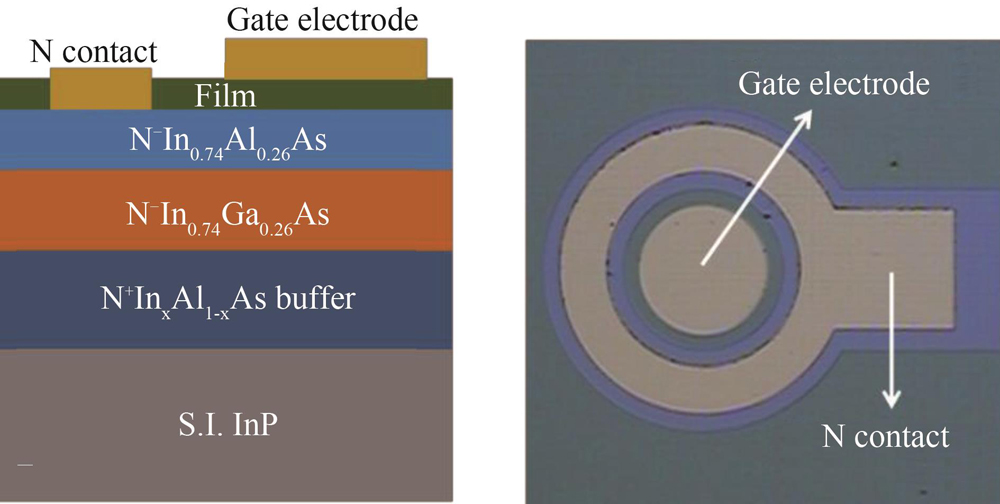
Set citation alerts for the article
Please enter your email address



