Yuqing Guan, Yunxia Fu, Wenzhe Zou, Zhangning Xie, Lihua Lei. A characterization method of thin film parameters based on adaptive differential evolution algorithm (Invited)[J]. Infrared and Laser Engineering, 2022, 51(1): 20210976
Search by keywords or author
- Infrared and Laser Engineering
- Vol. 51, Issue 1, 20210976 (2022)
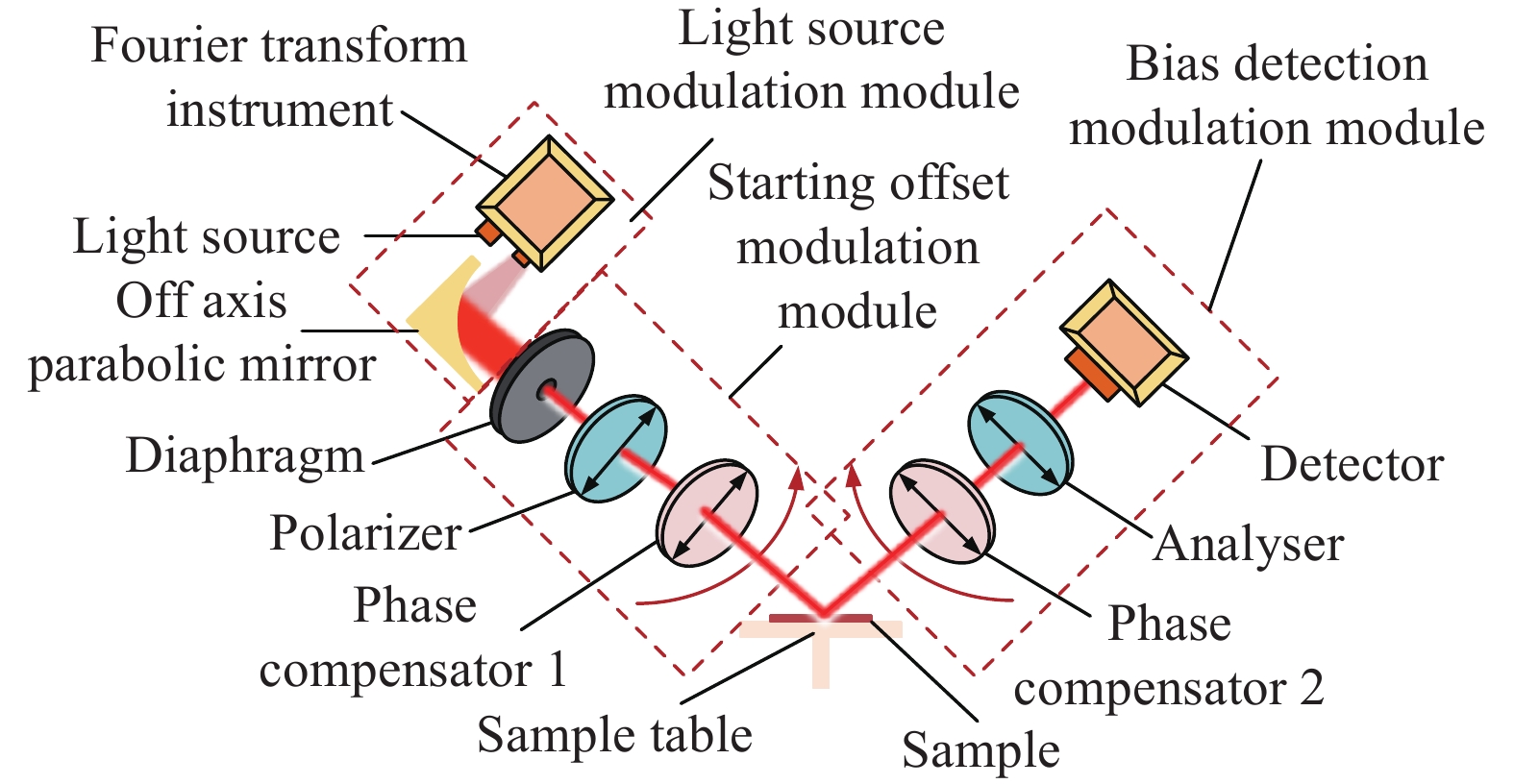
Fig. 1. Optical path diagram of system construction

Fig. 2. Flow chart of adaptive differential evolution algorithm
Fig. 3. Iterative curve of 104.2 nm SiO2/Si standard sample
Fig. 4. Iterative curve of 398.4 nm SiO2/Si standard sample
Fig. 5. Mueller spectrum of 104.2 nm SiO2/Si film thick sample
Fig. 6. Mueller spectrum of 398.4 nm SiO2/Si film thick sample
Fig. 7. Index of refractive and extinction coefficient of 104.2 nm standard sample
Fig. 8. Index of refractive and extinction coefficient of 398.4 nm standard sample
Fig. 9. Iterative curve of 104.2 nm SiO2/Si standard sample
Fig. 10. Iterative curve of 398.4 nm SiO2/Si standard sample
Fig. 11. Measurement of ellipsometry parameters of 104.2 nm SiO2/Si standard sample
Fig. 12. Measurement of ellipsometry parameters of 398.4 nm SiO2/Si standard sample
|
Table 1. System component parameter values
|
Table 2. MSE of 104.2 nm sample
|
Table 3. MSE of 398.4 nm sample
|
Table 4. Calculated value of sample thickness
| |||||||||||||||||||||||||||||||||
Table 5. Comparison of experimental results
|
Table 6. Calculated value of sample thickness
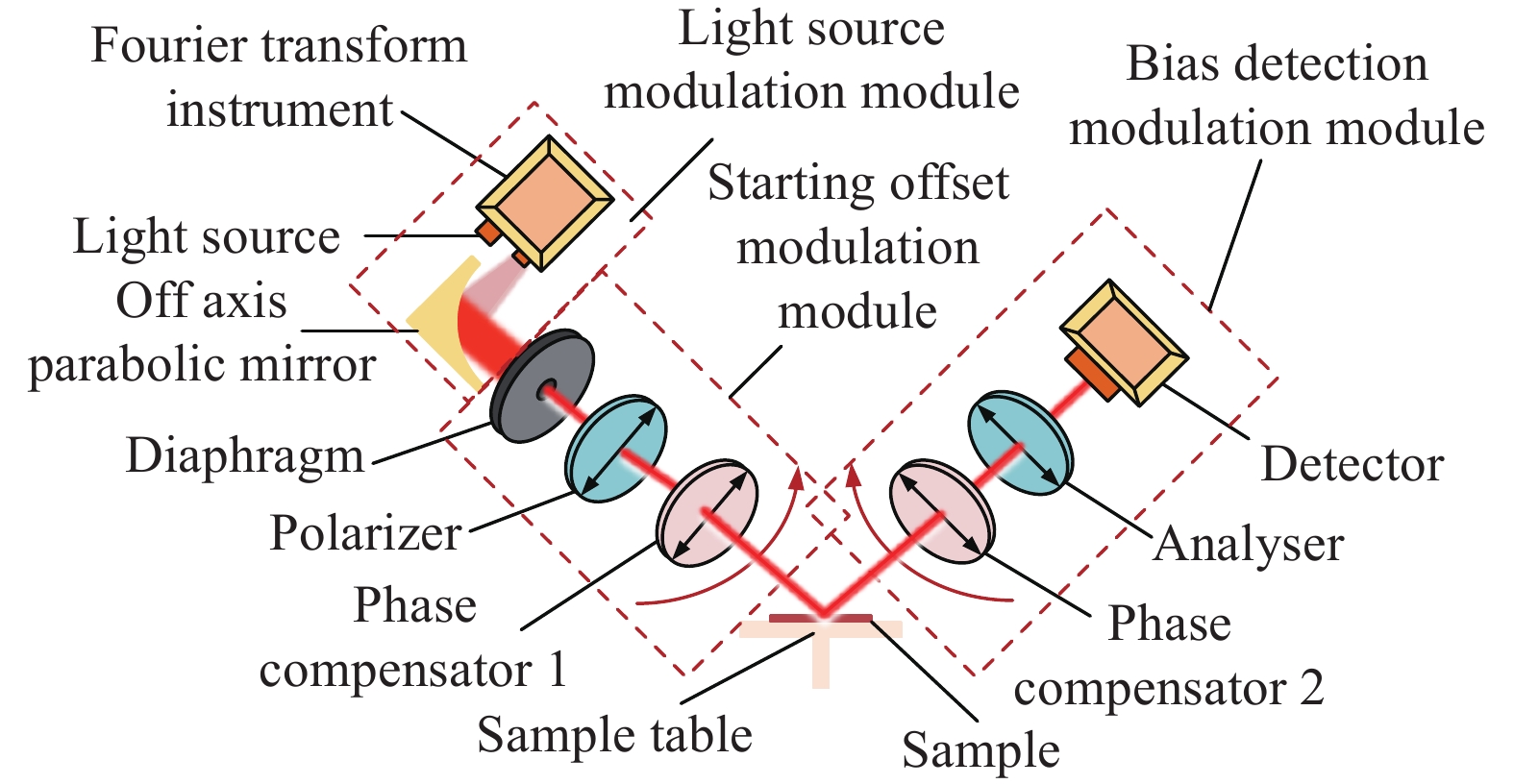
Set citation alerts for the article
Please enter your email address



