Wen-Jing Zhao, Meng-Guang Ding, Xiao-Li Yang, Hai-Yun Hu. Nonequilibrium statistical theoretical analysis method of TDDB of gate oxide [J]. Acta Physica Sinica, 2020, 69(10): 100502-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 10, 100502-1 (2020)
![The most probable lifetime of gate oxide with different thickness: (a) Sample 1[21] at ; (b) sample 2[22] at](/richHtml/wlxb/2020/69/10/20200108/img_1.jpg)
Fig. 1. The most probable lifetime of gate oxide with different thickness: (a) Sample 1[21] at
 ; (b) sample 2[22] at
; (b) sample 2[22] at

 ; (b) sample 2[22] at
; (b) sample 2[22] at

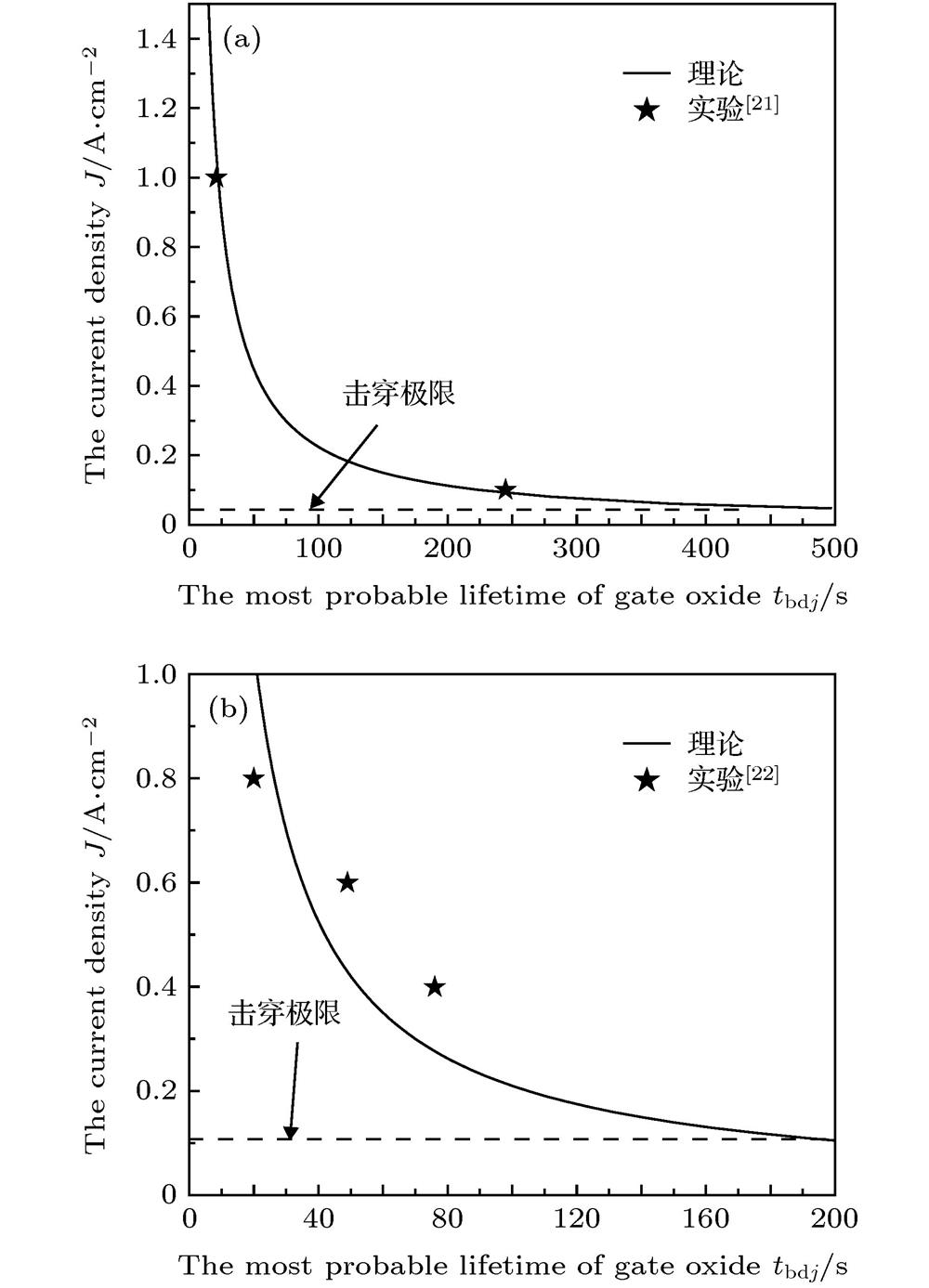
Fig. 2. The most probable lifetime of gate oxide under different electric current density: (a) Sample 1; (b) sample 2
Fig. 3. The probability density varies with electron trap density at different time: (a) Sample 1 at
 ; (b) sample 2 at
; (b) sample 2 at

 ; (b) sample 2 at
; (b) sample 2 at

Fig. 4. The probability density varies with electron trap density under different electric current density(
 ): (a) Sample 1; (b) sample 2.
): (a) Sample 1; (b) sample 2.
 ): (a) Sample 1; (b) sample 2.
): (a) Sample 1; (b) sample 2. Fig. 5. Breakdown cumulative distributions for two different electric current densities in sample 1: (a) J =
 ; (b)
; (b)

 ; (b)
; (b)

Fig. 6. Breakdown cumulative distributions for three electric current densities in sample 2. (Note: solid five-pointed star represents experimental value and line segment represents theoretical value.)
Fig. 7. The most probable lifetime of gate oxide with different thickness.
Fig. 8. The most probable lifetime of gate oxide under different electric field.
Fig. 9. The probability density varies with electron trap density at different time under
 .
.
 .
. Fig. 10. The probability density varies with electron trap density at
 under the different electric field.
under the different electric field.
 under the different electric field.
under the different electric field. Fig. 11. Breakdown cumulative distributions for three different electric field.
Set citation alerts for the article
Please enter your email address



