Zhan-Gang Zhang, Bing Ye, Qing-Gang Ji, Jin-Long Guo, Kai Xi, Zhi-Feng Lei, Yun Huang, Chao Peng, Yu-Juan He, Jie Liu, Guang-Hua Du. Mechanisms of alpha particle induced soft errors in nanoscale static random access memories [J]. Acta Physica Sinica, 2020, 69(13): 136103-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 13, 136103-1 (2020)
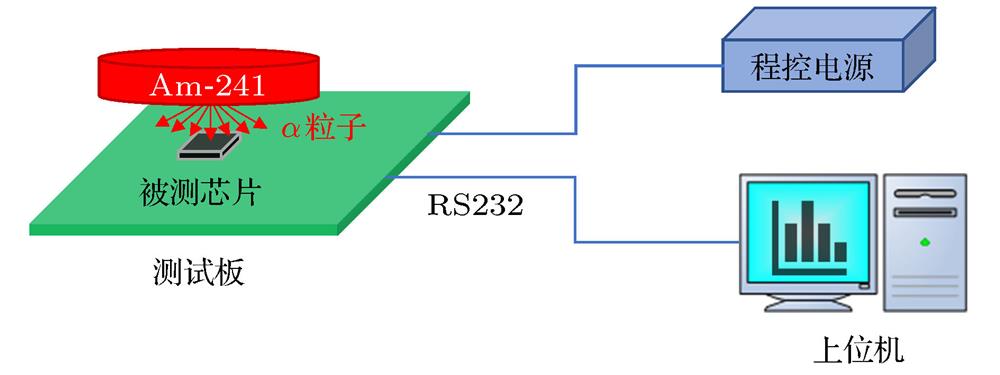
Fig. 1. Schematic diagram of the test setup.

Fig. 2. α particle distribution on the silicon surface of the 65 nm SRAM.
Fig. 3. α particle distribution on the silicon surface of the 90 nm SRAM.
Fig. 4. Impact of initial data pattern on SEU cross section.
Fig. 5. Reverse analysis results of the 65 nm SRAM: (a) Cross section; (b) memory area image.
Fig. 6. TRIM simulation results: (a) The propagation trajectory of alpha particles in the device; (b) the alpha particle trajectory from the cross-sectional view of the device (the initial incident position of the particle is at the zero center).
Fig. 7. 3 D simulation model of the 65 nm device.
Fig. 8. Deposited energy spectra in sensitive regions of devices at different incident angles.
Fig. 9. Relationship between LET value and energy of α particle in silicon material.
Fig. 10. Relationship between single event upset cross section and critical energy at different incident angles.
Fig. 11. Single event upset cross section at different incident angles.
|
Table 1.
Parameters of the radioactive source being used.
使用的放射源参数
|
Table 2.
Parameters of the devices under test.
被测器件参数
|
Table 3.
Test results of SEU cross section.
SEU截面测试结果
|
Table 4.
The α particle emissivity level and corresponding soft error rate.
α粒子发射率等级及对应的软错误率
|
Table 5.
Soft error rates of the 65 nm SRAM at the experimental site with an altitude of 4300 m and sea level of Beijing city being used. The contribution rates of α particle, high energy neutron and thermal neutron are analyzed, respectively.
65 nm SRAM在4300 m海拔试验地点及北京海平面使用时的软错误率及α粒子、高能中子和热中子贡献占比
|
Table 6. [in Chinese]
Set citation alerts for the article
Please enter your email address



