- Chinese Optics Letters
- Vol. 21, Issue 3, 032502 (2023)
Abstract
1. Introduction
Due to the high-quality and chemically stable material, wide bandgap semiconductor avalanche photodiodes (APDs) based on silicon carbide (SiC) have advantages of being photosensitive, visible-blind, reliable, small, and easily integrated, which makes them powerful competitors for ultraviolet (UV) detectors in plenty of applications, such as corona detection, astronomical research, UV communication, and missile plume detection[1–5]. In the past few years, with the improvement of crystal material growth and device fabrication technology, 4H-SiC APDs have achieved great advancements with high gain, high quantum efficiency (QE), low dark current, and even excellent Geiger-mode single-photon-detection performance[6–13]. Related arrays based on 4H-SiC APDs have also been demonstrated for UV imaging in the future[14–18]. However, most of the reported research work has been focused on 4H-SiC APDs at low temperatures. For such critical applications as flame detetion in gas turbines and UV detection for space exploration, high-stability UV detectors at high temperatures are in great demand. The temperature-dependent performance of 4H-SiC APD-based UV detectors has been analyzed by few research groups in the world[19–21]. The stability and reliability of 4H-SiC APDs with harsh stress conditions have not yet been reported.
In this Letter, high-stability 4H-SiC APDs at high temperatures are fabricated and investigated for UV detections. Based on the variable-temperature
2. Device Design and Fabrication
First, the device structure of 4H-SiC APDs is carefully designed, which determines the performance under dark current, avalanche breakdown voltage, QE, etc. As shown in Fig. 1(a), a separate absorption charge multiplication (SACM) epilayer structure is used for our 4H-SiC APDs in this work. From bottom to top, the wafer is composed of a
Sign up for Chinese Optics Letters TOC. Get the latest issue of Chinese Optics Letters delivered right to you!Sign up now
![]()
Figure 1.Device structure of 4H-SiC APDs. (a) Schematic cross-sectional structure; (b) doping concentration profile of epilayers obtained by SIMS.
Device fabrication was based on an optimized manufacturing process, and the detailed fabrication process can be referred to in Ref. [22]. For isolation and passivation, a
3. Results and Discussion
The room-temperature performance of 4H-SiC APDs was first investigated. As shown in Fig. 2(a), the dark current and photocurrent at
![]()
Figure 2.Characteristics of 4H-SiC APDs at room temperature. (a) I-V and I-M curves; (b) spectral responsivity. Here, the photo image of the fabricated 4H-SiC APD is shown in the inset of Fig. 2(a).
In order to investigate the high-temperature device performances, the
| Parameters | Ref. [ | Ref. [ | This Work |
|---|---|---|---|
| Vb (V) | 634 | 186 | 163 |
| Idark | |||
| Gain | 2500 | ||
| Maximum QE (%) | 45%@290 nm | 53%@290 nm | 54%@285 nm |
| CT of Vb (mV/°C) | 110 | 14 | 7.4 |
Table 1. Comparison of Different 4H-SiC APDs
![]()
Figure 3.Performance of 4H-SiC APDs at different temperatures. (a) Dark currents near the breakdown voltage; (b) breakdown voltage shift as a function of temperature.
In addition, the high-temperature stability of our 4H-SiC APDs was verified with a high junction temperature, as shown in Fig. 4. The two-dimensional mapping of junction temperature was obtained for our fabricated 4H-SiC APDs based on an infrared microscope, during which the device was stressed with large power consumption and high temperatures. Figures 4(a) and 4(b) provide the junction temperature mapping of 4H-SiC APD with different maximum junction temperature of 145°C and 270°C, respectively. It should be noted that the distribution of junction temperature is nonuniform for 4H-SiC APDs, which can be explained by the asymmetric carrier lateral drift in the off-orientated 4H-SiC[7,22–25]. The results demonstrate that the fabricated 4H-SiC APD can bear a junction temperature of
![]()
Figure 4.Two-dimensional mapping of the junction temperature for 4H-SiC APDs with different maximum junction temperatures. (a) 145°C; (b) 270°C.
Finally, for the first time, an accelerated aging test with harsh stress conditions was performed to further confirm the stability of 4H-SiC APDs in this work. Three different stress conditions are selected with the temperatures and reverse currents of 175°C/100 µA, 200°C/100 µA, and 200°C/500 µA, respectively. The stress condition for 4H-SiC APDs in this work is much harsher than that of the aging test for InGaAs APDs in Ref. [26]. Device failure is defined as a state in which the dark current at a bias of 0.5 V over the avalanche breakdown voltage increases more than 0.01 µA compared with the initial value. A pre-aging test of 24 h at the stress condition of 175°C/100 µA was done to check the bonding of the device sample, and the first 24 h of pre-aging did not result in changes in the dark-current characteristics.
After the pre-aging, a long-time aging test was conducted. The dark-current variation of 4H-SiC APD as a function of accelerated aging time with different stress conditions is shown in Fig. 5. The dark current was measured at room temperature with a reverse bias voltage, where a gain of
![]()
Figure 5.Dark current of 4H-SiC APD as a function of aging time with different stress conditions. (a) 175°C/100 µA; (b) 200°C/100 µA; (c) 200°C/500 µA.
4. Conclusion
In conclusion, high-stability 4H-SiC APDs are fabricated and investigated for UV detection at high temperatures. The high-temperature stability of our 4H-SiC APDs was verified based on the variable temperature
References
[1] T. Liu, P. Wang, H. Zhang. Performance analysis of non-line-of-sight ultraviolet communication through turbulence channel. Chin. Opt. Lett., 13, S21501(2015).
[2] X. Guo, L. B. Rowland, G. T. Dunne, J. A. Fronheiser, P. M. Sandvik, A. L. Beck, J. C. Campbell. Demonstration of ultraviolet separate absorption and multiplication 4H-SiC avalanche photodiodes. IEEE Photon. Technol. Lett., 18, 1910(2006).
[3] H.-D. Liu, D. McIntosh, X. Bai, H. Pan, M. Liu, J. C. Campbell, H. Y. Cha. 4H-SiC PIN recessed-window avalanche photodiode with high quantum efficiency. IEEE Photon. Technol. Lett., 20, 1551(2008).
[4] H.-D. Liu, X. Zheng, Q. Zhou, X. Bai, D. C. McIntosh, J. C. Campbell. Double mesa sidewall silicon carbide avalanche photodiode. IEEE J. Quantum Electron., 45, 1524(2009).
[5] Q. Zhou, D. McIntosh, H.-D. Liu, J. C. Campbell. Proton-implantation-isolated separate absorption charge and multiplication 4H-SiC avalanche photodiodes. IEEE Photon. Technol. Lett., 23, 299(2011).
[6] A. Vert, S. Soloviev, J. Fronheiser, P. Sandvik. Solar-blind 4H-SiC single-photon avalanche diode operating in Geiger mode. IEEE Photon. Technol. Lett., 20, 1587(2008).
[7] X. Cai, D. Zhou, S. Yang, H. Lu, D. Chen, F. Ren, R. Zhang, Y. Zheng. 4H-SiC SACM avalanche photodiode with low breakdown voltage and high UV detection efficiency. IEEE Photon. J., 8, 6805107(2016).
[8] X. Zhou, T. Han, Y. Lv, J. Li, W. Lu, Y. Wang, X. Tan, S. Liang, Z. Feng, S. Cai. Large-area 4H-SiC ultraviolet avalanche photodiodes based on variable-temperature reflow technique. IEEE Electron Device Lett., 39, 1724(2018).
[9] X. Zhou, X. Tan, Y. Wang, X. Song, T. Han, J. Li, W. Lu, G. Gu, S. Liang, Y. Lv, Z. Feng. Large-area 4H-SiC avalanche photodiodes with high gain and low dark current for visible-blind ultraviolet detection. Chin. Opt. Lett., 17, 090401(2019).
[10] X. Bai, H.-D. Liu, D. C. McIntosh, J. C. Campbell. High-detectivity and high-single-photon-detection-efficiency 4H-SiC avalanche photodiodes. IEEE J. Quantum Electron., 45, 300(2009).
[11] J. Hu, X. Xin, X. Li, J. H. Zhao, B. L. VanMil, K.-K. Lew, R. L. Myers-Ward, C. R. Eddy, D. K. Gaskill. 4H-SiC visible-blind single-photon avalanche diode for ultraviolet detection at 280 and 350 nm. IEEE Trans. Electron Devices, 55, 1977(2008).
[12] X. Xin, F. Yan, X. Sun, P. Alexandrove, C. M. Stahle, J. Hu, M. Matsumura, X. Li, M. Weiner, H. J. Zhao. Demonstration of 4H-SiC UV single photon counting avalanche photodiode. Electron. Lett., 41, 212(2005).
[13] X. Zhou, X. Tan, Y. Lv, Y. Wang, J. Li, X. Song, S. Liang, Z. Feng, S. Cai. Single-photon-counting performance of 4H-SiC avalanche photodiodes with a wide-range incident flux. IEEE Photon. Technol. Lett., 32, 847(2020).
[14] A. Vert, S. Soloviev, A. Bolotnikov, P. Sandvik. Silicon carbide photomultipliers and avalanche photodiode arrays for ultraviolet and solar-blind light detection. IEEE Sensors Conference(2009).
[15] F. Yan, C. Qin, J. H. Zhao, M. Bush, G. Olsen, B. K. Ng, J. P. R. David, R. C. Tozer, M. Weiner. Demonstration of 4H-SiC avalanche photodiodes linear array. Solid-State Electron., 47, 241(2003).
[16] L. Li, D. Zhou, H. Lu, W. Liu, X. Mo, F. Ren, D. Chen, R. Wang, G. Li, R. Zhang, Y. Zheng. 4H-SiC avalanche photodiode linear array operating in Geiger mode. IEEE Photon. J., 9, 6804207(2017).
[17] X. Zhou, X. Tan, Y. Lv, Y. Wang, J. Li, T. Han, H. Guo, S. Liang, Z.-H. Zhang, Z. Feng, S. Cai. 8 × 8 4H-SiC ultraviolet avalanche photodiode arrays with high uniformity. IEEE Electron Device Lett., 40, 1589(2019).
[18] X. Zhou, X. Tan, Y. Lv, Y. Wang, J. Li, S. Liang, Z.-H. Zhang, Z. Feng, S. Cai. 128-pixel arrays of 4H-SiC UV APD with dual-frequency PECVD SiNx passivation. Opt. Express, 28, 29245(2020).
[19] H.-Y. Cha, S. Soloviev, S. Zelakiewicz, P. Waldrab, P. M. Sandvik. Temperature dependent characteristics of nonreach-through 4H-SiC separate absorption and multiplication APDs for UV detection. Sens. J., 8, 233(2008).
[20] D. Zhou, F. Liu, H. Lu, D. Chen, F. Ren, R. Zhang, Y. Zheng. High-temperature single photon detection performance of 4H-SiC avalanche photodiodes. IEEE Photon. Technol. Lett., 26, 1136(2014).
[21] S. Yang, D. Zhou, X. Cai, W. Xu, H. Lu, D. Chen, F. Ren, R. Zhang, Y. Zheng, R. Wang. Analysis of dark count mechanisms of 4H-SiC ultraviolet avalanche photodiodes working in Geiger mode. IEEE Trans. Electron Devices, 64, 4532(2017).
[22] R. Raghunathan, B. J. Baliga. Temperature dependence of hole impact ionization coefficients in 4H and 6H-SiC. Solid-State Electron., 43, 199(1999).
[23] A. Konstantinov, T. Neyer. Pattern of near-uniform avalanche breakdown in off-oriented 4H SiC. IEEE Trans. Electron Devices, 61, 4153(2014).
[24] K. Mochizuki, N. Kameshiro, H. Matsushima, H. Okino, R. Yamada. Uniform luminescence at breakdown in 4H-SiC 4°-off (0001) p–n diodes terminated with an asymmetrically spaced floating-field ring. IEEE J. Electron Devices Soc., 3, 349(2015).
[25] L. Su, X. Cai, H. Lu, D. Zhou, W. Xu, D. Chen, F. Ren, R. Zhang, Y. Zheng, G. Li. Spatial non-uniform hot carrier luminescence from 4H-SiC p-i-n avalanche photodiodes. IEEE Photon. Technol. Lett., 31, 447(2019).
[26] I. Watanabe, M. Tsuji, M. Hayashi, K. Makita, K. Taguchi. Reliability of mesa-structure InAlGaAs-InAlAs superlattice avalanche photodiodes. IEEE Photon. Technol. Lett., 8, 824(1996).
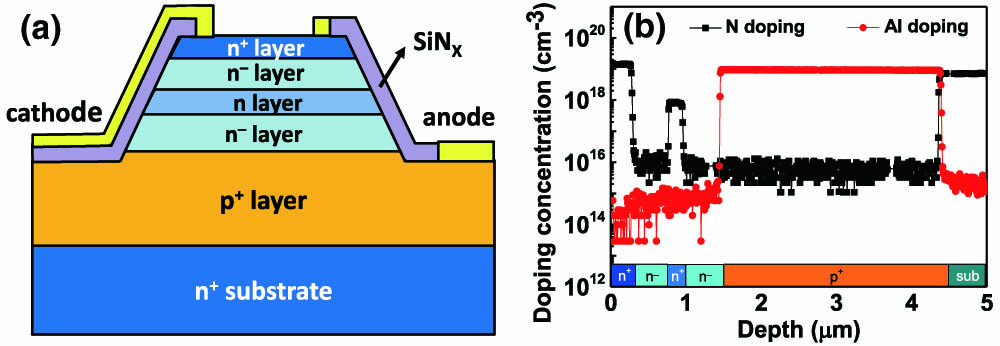
Set citation alerts for the article
Please enter your email address



