Juyou Du, Fengzhao Dai, Xiangzhao Wang. Calibration Method for Alignment Error Caused by Asymmetric Deformation of Mark and Its Application in Overlay Measurement[J]. Chinese Journal of Lasers, 2019, 46(7): 0704004
Search by keywords or author
- Chinese Journal of Lasers
- Vol. 46, Issue 7, 0704004 (2019)

Fig. 1. Principle diagram of SMASH alignment technique
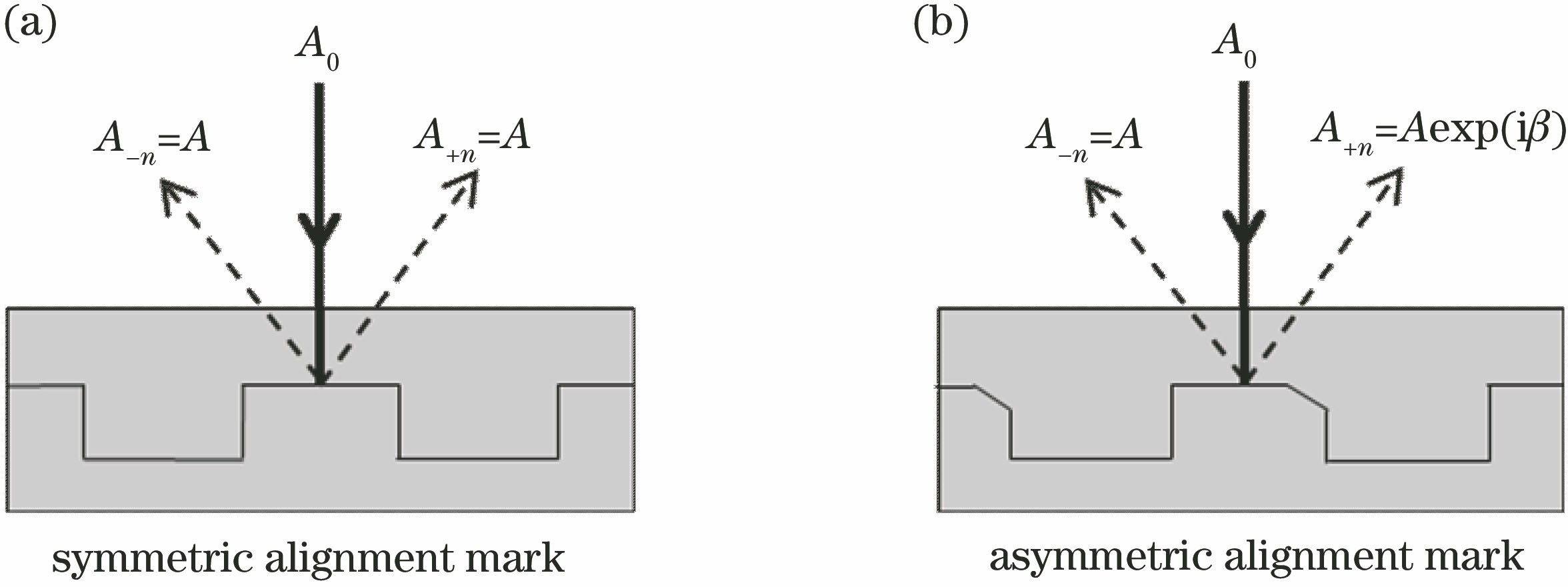
Fig. 2. Beam diffraction diagrams of different alignment marks. (a) Symmetric alignment mark; (b) asymmetric alignment mark
Fig. 3. Simulation model of alignment mark
Fig. 4. Asymmetric alignment marks with different shapes. (a) Round shape; (b) wedge shape
Fig. 5. Alignment measurement errors as functions of deformations of different asymmetric alignment marks under illuminations with different wavelengths and polarizations. (a) Round shape; (b) wedge shape
Fig. 6. Simulation results. (a) Ra-Rb as a function of Rb; (b) Wa-Wb as a function of Wb
Fig. 7. Alignment measurement errors caused by asymmetric alignment marks with different shapes after calibration. (a) Round shape; (b) wedge shape
Fig. 8. Principle diagrams of overlay precision measurement based on DBO technique. (a) eoverlay<0; (b) eoverlay=0; (c) eoverlay>0
Fig. 9. Overlay measurement error caused by asymmetric deformation of overlay mark
Fig. 10. Simulation model of overlay mark
Fig. 11. Overlay measurement error as a function of deformation of different asymmetric overlay marks under illuminations with different wavelengths and polarizations. (a) Round shape; (b) wedge shape
Fig. 12. Overlay measurement error as a function of alignment measurement error caused by different asymmetric deformations. (a) Round shape; (b) wedge shape
Fig. 13. Simulation results of overlay measurement errors caused by asymmetric overlay marks with different shapes after calibration. (a) Round shape; (b) wedge shape
| |||||||||||||||||||
Table 1. Refractive indexes with alignment mark materials under different wavelengths
| ||||||||||||||||||||||||
Table 2. Refractive indexes of overlay mark materials under different wavelengths

Set citation alerts for the article
Please enter your email address



