Cheng-Hao Gao, Feng Xu, Li Zhang, De-Sheng Zhao, Xing Wei, Ling-Juan Che, Yong-Zhang Zhuang, Bao-Shun Zhang, Jing Zhang. Ion implantation isolation based micro-light-emitting diode device array properties [J]. Acta Physica Sinica, 2020, 69(2): 027802-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 2, 027802-1 (2020)
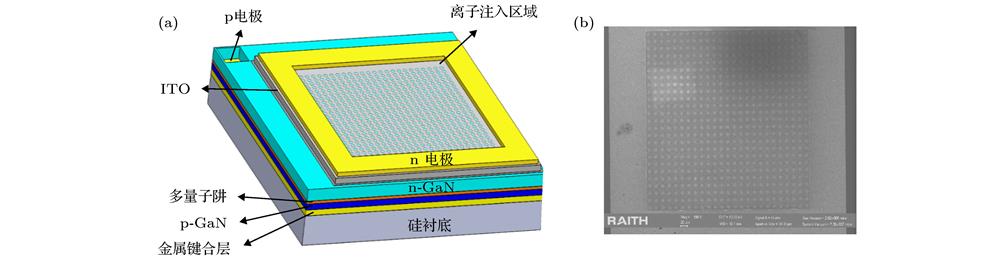
Fig. 1. (a) Schematic structure of micro-LED array; (b) SEM image of 10 μm micro-LED array surface.(a) micro-LED阵列结构图; (b) 10 μm micro-LED阵列表面SEM图像
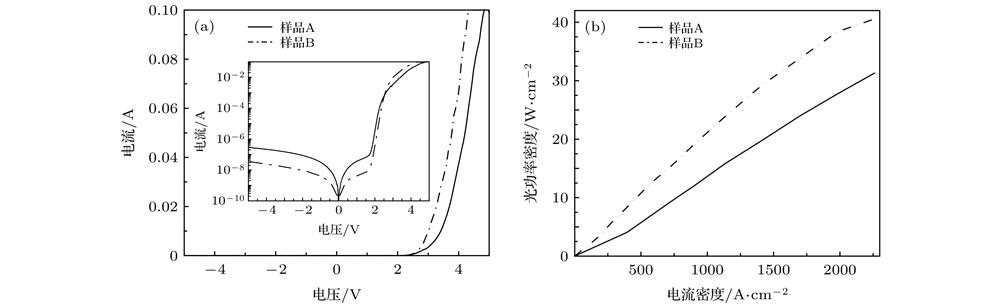
Fig. 2. (a) The I-V and (b) light output power density-current density characteristics of 6 μm arrays of samples A and B
样品A和B 6 μm阵列的(a) I-V 特性和(b)光输出密度-电流密度特性
Fig. 3. Comparison of (a) reverse leakage current and (b) light output density between implanted isolated micro-LED devices and mesa etching devices.注入隔离micro-LED器件与台面刻蚀器件 (a)反向漏电流和(b)光输出密度比较
Fig. 4. The relationship between damage and implantation depth of F ion with different implantation energies with SRIM simulation.SRIM模拟F离子不同注入能量下产生的损伤与注入深度关系
Fig. 5. Schematic of CTLM test.CTLM测量原理图
Fig. 6. The CTLM linear fitting curve at (a) the implantation energy of 50 keV and (b) 50/100 keV.CTLM线性拟合曲线 (a) 50 keV能量注入; (b) 50/100 keV能量注入
Fig. 7. I-V characteristics of the different emission aperture arrays.
不同发光孔径阵列I-V 特性曲线
Fig. 8. Light-emitting aperture arrays of (a) 6 μm, (b) 8 μm, and (c)10 μm at 20 mA.20 mA下 (a) 6 μm, (b) 8 μm, (c) 10 μm发光孔径阵列发光图像
|
Table 1.
The photoelectric properties of 6 μm micro-LED array.
6 μm micro-LED阵列光电性能参数
| ||||||||||||||||||||||||||||||||||||
Table 2.
The actual emission condition of single light-emitting aperture in sample B.
样品B单颗发光孔径实际发光情况
Set citation alerts for the article
Please enter your email address



