Jian WANG, Jun-qi XU, Jun-hong SU, Yang LI, Yun-yun SHI. Research on Infrared Anti-reflection Thin Film Devices with Compatibility of Electromagnetic Shielding[J]. Acta Photonica Sinica, 2020, 49(10): 1031002
Search by keywords or author
- Acta Photonica Sinica
- Vol. 49, Issue 10, 1031002 (2020)
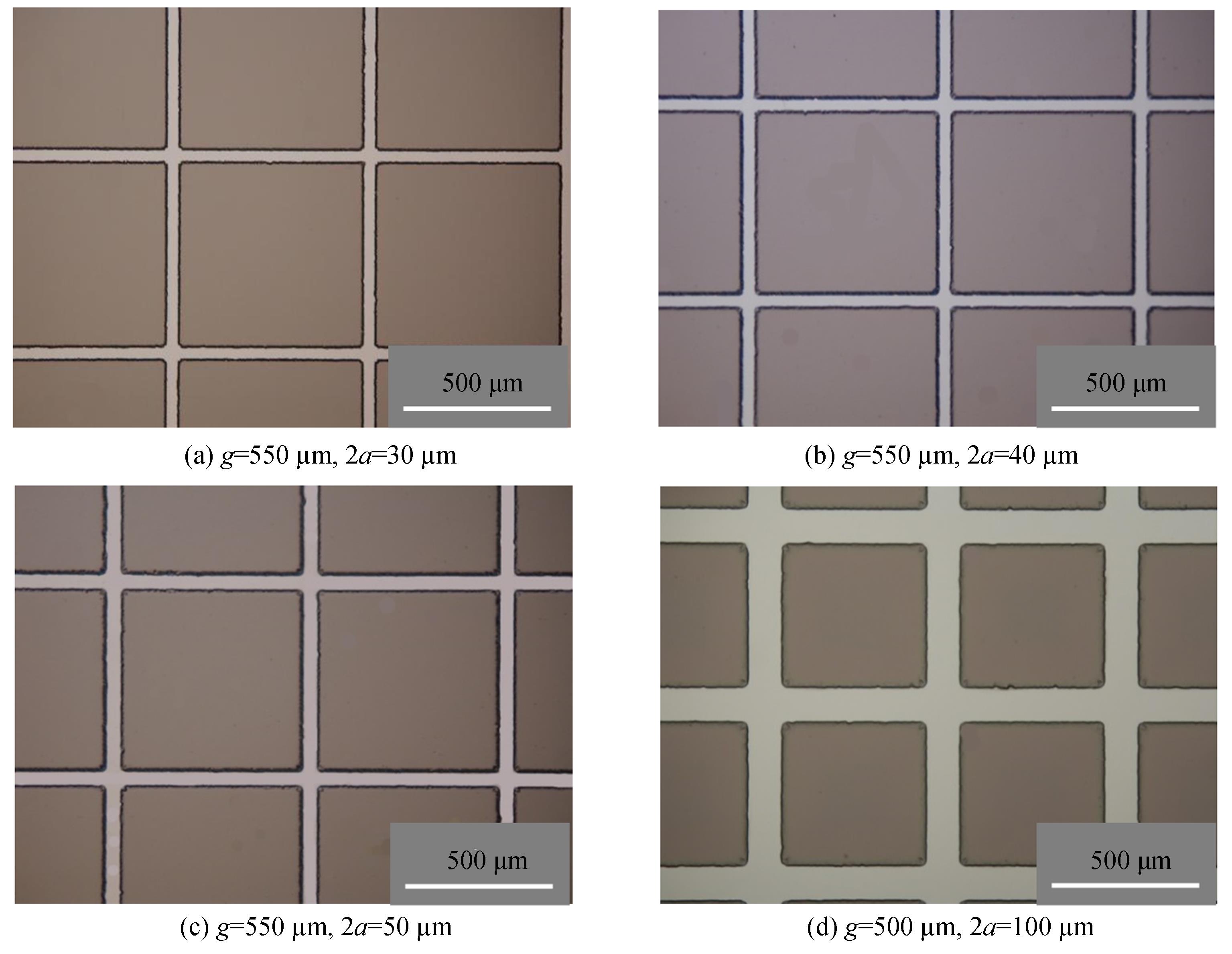
Fig. 1. Microstructure of grid under 100× optical microscopy
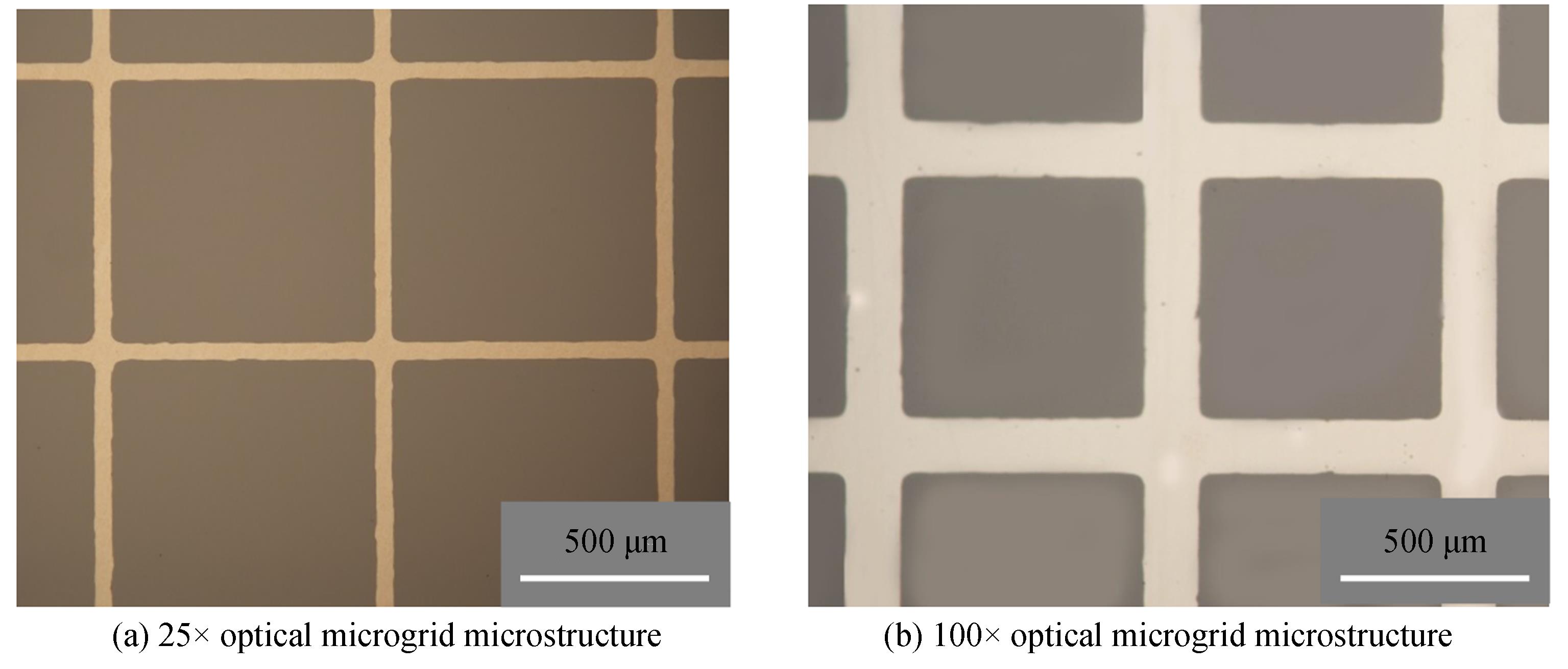
Fig. 2. Microstructure of metal grid film
Fig. 3. Matrix method for solving multilayer films
Fig. 4. Simulation curve of infrared antireflection coating in 3~5 μm band
Fig. 5. Transmittance-shielding efficiency test curve of metal grid
Fig. 6. The measured curve of infrared antireflection coating in the 3~5 µm band
Fig. 7. Structure diagram of thin film device compatible with electromagnetic shielding infrared window
Fig. 8. Transmittance-electromagnetic shielding effectiveness of thin film device
|
Table 1. Photolithography process parameters of the grid
|
Table 2. Shows the metal film preparation process
|
Table 3. Thin film preparation process parameters
|
Table 4. Comparison of transmittance before and after the infrared antireflective coating on the metal grid
|
Table 5. Electromagnetic shielding effectiveness of electromagnetic shielding infrared window film devices
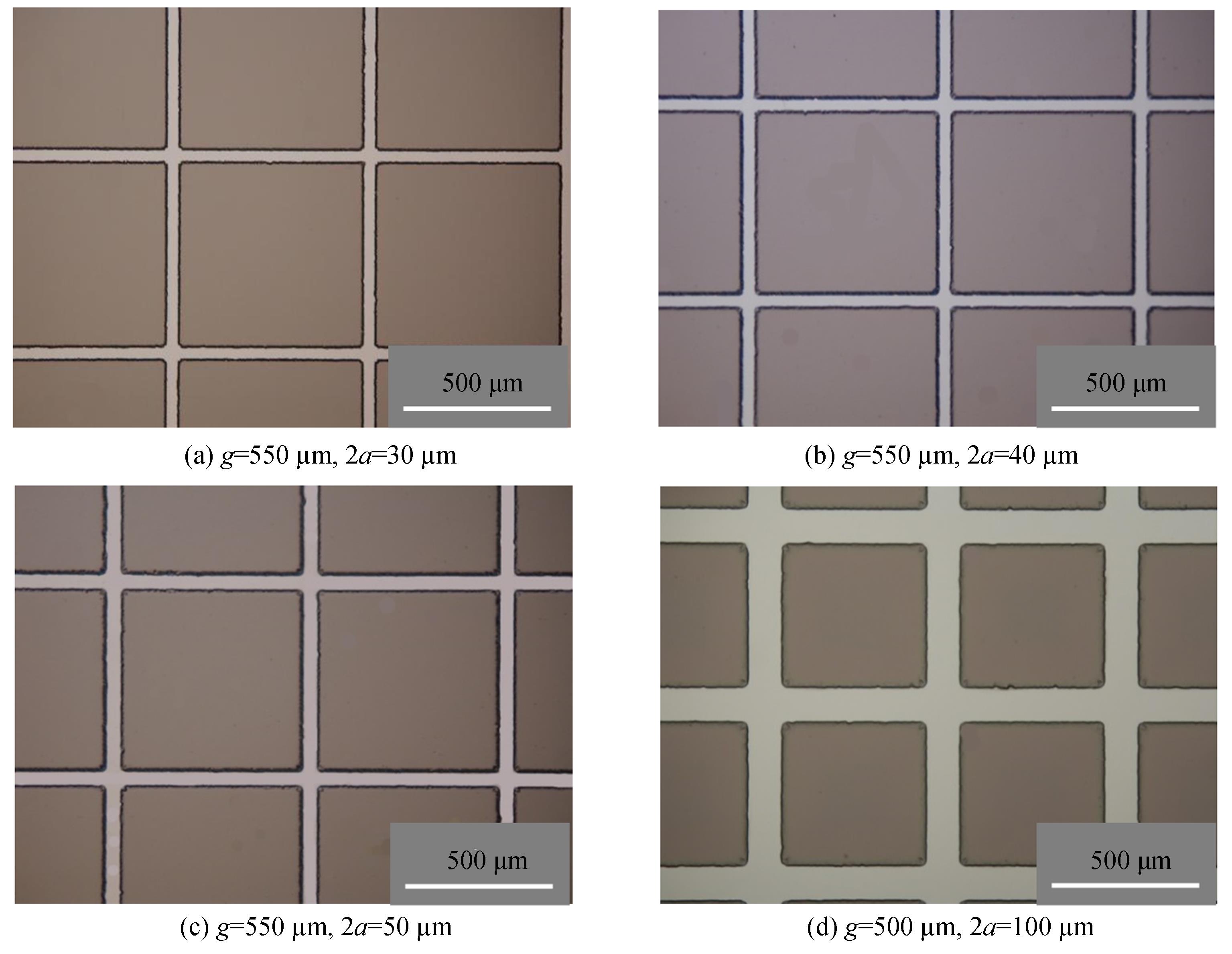
Set citation alerts for the article
Please enter your email address



