Xiangyue Liu, Zhe Zhang, Li Jiang, Hongxuan Song, Dianxiang Yao, Siyi Huang, Wenjie Xu, Tonglin Huo, Hongjun Zhou, Runze Qi, Qiushi Huang, Zhong Zhang, Zhanshan Wang. Thickness Control and Thermal Stability of Large‐Diameter Mo/Si Multilayer Films for Extreme Ultraviolet Source[J]. Chinese Journal of Lasers, 2024, 51(7): 0701014
Search by keywords or author
- Chinese Journal of Lasers
- Vol. 51, Issue 7, 0701014 (2024)
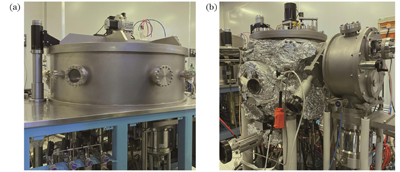
Fig. 1. Experimental equipments. (a) Sputtering equipment; (b) annealing equipment

Fig. 2. Schematic of substituted substrate
Fig. 3. Schematic of geometric relationship between substrate and shadow mask
Fig. 4. XRR measurement results of multilayer films at different positions on substituted substrate after film thickness correction using shadow mask
Fig. 5. AFM images of samples at different positions on curved substrate with 300 mm diameter. (a) X = 32.5 mm (sample 1); (b) X = 72.5 mm (sample 5); (c) X = 112.5 mm (sample 9); (d) X = 142.5 mm (sample 12)
Fig. 6. Normalized results for periodic thicknesses of samples at different positions on curved substrate with 300 mm diameter
Fig. 7. XRR measurement results of multilayer film samples. (a) Mo/Si samples before and after annealing; (b) Mo/Si/C samples before and after annealing; (c) Mo/C/Si/C samples before and after annealing; (d) period thicknesses of Mo/Si, Mo/Si/C, and Mo/C/Si/C samples before and after annealing
Fig. 8. Measurement results of EUV reflectivity. (a) Mo/Si samples before and after annealing; (b) Mo/Si/C samples before and after annealing; (c) Mo/C/Si/C samples before and after annealing
Fig. 9. TEM measurement results at different resolutions. (a) Mo/Si sample (low resolution); (b) Mo/C/Si/C sample (low resolution); (c) Mo/Si sample (high resolution); (d) Mo/C/Si/C sample (high resolution)
|
Table 1. Multilayer film systems of annealed samples
|
Table 2. EUV measurement results before and after annealing at 300 ℃ for 2 h
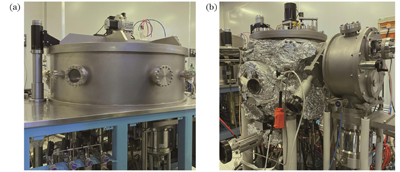
Set citation alerts for the article
Please enter your email address



