Xun Wang, Feng-Qi Zhang, Wei Chen, Xiao-Qiang Guo, Li-Li Ding, Yin-Hong Luo. Experimental study on neutron single event effects of commercial SRAMs based on CSNS [J]. Acta Physica Sinica, 2020, 69(16): 162901-1
Search by keywords or author
- Acta Physica Sinica
- Vol. 69, Issue 16, 162901-1 (2020)
![Layout of back-n at CSNS[19].](/richHtml/wlxb/2020/69/16/20200265/img_1.jpg)
Fig. 1. Layout of back-n at CSNS[19].
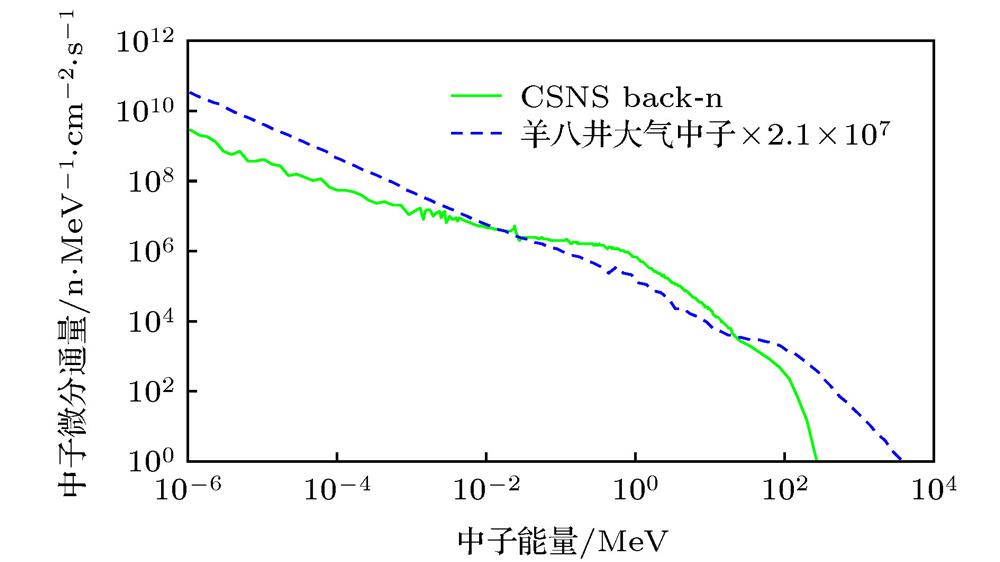
Fig. 2. Comparison between the differential neutron energy spectra of CSNS back-n and Yangbajing.
Fig. 3. Layout of the irradiation experiment at CSNS back-n
Fig. 4. Comparison between the SEE cross sections of devices with different test patterns.
Fig. 5. Comparison of the SEE cross sections of the devices with the same feature sizes from different manufacturer: (a) 350 nm SRAM; (b) 130 nm SRAM; (c) 65 nm SRAM.
Fig. 6. Comparison of the SEE cross sections of devices from the same manufacturer with different feature sizes: (a) HITECHI/RENESAS HM SRAM; (b) Cypress CY1318SRAM; (c) Cypress CY62126SRAM; (d) ISSI IS6X SRAM
Fig. 7. MCU rates of the devices with different test patterns: (a) IS61WV204816(40 nm); (b) CY62126DV(130 nm); (c) HM62V8100 (180 nm); (d) IS64WV25616 (65 nm)
Fig. 8. MCU rates and sizes of the devices with the same feature sizes from different manufacturer.
Fig. 9. MCU rates and sizes of the devices from the same manufacturer with different feature sizes: (a) CY7C1318; (b) IS6X
|
Table 1.
Parameters of the SRAM devices for test.
待测SRAM器件参数
|
Table 2.
Test results of the SEUs at CSNS back-n.
在CSNS反角白光中子源的SEU测试结果
| ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Table 3.
Extraction results of the single event multiple cell upsets.
单粒子MCU提取结果
Set citation alerts for the article
Please enter your email address



